AuRoFUSE™에 의한 접합 기술이 실현하는 미래

금 나노 페이스트를 이용한 반도체 패키지 기술
~저온 융착·고신뢰성으로 LED 조명, 파워 디바이스, MEMS를 안정적으로
연구자·개발자

다나까귀금속공업
금속 재료 개발부
금 나노입자를 페이스트 상으로 한 재료는, 종래의 은 은페이스트 재료와 달리 신뢰성이 압도적으로 높고, 또한 200℃에서 가압 없이 작업할 수 있기 때문에 무연 재료로서 작업 비용은 싸게 된다. 최종적으로는 금 나노 입자가 직접 서로 붙어 있기 때문에 열전도율도 은 은페이스트에 의한 은 융합보다 높고, 열을 놓치기 쉽다. 일반적으로는 금은 고가라는 이미지가 붙어 있지만 작업 효율, 제조 장치 비용, 고신뢰성(고수명)에 의한 교환 비용, 성능(파워 디바이스의 고출력) 등 종합적인 이점을 비용으로 환산해 보면 오히려 시스템 비용은 저렴할 가능성이 있다.
다나까귀금속공업 공업이 새로운 금 나노입자의 페이스트 재료 「AuRoFUSE」를 개발, 반도체의 패키지 기술에의 응용을 제안하고 있다. 접착성이나 작업 효율의 높이로부터 파워 디바이스의 다이 본딩이나, WLP(웨이퍼 레벨 패키징)의 웨이퍼끼리의 밀봉에 사용하는 사례 등을 상정하고 있다.
금은 자연계에서는 지극히 안정되어 있어 1000년도 전의 신사나 절, 문화재 등에 사용되어 왔다. 반도체나 일렉트로닉스의 세계에서도 마찬가지로, 예를 들면, 스마트폰이나 휴대전화의 프린트 회로 기판은 「도시 광산」이라고 야유될 정도로 대량으로 사용되고 있다. 녹슬지 않고, 열화하지 않는다는 돈만의 특성을 가지고 있기 때문이다. 전자 회로 에서는 녹슬면 저항이 높아지고, 의도하지 않은 금속의 성장이 있으면 쇼트에 연결된다. 여러 번 고온-저온의 실제 사용 상태를 반복하면 균열되거나 벗겨질 수 있다. 그러나 금은 다른 금속에서 볼 수있는 시간이 지남에 따라 변하지 않습니다. 수년에 걸쳐 안정적이다.
한편, 전자 회로의 세계에서는 유해한 납 솔더를 사용하지 않고 금속끼리를 접합하는 무연가 실용화되어 왔다. 그러나 기존의 납 솔더보다 30~40℃ 고온에서 처리해야 한다는 제약이 있었다. 이 때문에, 제조 장치가 고가가 됨과 동시에, 제조 공정도 어려웠다. 무연 납에 가까운 온도에서 접합시키는 것은 금속 접합의 주요 목표 중 하나였습니다.
200℃에서 접합할 수 있는 금 페이스트
다나까귀금속의 AuRoFUSE는 납 땜납의 접합 온도보다 낮은 200℃에서 접합할 수 있는 금 페이스트 이다(그림 1). 이 금 페이스트 에는 입경이 200~400nm의 나노 입자를 사용하고 있지만, 이 사이즈가 반도체 칩의 실장에는 최적이기 때문이라고 한다. 입경이 이 사이즈보다 지나치게 작으면, 150℃ 정도에서 네킹이라고 부르는, 나노 입자끼리가 붙기 쉬워져 취급하기 어려워진다. 입경이 크고 1μm 이상이 되면 용융 온도가 400℃로 되어 버려, 사용하기 어려워진다.
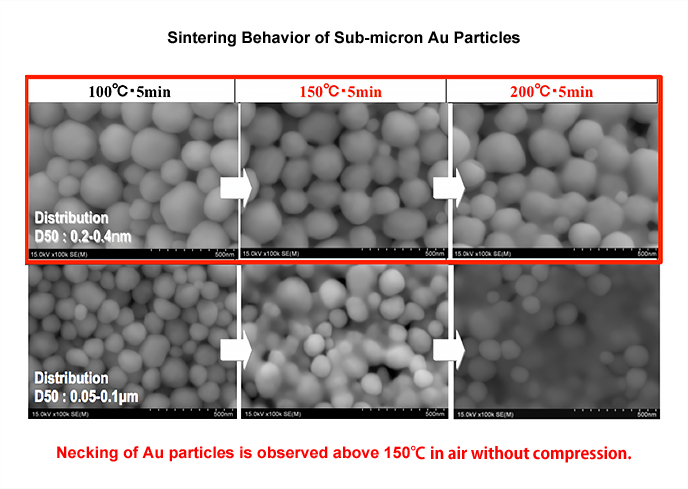
종래의 금 페이스트 에서는, 금의 입자를 유기 용제에 녹여 넣고 있지만, 또한 페이스트의 점도를 조정하기 위한 분산제도 첨가하고 있었다. 페이스트의 점도가 높으면 사용하기 어렵고, 액상 정도가 아니라 적당한 점도가 가장 가공하기 쉽다.
이번 AuRoFUSE는 입경을 200~400nm로 제어하여 용제로서의 계면활성제를 넣고 있을 뿐이라고 한다. 이 때문에 점도 조정에 곤란하지 않고, 사용하기 쉬운 점도로 하고 있다. 기본적인 아이디어는 표면활성제가 금 입자의 표면을 잘 덮고, 100℃ 이상의 열로 쉽게 벗겨 주는 것입니다. 금 입자와 계면활성제는 물리적으로 붙어있는 정도이며 화학적으로 결합하지 않습니다. 이 때문에, 온도를 가하면 계면활성제가 간단하게 벗겨진다.
무연 중 하나인 금과 주석의 공정 솔더와 비교해 AuRoFUSE는 전기 저항률은 1/5의 5.4μΩcm(25℃)로 낮고 열전도율은 3배인 150W/mK 이상으로 크다(표 1). 즉 열도 전기도 흘리기 쉽다. 또한 영률이 1/6 이하인 9.5GPa로 낮고 부드러운 재료임을 보여준다. 부드러운 재료는 응력을 흡수해 준다는 장점도 있다. 금주석 공정 재료와의 비교에서는, 종래와 같이 실리콘과의 콘택트 재료에 사용하는 경우에는, Ti의 하지 배리어 메탈, Pt 혹은 TiW 배리어 메탈 위에 Au 전극을 형성한다.
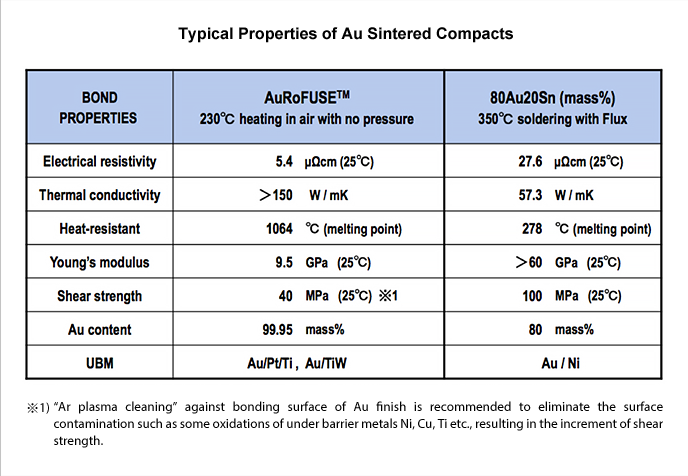
이 금 나노 페이스트를 사용하여 칩을 다이 본딩하는 경우, 기판에 대하여 밀착성이나 열팽창 계수의 정합 등을 포함하여 Au/Pd/Ni 금속을 반도체 칩이나 기판 상에 형성해 둔다. 그 위에 탑재해야 할 위치에 AuRoFUSE를 디스펜서로 Au를 토출하여 Au/Pd/Ni 금속층 위에 부착시킨다(도 2). 그리고 가압, 열처리하여 접합한다. 접합시키는 시간은 20분 정도로 200~230℃. 접합 후 1~3시간의 포스트 신터링을 실시하여 접합 부분을 안정화시킨다.

이 금 나노 페이스트의 응용으로서, 상정하고 있는 것은 자동차의 프론트 라이트에 사용하는 LED 헤드 라이트 조명이나 레이저 헤드 라이트(참고 자료 1), 레이저 프로젝터, GaN 파워 디바이스 등이다.
방열에 주의를
LED 조명에서는 다수의 LED를 나란히 빛내는 방법을 취하지만 LED 조명에서는 청색 LED에 노란색 형광체를 바르고 청색 + 노란색으로 백색으로 한다. 도 3은 LED 칩을 2개 직렬 접속한 쌍을 12조 병렬 접속으로 실장한 합계 24개의 LED 칩을 탑재한 LED 램프이다. 여기에서는 칩을 페이스 다운으로 알루미늄 기판에 판에 탑재하고 있다. 페이스 다운 본딩 패드 아래의 알루미늄 기판 과는 절연 시트로 전기적으로 절연해 두지만, 열만을 놓치고 싶기 때문에 열전도율이 좋은 재료를 알루미늄 기판과 본딩 패드 사이에 끼울 필요가 있다. LED의 열은 알루미늄 기판으로 빠져나가는 것으로, LED의 n, p의 양 전극을 통과하여 외부로 방출되게 되어 있다.
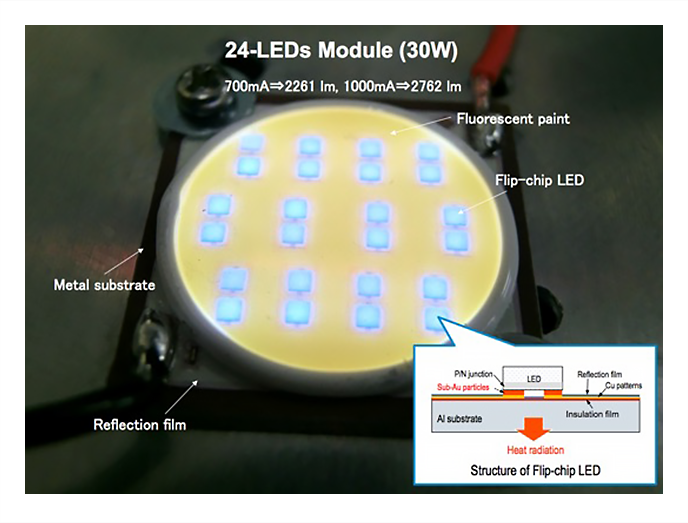
이 구조 LED 모듈 8기의 온·오프 시험(24V에서 350mA, 정지 시간 15분)을 행했다. 본딩 패드 부분을 이번 Au 페이스트, AuSn 솔더, SnAgCu 솔더의 3종류의 시제품을 만들어 각각 8기씩 시험했다. AuSn 땜납은 500사이클로 전수 고장했고, SnAgCu 솔더에서는, 1000사이클로 3기 밖에 생존하지 않았다. 그대로 3000사이클은 클리어할 수 있었지만, 4000사이클에서는 2기밖에 살아남지 않고, 5000사이클에서는 전수 고장했다. 그런데 Au 페이스트 전극에서는 1만5000사이클이라도 하나도 고장이 없었다.
레이저 다이오드는, 레이저 칩의 기판 측의 전극층으로서, 칩측으로부터 AuZn층, Ti층, Au층을 설치해 두고, 구리 기판 위에는 Au막을 형성하고, Au끼리를 Au 페이스트「AuRoFUSE」로 접합한다. 접합 부분은 Au끼리이기 때문에 전위차를 발생시키지 않기 때문에 신뢰성상 문제가 될 걱정은 없다. 200℃ 이상에서 접합시켜, 한층 더 신터링함으로써, 금 페이스트에 포함되는 용제가 휘발해, 순수한 금만이 남아 접합하기 때문에, 금끼리가 접합하게 되어, 매우 안정한 접합이 되는 것이다.
발열하는 파워 디바이스로서 GaN 디바이스가 유망하다고 하는 것은, 전류를 옆으로 흘리는 디바이스이기 때문이라고 한다. 다이 본딩에 Ag(은)를 사용하면, 본딩 와이어의 Au와의 전위차에 의해, Ag 마이그레이션이 일어나 덴드라이드가 성장해 단자간의 쇼트에 이를 우려가 있다. 이 때문에 Au-Au 접합이 바람직하다. 단, SiC 트랜지스터는 수직으로 전류를 흘리는 타입이기 때문에, 다이 본딩제에 Ag를 이용하여 마이그레이션을 일으켜도 단락할 위험성은 적다. 이 때문에 SiC 디바이스에는 Au이어야 한다는 동기는 얇다.
WLP 패키지에 적용
AuRoFUSE의 또 다른 응용 예는 WLP 패키지의 진공 밀봉제로서의 용도이다. MEMS 디바이스와 같이, 얇은 멤브레인막을 형성하여 그 정전 용량이나 피에조 저항을 측정하는 센서를 양산하는 경우에는, 기밀 밀봉으로 MEMS 칩을 몰드 수지 내에 수납하고 있다.
향후, WLP에 의해, 보다 소형화와 내부식성의 패키지가 가능하면 생체 매립 센서가 가능하게 된다. 디바이스 웨이퍼 위에 캡 웨이퍼를 씌워 밀봉하는 것이지만, 웨이퍼와 웨이퍼를 밀봉하는데 금으로 둘러싸 버리면, 생체내에서도 부식되는 일은 없다.
다나까귀금속은 인쇄에 의해 금의 패턴을 그릴 경우, 패턴 이외의 금 재료는 낭비된다. 이 때문에, 리소그래피에 의해 패턴을 전사 웨이퍼에 형성하고, 그 전사 웨이퍼를 디바이스 웨이퍼의 금 패턴에 전사하는 기술도 개발되고 있다. 전사 웨이퍼는 여러 번 반복적으로 사용할 수 있으므로 낭비되지 않습니다.

금 패턴을 밀봉용 프레임으로서 사용하는 경우에는 하지의 표면이 다소 거칠어도 그 표면을 따라 추종하여 간극을 만들지 않는다는 장점도 있다. 금은 신터링함으로써 기초를 따라 변형한다. 도 4는 금을 200℃, 100MPa에서 열압착시킴으로써 기밀 밀봉한 경우의 패턴(도 4 우)과 단면도(도 4 좌)이다. 이 방법은 기밀 밀봉의 금 프레임과 전극의 금 접속을 동시에 형성할 수 있다는 장점도 있기 때문에, 장래의 TSV(Through Silicon Via)에 의한 3차원 IC와 MEMS의 집적을 용이하게 할 수 있게 된다.
참고 자료
1. BMW i8, 신형 7 시리즈에 탑재된 최신 헤드라이트 「레이저 라이트」가 대단하다
뉴스 릴리스
- PRESS2016.04.04
- 다나까귀금속공업 S.E.I, 저온 접합 소재 'AuRoFUSE™'를 적용한 고출력 LED 모듈 개발
다양한 분야에서 활약하는 귀금속의 가능성을 소개합니다.
다나까귀금속은 현금 조달부터 부품 공급, 연구개발부터 제조, 판매, 리사이클에 이르기까지
귀금속에 관한 모든 서비스를 전개하고 있어 최적의 조합으로 고객의 요구에 맞는 토탈 솔루션을 제공하고 있습니다.
이 기사는 어땠어?
참고가 된 분은, 공유를 부탁합니다.