전력 반도체 용 AgSn TLP 시트

견적 출처: 2025년 5월 6일
PCIM 매거진
다나까귀금속에서 산업용 귀금속 사업을 담당하는 다나까귀금속공업 공업은 파워 반도체 패키지 제조에 있어서의 다이 접합용으로 설계된 시트상 접합 재료「AgSn TLP 시트」를 개발했다고 발표했다. 본 제품은 히트싱크의 대면적 접합에서는 열계면 재료(TIM: 전자기기에서 발생하는 불필요한 열을 방산시키기 위해 재료 사이에 삽입하는 열전도 재료)의 대체재로도 기대되고 있으며, 추가 용도 확대가 전망되고 있다.
대전류 대형 실리콘 칩의 접합을 실현하는 시트상 접합 재료
최근 전기 자동차, 하이브리드 자동차, 산업 인프라 등의 용도를 중심으로 대전류 파워 반도체에 대한 수요가 높아지고 있다. 그 때문에, 대형 실리콘 칩의 접합에 있어서는, 높은 신뢰성을 확보하면서, 대면적 접합을 가능하게 하는 재료가 요구되고 있다. 이번에 발표한 AgSn TLP 시트는 최대 20mm의 반도체 칩 접합에 사용할 수 있다. 또한, 3.3MPa라는 저압에서의 접합이 가능하고, 반도체 제조에 있어서의 수율 향상에도 공헌한다.
저온 접합 및 고내열성으로 파워 반도체의 열 대책을 강력하게 서포트
파워 반도체를 비롯한 반도체 디바이스에는 고온에 의한 고장이나 수명 단축을 방지하기 위해 높은 내열성이 요구된다. 현재, 전력 반도체 패키지의 제조에 주로 사용되고 있는 접합 재료 로서는 환경 부하의 관점에서 대체가 진행되고 있는 고연 땜납 있다. 납은 RoHS 지침의 규제 대상이지만, 과학적 및 기술적으로 대체가 곤란한 용도에 대해서는, 유효기간내에서의 사용이 인정되고 있다. 다만, 현재는 유효기간 제외를 위해 대체재 개발이 진행되고 있다. 그 외, 내열성이 낮은 SAC 땜납 (주석, 은, 구리를 함유하는 땜납 재료) 및 은(Ag) 소결 재료 등도 사용되고 있다. 본 제품의 가열 온도는 250℃이며, 액상 확산 접합 가능하다. 액상 확산 접합 (TLP 접합이라고도 불린다)이란, 확산 접합을 행할 때, 접합 계면에 삽입한 금속 등을 일시적으로 융해, 액화시킨 후에, 확산을 이용하여 등온 응고에 의해 접합하는 방법이다. 접합 후의 내열 온도는 480℃에 달하고, 내열성은 종래 제품을 상회한다. 또한, 최대 50MPa의 접합 강도를 유지할 수 있기 때문에, 다양한 피접합재 에도 사용할 수 있다. 또한 본 제품은 무연 접합 재료 이며 3,000 사이클의 히트 사이클 시험에도 합격하는 높은 접합 신뢰성을 갖추고 있다.
대면적 접합이 가능하기 때문에 본 제품은 파워 반도체용 다이 접합 재료 로서의 용도에 더해 TIM의 대체재로서의 사용도 기대되고 있다. 반도체 패키지의 제조에 있어서는, 열전도율이 높은 각종 재료가 개발되어 왔지만, TIM의 열전도율의 낮음이, 열 설계 전체에 있어서의 과제가 되고 있다. 또한 본 제품은 50mm 초과의 대면적 TIM의 접합을 가능하게 하는 고열 전도성 접합 재료 이며, 반도체 패키지 제조에 있어서의 열 대책에의 공헌이 기대된다.
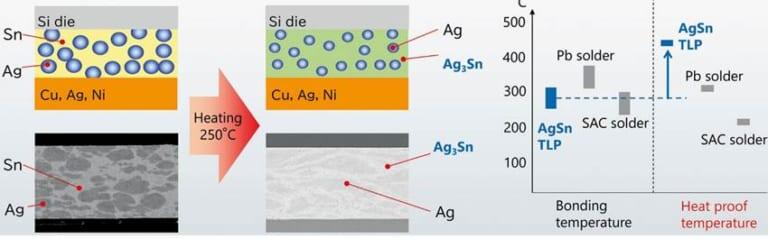
당사의 최신 게시물은 PCIM이 발행하는 PCIM Magazine의 "Hub for Power Electronics"를 참조하십시오.

URL: https://pcim.mesago.com/nuernberg/de/pcim-insights/pcim-magazine.html
이 기사는 어땠어?
참고가 된 분은, 공유를 부탁합니다.




