AgSn TLP 시트
일렉트로닉스
반도체
접합 및 봉지
접합 재료
판재·선재·관재

「TLP 시트」란?
다나까귀금속이 개발한 Ni/Cu를 주성분으로 하는 확산 접합에 의한 중간 재료 시트입니다. 200℃에서 접합 가능, 고온 공정 후에도 안정되어, 접합층의 얇음과 보이드 저감을 실현. 파워 디바이스나 고열 부하가 걸리는 모듈 실장 등, 고신뢰성과 열 안정성이 요구되는 분야에 최적인 차세대형 접합 재료 입니다.
대형 실리콘(Si) 칩의 접합을 가능하게 하는 판형 접합 재료
대응 칩 사이즈 20mm의 대면적으로, 고신뢰인 접합을 가능.
EV, HV, 산업 인프라 등으로 높아지는 대전류 대응의 파워 반도체 요구에 공헌.
TLP 접합 (액상 확산 접합(※1)): Transient Liquid Phase Diffusion Bonding
AgSn TLP 시트 개요
특징
신뢰할 수 있음
- 결합 후, Ag와 Sn은Ag3Sn이 되어 내열 온도가 480°C까지 상승하여 기존 재료보다 높은 내열성을 제공합니다.
- 접합 강도에 있어서는 최대 50MPa를 유지하고, 300℃에서도 동등한 접합 강도를 유지합니다.
- 3,000 사이클의 히트 사이클 테스트를 통과한 고접합 신뢰성도 특징 입니다.
비용 절감
- 접합 작업은 몇 분 안에 완료될 수 있으므로, 택트 타임을 단축하여 공정 비용을 절감할 수 있습니다.
환경에 미치는 영향 줄이기
- 이 소재는 용매를 함유하지 않으므로 휘발성 유기 화합물(VOC)을 생성하지 않습니다.
- 이 제품에는 납이 포함되어 있지 않으므로 RoHS 규정의 적용을 받는 물질이 포함되어 있지 않습니다.
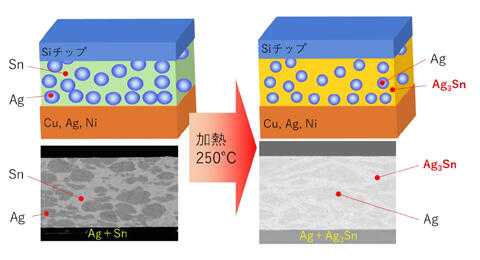
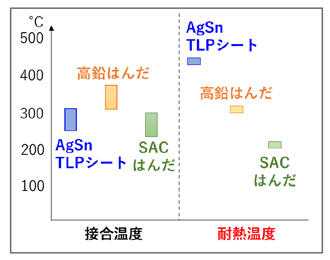
사용 방법
결합 조건
- 가열 온도 250℃에서 액상 확산 접합(※1)이 가능합니다.
- 3.3MPa의 저가압으로 접합이 가능합니다.
목표에 합류
- Cu, Ni, Ag 등의 다양한 피접합재에 대응이 가능합니다.
명세서
| 필수 성능 항목 | 성능 |
|---|---|
| 대응 칩 사이즈 | 최대 20mm |
| 판 두께 | 0.03~0.2mm |
| 접합 강도 (전단 강도) | 25~50 MPa |
| 내열성(고온 전단 강도 300℃) | 25~50 MPa |
| 신뢰성 (HC -50℃⇔200℃) | 3,000사이클 |
| 피접합재 | Cu/Ni/Ag에 접합 가능 |

(※1)액상 확산 접합: 확산 접합을 실시할 때, 접합 계면에 삽입되는 금속 등을 일시적으로 용융, 액화한 후에, 확산을 이용하여 등온 응고시켜 접합하는 접합 방법. 영어 명칭은 Transient Liquid Phase Diffusion Bonding (TLP 접합)
관련 정보
스크롤
