AuRoFUSETM接合技術實現的未來

採用金奈米膏材半導體封裝技術
低溫熔合和高可靠性確保了LED照明、功率元件和MEMS的穩定性。
研究人員和開發人員

田中貴金屬工業
金屬材料開發部
與傳統的銀膠材料不同,金奈米顆粒膏材的可靠性更高。由於它們可以在200°C下無壓加工,因此無鉛,且運行成本低。此外,由於金奈米顆粒彼此直接連接,其導熱係數高於使用銀膠熔融的銀,因此更容易散熱。人們通常認為黃金價格昂貴,但如果將工作效率、製造設備成本、高可靠性(長壽命)帶來的更換成本以及高性能(高功率裝置輸出)等整體優勢轉化為成本,實際上可能會降低系統成本。
田中貴金屬工業株式會社開發了一種名為「AuRoFUSE」的新型金奈米顆粒膏材,並計劃將其應用於半導體封裝技術。由於其具有高黏附性和高加工效率,預計可用於功率元件的晶片鍵合以及晶圓級封裝(WLP)中的晶圓密封。
黃金在自然界中極為穩定,早在1000年前就被用於建造神社、寺廟和文化遺產。在半導體和電子領域,黃金同樣發揮著重要作用;例如,智慧型手機和行動電話的印刷迴路基板用量巨大,以至於人們常常戲稱它們為「都市礦山」。這是因為黃金具有獨特的性質,例如不會生鏽或腐蝕。電子迴路生鏽後,電阻會增加,任何意外的金屬生長都可能導致短路。在實際使用過程中,反覆暴露於高低溫環境會導致電路板開裂和剝落。然而,黃金不像其他金屬會隨時間變化,能夠維持多年穩定。
同時,在電子迴路領域,無鉛已投入實際應用,無需使用有害的含鉛焊料即可將金屬連接在一起。然而,它的限制在於加工溫度必須比傳統含鉛焊料高出30至40攝氏度。這使得生產設備成本高昂,生產流程也較為複雜。金屬連接領域的主要目標之一,就是在接近含鉛焊料加工溫度的條件下達到無鉛連接。
可在200℃下黏結的金膏材
田中貴金屬的AuRoFUSE是一種可在200°C下進行鍵結的金膏材,其鍵結溫度低於鉛焊料(圖1)。該金膏材採用粒徑為200至400奈米的奈米顆粒,該公司聲稱這是半導體晶片封裝的最佳粒徑。如果顆粒尺寸小於此值,奈米顆粒在150°C左右就會發生頸縮現象,導致金膏難以操作。如果顆粒尺寸大於1微米,熔點將達到400°C,同樣難以使用。
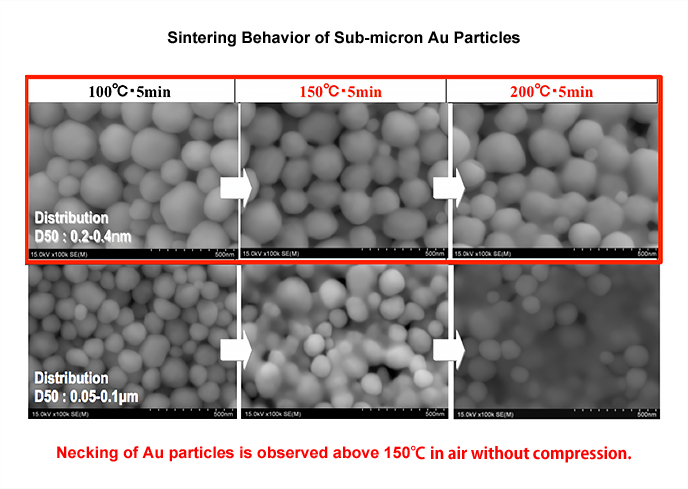
在傳統的金膏材,金顆粒溶解在有機溶劑中,再加入分散劑來調整膏材黏度。膏材的高黏度使其難以使用,而黏度適中、不像液體那麼高的黏度是最容易處理的。
新的 AuRoFUSE 指出,粒徑可控制在 200-400 nm,且只含有界面活性劑作為溶劑。因此無需調整黏度即可輕鬆使用。其基本概念是表面活性劑可適度覆蓋金微粒表面,因此當加熱至 100°C 以上時,金微粒很容易剝落。金顆粒和界面活性劑只是物理性的相互附著,而不是化學性的。因此,界面活性劑在加溫時很容易剝落。
無鉛AuRoFUSE 與金錫共晶焊料 (焊料的一種) 相較,其電阻率低 1/5(25 °C 時為 5.4 µΩcm),熱導率高達 150 W/mK 以上,是金的三倍以上 (表 1)。這表示熱能和電能都很容易流動。此外,Young's 模量很低,只有 9.5 GPa,不到六分之一,顯示它是一種軟性材料。軟性材料還有吸收應力的優點。相較於金錫共晶材料,當與矽同樣使用為接觸材料時,金電極會形成在 Ti 基礎阻擋金屬、Pt 或 TiW 阻擋金屬上。
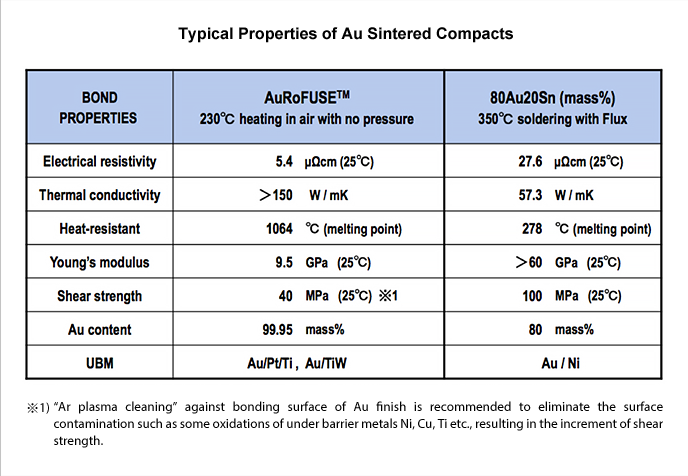
使用這種金奈米膏材進行晶片鍵合時,首先在半導體晶片或基板上形成Au/Pd/Ni金屬層,同時考慮基板黏附性和熱膨脹係數匹配等因素。然後使用點膠器將AuRoFUSE塗覆到Au/Pd/Ni金屬層上所需的安裝位置(圖2)。之後,透過加壓和熱處理將兩者鍵結。鍵合時間約20分鐘,溫度為200-230°C。鍵結完成後,進行1-3小時的後燒結處理,以穩定鍵結區域。

這種金奈米膏材的潛在應用包括汽車前燈中使用的 LED 前燈和雷射前燈(參考文獻 1)、雷射投影機和 GaN 功率裝置。
註意散熱
在 LED 照明中,大量的 LED 排成一排來發光,但在 LED 照明中,藍色的 LED 塗上黃色的螢光粉,使其成為藍色 + 黃色的白色。圖 3 顯示一盞 LED 燈,燈上共安裝了 24 顆 LED 晶粒,其中 12 對 LED 晶粒由兩顆 LED 晶粒串聯,另外 12 對則以平行連接的方式安裝。在此,晶片面朝下安裝在鋁板上,基板。基板在面朝下的接合墊下,LED 與鋁質基板用隔熱片進行電絕緣,但在鋁質基板與接合墊之間必須放置導熱性良好的材料,以便只讓熱量排出。LED 的設計是透過 LED 的 n 電極和 p 電極向外釋放熱量。
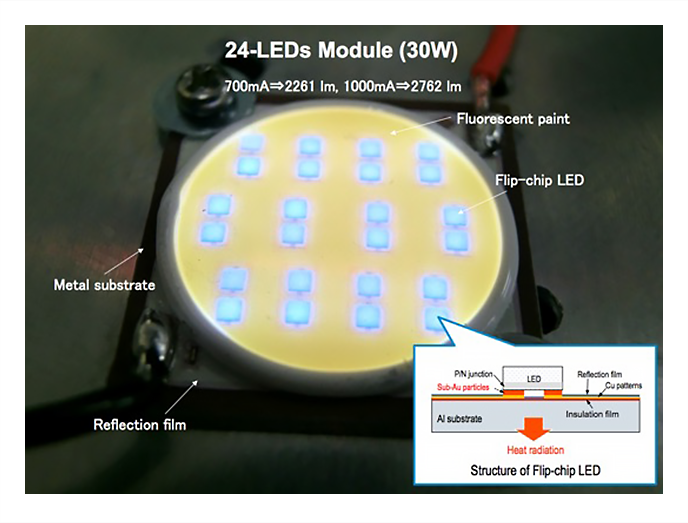
對八個採用此結構的LED模組進行了開關測試(24V,350mA,靜置15分鐘)。製作了三種焊盤原型:金膏材、金錫焊料和錫銀銅焊料,每種各八個進行測試。所有金錫焊料模組在500次循環後失效,1000次循環後僅有三個錫銀銅焊料模組存活。它們能夠承受3000次循環,但4000次循環後僅有兩個存活,5000次循環後全部失效。然而,即使經過15,000次循環,所有金膏材電極均未失效。
對於雷射二極體,晶片側的基板側依序設定AuZn層、Ti層和Au層作為電極層,並在銅基基板形成Au膜,然後使用AuRoFUSE金膏材將各Au層鍵結在一起。由於鍵合部分為Au-Au鍵合,不存在電位差,因此無需擔心可靠性問題。透過在200℃或更高的溫度下進行鍵合和燒結,金膏材中的溶劑揮發,僅留下純金進行鍵合,從而形成非常穩定的金-金鍵合。
氮化鎵(GaN)裝置之所以被認為有潛力成為發熱功率元件,是因為它們是水平方向導電的裝置。如果使用銀(Ag)進行晶片鍵合,與金(Au)接合線之間的電位差會導致銀遷移,進而引發枝晶生長和端子間短路。因此,金-金鍵合是更優的選擇。然而,由於碳化矽(SiC)電晶體是垂直方向導電的裝置,即使使用銀作為晶片鍵合材料時發生遷移,短路的風險也很小。因此,在碳化矽元件中使用金的動力並不強。
WLP軟體包的應用
AuRoFUSE的另一個應用是作為WLP封裝的真空密封劑。在批量生產形成薄膜並測量其電容和壓阻的感測器(例如MEMS裝置)時,MEMS晶片會被密封在成型樹脂內。
未來,晶圓級封裝(WLP)技術將協助開發更小巧、更耐腐蝕的封裝,進而實現植入式感測器在生物體內的應用。將一層蓋晶圓放置在裝置晶圓上方進行密封,如果晶圓周圍用金色進行密封,即使在生物體內也不會發生腐蝕。
在印製金圖案時,圖案以外的金材料會被浪費掉。因此田中貴金屬正在開發一種新技術,即利用光刻技術在轉移晶片上形成圖案,然後將轉移晶片轉移到裝置晶片上的金圖案上。轉移晶片可以多次重複使用,從而避免金材料的浪費。

將金圖案作為封裝用框架使用時,即使基底的表面有些粗糙,也可以沿著其表面進行追蹤,不會產生縫隙,這也是其優點。金通過燒結沿基底變形。圖4是通過在200°C、100MPa下熱壓接金,停止氣密封時的圖案 (圖4右) 和截面圖 (圖4左) 。該方法還具有能夠同時形成氣密封的金框架和電極的金連接的優點,因此將來能夠容易地集成基於TSV (通過硅通孔) 的三維IC和MEMS。
參考資料
1.寶馬i8、新款7系列搭載的最新前照燈“Laserlight”令人驚嘆。
新聞稿
- PRESS2016.04.04
- 田中貴金屬工業與S.E.I開發使用低溫接合材料「AuRoFUSE」™的高功率LED模組
我將介紹貴金屬在各種領域活躍的可能性。
田中貴金屬負責從貴金屬採購到材料供應、研發、製造、銷售和回收的所有環節。
我們提供與貴金屬相關的全方位服務,並透過最佳組合這些服務,為客戶量身定制全面的解決方案。
這篇報道怎麽樣?
請參考的人分享。