功率半導體用AgSn TLP片材

引用來源:2025年5月6日
PCIM Magazine
田中貴金屬田中貴金屬工業的工業貴金屬業務宣布開發出一種片狀 'AgSn TLP sheet',專門用於功率 製造中的晶粒接合。該產品也有望在 的大面積接合中用作熱介面材料 (TIM:插入材料間的導熱材料,以散去電子設備中產生的不需要的熱量) 的替代品,預計還會有更多應用。接合材料半導體封裝散熱器
片狀鍵接合材料,可用於高電流下大尺寸矽晶片的鍵合
近年來,高電流功率半導體的需求不斷增長,主要應用於電動車、混合動力汽車、工業基礎設施等領域。因此,用於鍵合大型矽晶片的材料必須能夠實現大面積鍵合併保持高可靠性。此次發表的AgSn TLP薄片可用於鍵結尺寸達20毫米的半導體晶片。此外,該材料可在3.3兆帕的低壓下進行鍵合,有助於提高半導體製造的良品率。
低溫接合和高耐熱性為功率半導體的熱管理提供了強有力的支援。
功率半導體和其他半導體裝置需要高耐熱性,以防止高溫導致的擊穿和壽命縮短。目前,功率半導體封裝製造中使用的主要接合材料是高鉛焊錫,但由於其對環境的影響,這種焊料正被逐步取代。雖然RoHS指令限制鉛的使用,但在有效期內,對於在科學和技術上難以找到替代方案的應用,鉛的使用是被允許的。然而,由於目前鉛的使用不受有效期限限制,替代材料的研發工作正在進行中。其他使用的材料包括SAC焊錫(一種含有錫、銀和銅的焊料)和銀(Ag)燒結材料,這些材料的耐熱性較低。本產品可加熱至250°C,並可進行液相擴散接合。液相擴散接合(TLP)是一種擴散焊接方法,其中插入焊接界面的金屬被暫時熔化並液化,然後透過擴散進行等溫凝固。焊接後,其耐熱性可達480°C,超過了傳統產品的耐熱性。此外,其接合強度可達50 MPa,適用於多種被接合材料。而且,該產品為無鉛接合材料,黏接可靠性高,已通過3000次熱循環測試。
由於該產品能夠實現大面積鍵合,預計不僅可以用作功率半導體晶片的晶片鍵接合材料(TIM)。儘管半導體封裝製造領域已開發出多種高導熱材料,但導熱界面材料的低導熱性仍然是整體散熱設計中的一個難題。此外,該產品是一種高導熱鍵接合材料,能夠實現面積超過50mm的大面積導熱界面材料的鍵合,有望為半導體封裝製造中的熱管理做出貢獻。
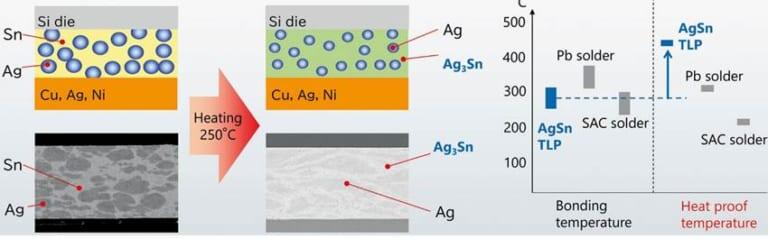
若要查看我們的最新文章,請參閱 PCIM 出版的 PCIM 雜誌上的「電力電子中心」專欄。

URL: https://pcim.mesago.com/nuernberg/de/pcim-insights/pcim-magazine.html
這篇報道怎麽樣?
請參考的人分享。




