金和金合金接合線

50多年的信譽和經驗
什麼是「金及金合金接合線」?
金及金合金接合線是一種導電材料,能夠可靠地連接半導體晶片和電極,並具有優異的接合性和耐腐蝕性。我們的產品是全球半導體製造商採用的世界標準,可滿足小型化、高速環路控制等各種安裝需求。
HAZ長度和斷裂載荷[Au Wire dia.25um]
![[HAZ長度和斷裂載荷比較圖] 從左側Y/C/FA/GSA/M3/GHA-2/LC/GSB/GFC/GLF/GMH/GFD/GPH/GPG-3/GPG/GPG-2/GMG/GMH-2](http://files.chinaasaservice.com/8284/25569152/img_bonding_wires_au_02.jpg)
GSA/GSB– 用於穩定二次鍵結的金接合線
特色
- 穩定的縫合接合性使得即使對於 QFN、QFP 和 BGA 封裝,也很難發生局部脫黏現象。
- 針腳試驗後余金較多,針腳接合處接合提升較少。
- 壓合徑偏差小,圓度好且FAB軟,壓合球易變形。
Stable Stitch Bond on QFN Packages(PPF, 175°C)
![[Frequency和2nd Pull Strength比較圖] Average-GSA:4.3gf/FA:4.1gf/GSB:4.2gf/GHM:4.0gf](http://files.chinaasaservice.com/8284/25569162/img_bonding_wires_au_03.jpg)
After Stitch Pull Test
![[After Stitch Pull Test]GSA/FA/GSB/GMH](http://files.chinaasaservice.com/8284/25569159/img_bonding_wires_au_04.jpg)
Squashed Ball Roundness

GFC/GFD- 用於細間距安裝的金接合線
特色
- 焊接時超聲波引起的壓合球變形少。
- 由於能夠施加必要且充分的超聲波,因此能夠得到良好的接合狀態。
- 支持各種襯墊間距接合。
Ball Shape
![[Ball Shape比較] GMH/GFC/GFD, FAB:38-61μm, SBD:45-75μm](http://files.chinaasaservice.com/8284/25569155/img_bonding_wires_au_06.jpg)
Middle FAB : 51μm SBD : 60μm
Lower FAB : 62μm SBD : 75μm
35μm BPP Bonding

Bonder : Shikawa UTC-3000
Pad Opening : 2μm
Scatter Diagram at 35μm BPP Bonding
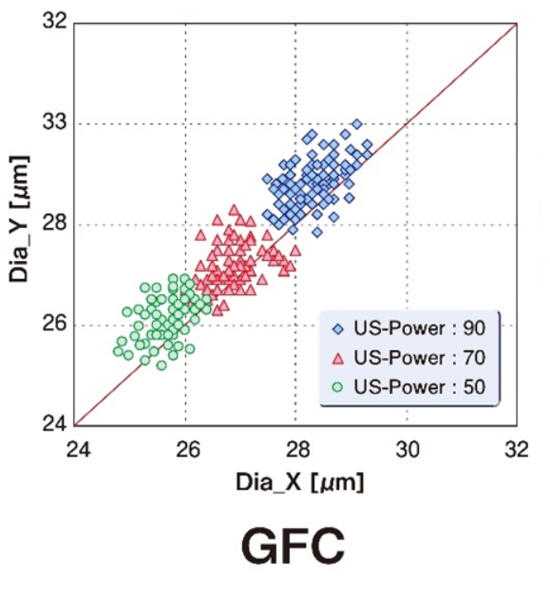
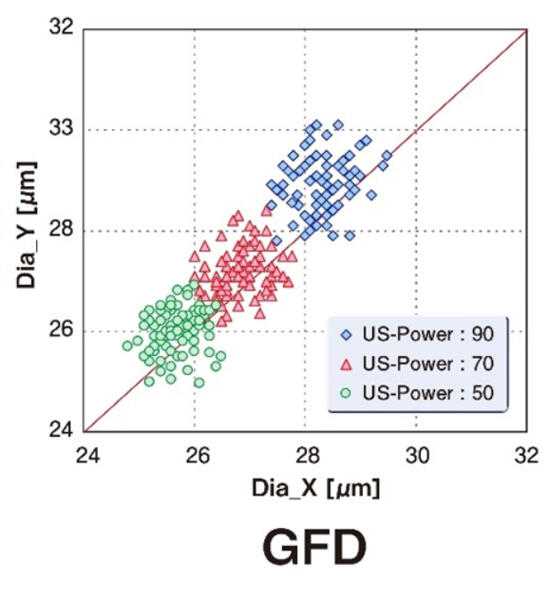

GPH——高可靠性金合金接合線
特色
- 與無鹵素樹脂組合,具有高可靠性

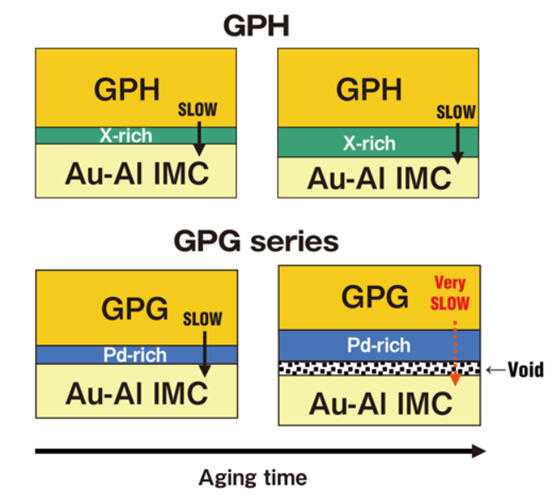
GLF- 超低環路金鍵接合線
特色
- 與原來的低環形成性相比,低環形成性更好。
- 卓越的頸部損傷抑制性
- S形彎曲抑制
- 拉伸強度比原來的低環絲高。
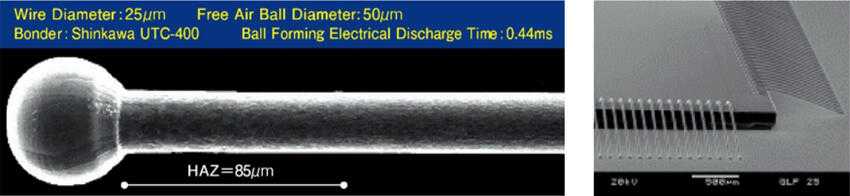
GMG– 高強度金接合線
特色
- 高強度型可通過細線化降低成本
- 支持各種環路形狀,如BGA。
- 非常適合用於堆疊晶片封裝中的凸块形成。
Mechanical Properties
![[Breaking Load和Wire Diameter的比較圖] FA/GMH/GMH-2/M3/GMG](http://files.chinaasaservice.com/8284/25569165/img_bonding_wires_au_14.jpg)
下載技術數據
您可以從以下橫幅下載技術數據:。
Scroll

