AgSn TLP片
電子
半導體
接合與封裝
接合材料
板材、線材與管材

什麼是「TLP表格」?
這是田中貴金屬主要成分為鎳/銅,採用擴散焊接工藝製成。此材料可在200℃下焊接,即使經過高溫處理也能保持穩定性,並能形成孔隙率低的超薄焊接層。它是一種新一代接合材料非常適合對可靠性和熱穩定性要求極高的應用領域,例如承受高熱負荷的功率元件和模組安裝。
用於黏合大型矽 (Si) 晶片的片狀黏合材料
20mm 的相容晶片尺寸面積大,可實現高度可靠的鍵結。
滿足電動車、高壓設備、工業基礎設施等領域對能夠處理大電流的功率半導體日益增長的需求。
TLP鍵結(瞬態液相擴散液相擴散接合(※1))
AgSn TLP片 概述
特色
可靠性
- 鍵結後,Ag 和 Sn 變成 Ag3Sn,耐熱溫度提高到 480°C,比現有材料具有更高的耐熱性。
- 接合強度最高可達 50 MPa,即使在 300°C 下也能維持相同的接合強度。
- 特色是黏合可靠性高,已通過 3000 次循環熱循環測試。
降低成本
- 由於黏合過程只需幾分鐘即可完成,因此可以透過縮短節拍時間來降低製程成本。
減少環境影響
- 由於該材料不含溶劑,因此不會產生 VOC(揮發性有機化合物)。
- 它不含鉛,因此不含任何受RoHS指令約束的物質。
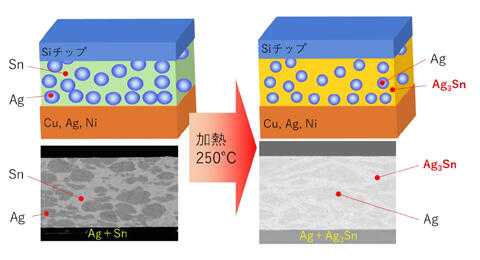
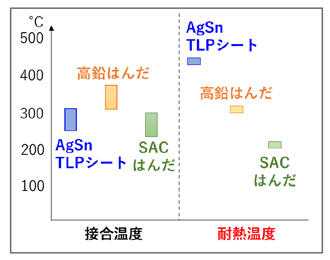
使用方法
黏合條件
- 在 250℃ 的加熱溫度下,可以進行液相擴散接合(※1)。
- 只需 3.3 MPa 的低加壓即可進行黏合。
加入目標
- 它可用於被接合材料例如銅、鎳和銀。
規格
| 所需績效項目 | 表現 |
|---|---|
| 支援的晶片尺寸 | 最大 20 毫米 |
| 板材厚度 | 0.03 至 0.2 毫米 |
| 接合強度(剪力强度) | 25至50兆帕 |
| 耐熱性(高溫剪力强度300℃) | 25至50兆帕 |
| 可靠性(HC -50℃⇔200℃) | 3,000 循環。 |
| 被接合材料 | 可與銅/鎳/銀鍵合 |

(※1)液相擴散接合:一種擴散焊接方法,其中插入焊接界面的金屬暫時熔化液化,然後透過擴散等溫凝固以形成材料焊接。英文名稱為Transient Liquid Phase Diffusion Bonding(TLP bonding)。
相關資訊
Scroll
