AgSn TLP Sheet

What is a "TLP sheet"?
This is an intermediate bonding sheet developed by TANAKA, primarily composed of Ni/Cu and manufactured using diffusion bonding technology. It enables bonding at 200 °C, maintains stability after subsequent high-temperature processes, and forms a thin bonding layer with reduced void formation. The material is suitable for high-reliability applications requiring thermal stability, including power devices and module assembly exposed to high heat loads.
Sheet bonding component that enables bonding of large silicon(Si)chips
A large area that supports a chip size of 20 mm with highly reliable bonding
Helps meet the growing need for high-power semiconductors in EV, HV, industrial infrastructure, and other applications.
TLP diffusion bonding:Transient Liquid Phase Diffusion Bonding(※1))
AgSn TLP Sheet Overview
Features
Reliability
- After bonding, Ag and Sn become Ag3Sn, which increases the heat resistance temperature to 480°C, providing higher heat resistance than existing materials.
- The bonding strength is maintained at a maximum of 50 MPa, and the same bonding strength is maintained even at 300°C.
- High bonding reliability that passed 3,000 cycles of heat cycle test.
Cost reduction
- Bonding can be completed in several minutes, which reduces the cycle time and therefore, reduces the process cost.
Reducing environmental impact
- The material is solvent-free and does not generate VOC (volatile organic compounds).
- Lead-free and does not contain substances restricted by the RoHS scope.
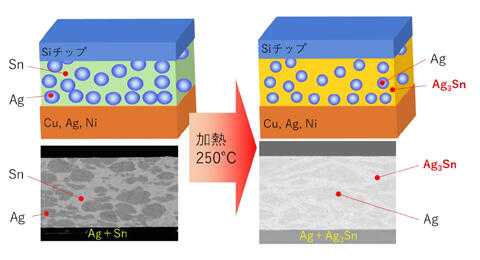
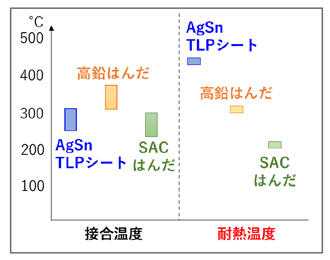
How to use
Bonding conditions
- Transient Liquid phase diffusion bonding(※1) is possible by heating temperature of 250℃.
- Bonding is possible with a low pressure of 3.3 MPa.
Bonding substrate
- Supports various substrates including Cu, Ni, and Ag.
Specifications
| Requirement | Performance |
|---|---|
| Applicable chip size | Up to 20 mm |
| Sheet Thickness | 0.03 to 0.2 mm |
| Bonding strength (shear strength) | 25 to 50 MPa |
| Heat resistance (high temperature shear strength 300℃) | 25 to 50 MPa |
| Reliability (HC -50℃⇔200℃) | 3,000 cycles |
| Bonded materials | Can bond Cu, Ni, and Ag |

(※1)Transient liquid phase diffusion bonding, also known as TLP bonding, is a bonding method that temporarily melts and liquifies metals and such inserted in the bonding surface, then uses diffusion to bond through isothermal solidification when carrying out diffusion bonding.
Related Information
First, please make an Inquiry about the product.
For any questions regarding product specifications, pricing, delivery times, etc., please feel free to Inquiry here.
