【주목 모이는 광전 융합에서의 활용도 시야에】"금"의 가능성이 개척하는 차세대 고밀도 실장의 신발상
현재, 반도체 후공정에서는 패키징 기술을 중심으로 에포크 메이킹이 되는 신기술의 도입이 가속되고 있다. 동시에 기대가 높아지고 있는 것이, 이 혁신에 대응한, 새로운 발상에 기초한 특징·특성을 가지는 재료의 창출이다. 다나까귀금속공업 공업은 신뢰성이 높고, 고밀도 실장을 가능하게 하는 새로운 실장 솔루션 「AuRoFUSE™(오로퓨즈) 프리폼」을 개발했다.
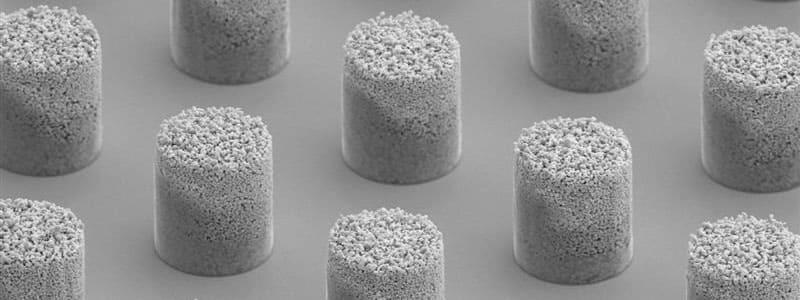
최근, 반도체 및 전자 기기 분야에서는, 통신 속도의 향상, 에너지 절약화 및 디바이스의 추가 소형화가 요구되고 있다. 이러한 요구에 부응하는 기술로 주목받고 있는 것이 컴포넌트를 높이 방향으로 적층하는 3차원 실장이나 한정된 공간에 많은 기능을 담는 고밀도 실장이다.
이러한 실장 기술을 지원하는 중요한 요소 중 하나가 플립칩 접합이다. 칩을 기판에 뒤집어서 직접 접합하는 이 방식에서는, 전극 부분을 마이크로 범프로 접속한다. 접합 재료 에는 접합 온도나 전기·열전도율 등 다양한 기능 특성이 요구되기 때문에 재료 선정은 매우 중요하다.
범프 형성 재료를 막는 과제
현재, 범프 전극의 형성에는 주로 땜납이나 도금 사용되고 있다.
땜납은 저비용이고 신속한 처리가 가능하다는 이점이 있지만, 좁은 피치에서의 단락의 위험이 우려된다. 한편, 도금은 미세 배선에 대한 대응력이 뛰어나지만, 재료의 경도가 재앙하고, 높이의 편차나 하중의 불균일을 흡수할 수 없다는 과제를 안고 있다. 이로 인해, 접속 불량이나 잔류 변형의 발생 등의 문제가 발생할 가능성이 있다.
이러한 과제를 극복하기 위해, 현재는 신규 재료의 개발이나 접합 프로세스의 최적화가 정력적으로 진행되고 있다. 플립칩 기술의 추가 진화는 차세대 반도체 실장을 지원하는 열쇠가 될 것이다.
닛케이 BP의 허가에 의해 「닛케이 크로스 텍」(2025년 11월 21일 게재)에 게재된 광고 기사를 발췌한 것입니다.
(금무단 전재)
관련 정보
파워 반도체 패키지 기술의 최신 동향, 고방열성· 고내열성 실현하는 최첨단 소재
스마트폰이나 전자기기 등의 에너지 절약화, EV 등의 차세대 모빌리티, 기지국, 재에너지의 전력 제어 등, 파워 반도체의 기술 개발은 점점 고출력화나 고효율화가 진행되고 있습니다.
고방열·고내열·접합 신뢰성의 공장·소형화 등의 과제에 대응하기 위한 최첨단 소재와 패키징의 기술 동향을 소개합니다.


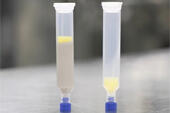

이 기사는 어땠어?
참고가 된 분은, 공유를 부탁합니다.




