AuRoFUSE™ Preforms

AuRoFUSE™ Preforms 이란?
다나까귀금속이 개발한 금·금 접합용 저온 소성 페이스트 AuRoFUSE™(오로퓨즈)를 활용한 고밀도 실장용 Au 소결 접합 기술입니다. 실장 공정의 효율화와 접합의 고신뢰성에 공헌해, 전기 저항 4.5μΩ·cm, 열전도율 200W/m·K라고 하는 고성능 특성을 가지고 있습니다.
AuRoFUSE™ Preforms 기술 소개
AuRoFUSE™를 활용한 고밀도 실장용 소결 Au 접합 기술
본 기술은 접합체를 사전에 건조시켜 유동성을 잃는 것으로 기어오름을 억제하고, 수평 방향으로의 확산 어려움으로부터 좁은 피치 접합을 가능하게 한 것입니다. 지금까지 5μm 사이즈의 범프 형성에 성공하고 있어 고밀도 실장이 요구되는 플립칩 본딩에의 활용이 기대되고 있다.
특징
- ① 다양한 크기, 형상의 금 범프가 제작 가능
(최소 실적: 5µm 사이즈, 5µm 간격) - ② 다공질 구조를 가진 접합체이기 때문에 압축 변형능이 뛰어나다
- ③가압시에 수평 방향으로의 변형이 적기 때문에 고밀도 실장이 가능
- ④주성분이 Au이기 때문에 산화나 마이그레이션이 발생하기 어렵다
- ⑤ 비교적 낮은 온도(200℃~), 대기하에서 접합이 가능



③ 접합 압력을 올렸을 때의 형상 변형률


가정용
광반도체(LED나 LD), 파워 반도체, IC용 다이어태치 치재
AuRoFUSE™ Preforms 제작 방법
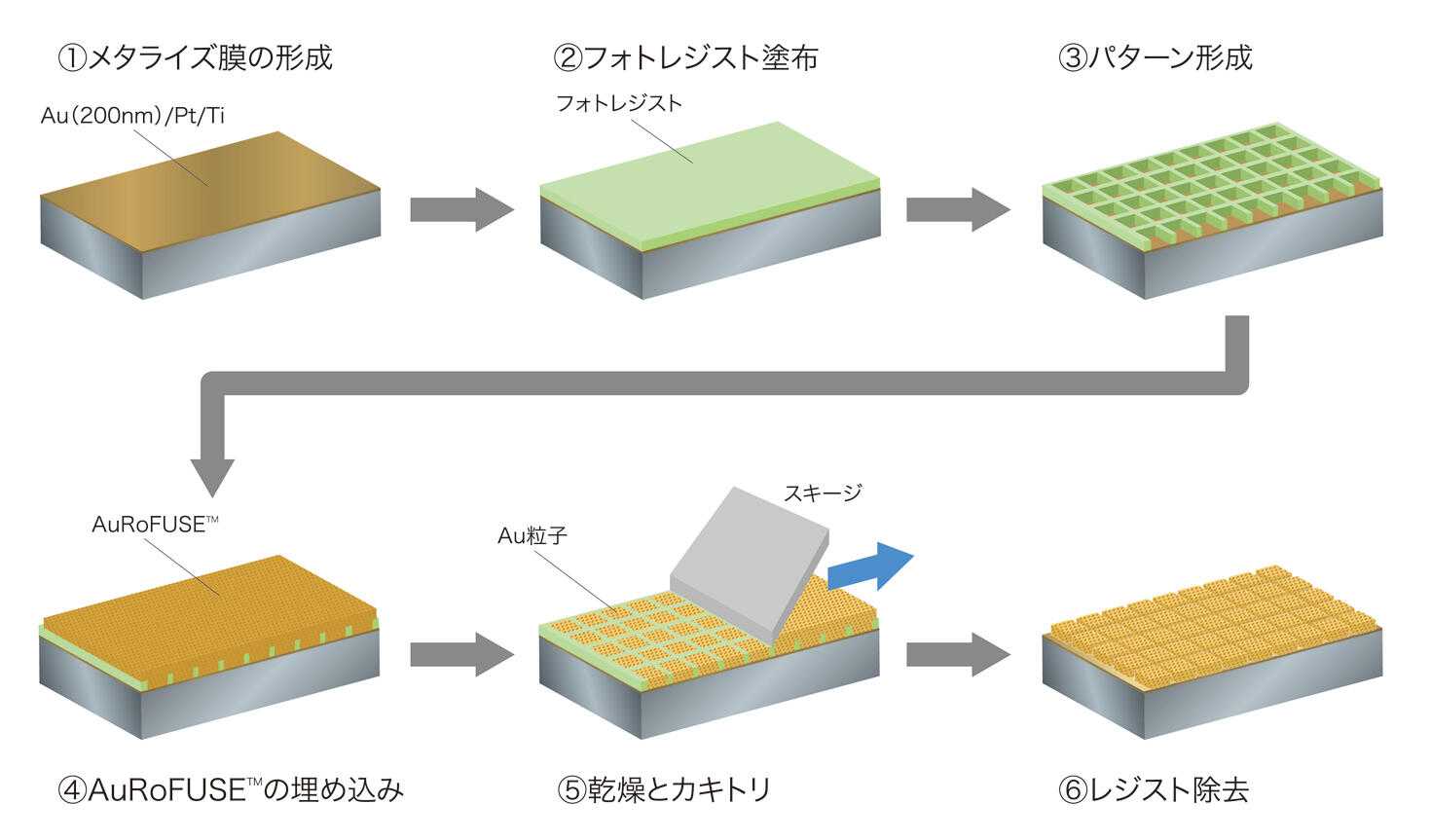
- ① 접합 대상의 기판에 하지층으로서 Au/Pt/Ti에 의한 메탈라이징한 실시한다
- ② 포토레지스트를, 메탈라이징한 후의 접합 대상의 기판에 도포한다
- ③ 프리폼 형상에 맞춘 포토마스크를 접합 대상의 기판에 들고, 노광·현상하여 레지스트 프레임을 제작한다
- ④ 제작한 레지스트 프레임에 AuRoFUSE™를 흘려 넣는다
- ⑤ 실온에서 진공 건조시키고, 건조 후에 스퀴지를 사용하여 잉여 Au 입자를 긁어낸다
- ⑥ 가열에 의한 가소 소결 후, 레지스트 프레임의 박리 제거를 행한다
AuRoFUSE™ Preforms과 다른 재료의 비교
(〇) AuRoFUSE™ Preforms
- 접합 전에 페이스트를 건조시켜 유동성을 잃음으로써, 가로 확산을 억제할 수 있어 고밀도 실장이 가능
- 다공질 구조 이기 때문에 변형이 용이하고 전극간에 고저차가 있는 경우나, 기판의 휨, 두께의 차이가 있는 경우에서도 접합이 가능
(△) 솔더 재료
- 범프 피치가 미세해짐에 따라, 땜납 재료가 용융시에 넓어져 버리기 때문에, 전극간의 접촉에 의해 단락한다
(△) 무전해 도금
- 좁은 피치를 실현할 수 있지만, 접합시에 비교적 높은 압력이 필요하기 때문에 칩의 파손으로 이어진다

접합 예: 플립칩 본딩
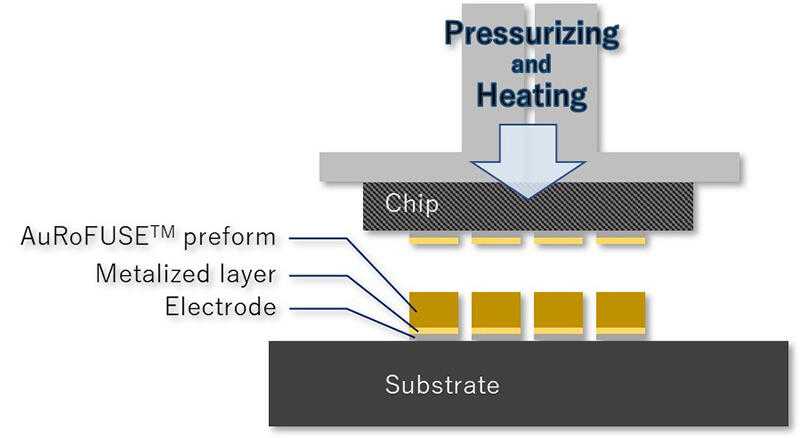
| Pretreatment: | UV ozonation, etc. |
| Thermo-Compression: | 200℃, 20MPa, 10sec. |
| Post-Bake: | 200℃, 60min. |
특성표
| 200℃, 20MPa, 10sec | 200℃, 100MPa, 10sec | |
|---|---|---|
| 전기 저항률 (µΩ·cm) | 3.0 | 2.6 |
| 열전도율 (W/mK) | 250 | 280 |
| 영률(GPa) | 57 | 70 |
| CTE : 선팽창 계수 (ppm / K) | 14 | 14 |
| 전단 강도 (MPa) | >30 | |
| 하지막 | Au/Pt/Ti, Au/Pd/Ni | |
AuRoFUSE™ Preforms 기술
사전에 범프를 형성한 기판을 제작하고, 거기에서 대상 칩이나 서브스트레이트로 범프를 전사하는 방법입니다.
기판의 개구부에서 범프를 형성·유지하는 구조이기 때문에, 반송중에 범프가 탈락할 염려가 없습니다.
전사시에는, 가열에 의해 범프가 수축하기 때문에, 수직 방향의 힘을 가하는 것만으로 용이하게 뽑아낼 수가 있습니다.
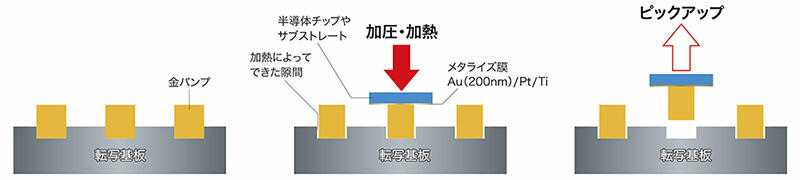
■ 특징
- ① 요철이나 관통공 등 종래 공법에서는 대응이 어려웠던 형상의 반도체 칩이나 서브스트레이트에도 적용이 가능
- ② 박리액 등의 데미지를 우려하여 포토리소그래피 공정에 통과하기 어려운 반도체 칩이나 서브스트레이트에도 적용이 가능
■【전사 기판의 제작 및 전사·접합 프로세스】
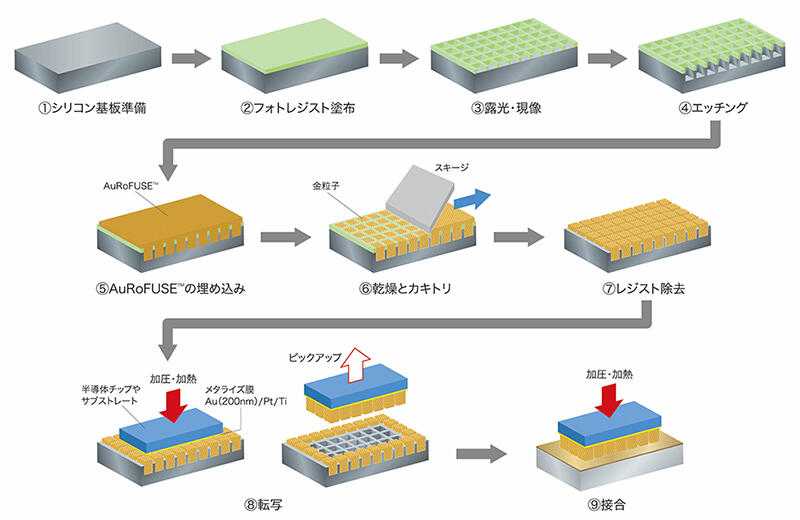
- ① 전사 기판 으로서 실리콘 기판을 준비
- ② 실리콘 기판 상에 포토레지스트를 도포
- ③ 목적의 패턴에 노광 현상한다
- ④ 실리콘 기판에 에칭으로 구멍을 뚫는다
- ⑤ 스퀴지 등을 사용하여 AuRoFUSE™를 내장
- ⑥ AuRoFUSE™를 상온·진공 하에서 건조시켜 레지스트 상의 여분의 금 입자를 긁어낸다
- ⑦ 레지스트를 박리하면 전사 기판 생긴다
- ⑧ 금 범프를 형성하고 싶은 대상(반도체 칩이나 서브스트레이트)을 전사 기판에 대고, 10MPa, 150℃, 1분의 가압 가열을 행한다. 그 후, 수직으로 기판을 들어 올리면 금 범프가 전사된다.
- ⑨ 전사 후의 기판을 20MPa, 200℃, 10초의 가압 가열로 접합한다
실시예
<초소형 양면 냉각 파워 모듈에의 적용 성과(도호쿠 대학 다카하시 료와 교수)>
인버터용 파워 디바이스를 실장한 모듈의 칩 전극과 기판 회로의 접합에 당사 AuRoFUSE™ Preforms 적용함으로써, 종래의 솔더에 비해 열저항값의 개선에 공헌하는 것을 알았습니다. 또한 유럽의 차재용 파워 모듈의 평가 규격(AQG324)에 있는 파워 사이클 시험을 클리어하고 있습니다.


| 시험 | 조건 | AuRoFUSE™ Preforms | 솔더 |
|---|---|---|---|
| 열 저항 | 냉각수: 10L/min | 전체 시스템에서 0.98 | 전체 시스템에서 1.00(기준) |
| 파워 사이클 | T jmax:175℃/T jmin:75℃ 2sec ON/18sec OFF |
60,000사이클에 V on 변동 없음 |
60,000사이클에 V on 초기비 3.2% 증가 |
본 연구는 도호쿠 대학이 문부 과학성 「혁신적 파워 일렉트로닉스 창출 기반 기술 연구 개발 사업」(조성금 번호:JPJ009777)의 지원을 받아 실시된 것으로, 다나까귀금속공업 공업이 어드바이저리 보드해 AuRoFUSE™ Preforms을 제공하고 있습니다.
관련기업
다나까귀금속공업과 Mems Core는 각각의 강점을 살려 재료 제공과 프리폼(금 범프) 프로토타입 및 실장 평가를 양방향으로 연계함으로써 신속한 개발 체제를 실현하고 있습니다.

주식회사 Mems Core WEB 사이트 링크 : https://www.mems-core.com/index.html


