금·금합금 본딩 와이어

50년이 넘는 신뢰와 실적
「금・금합금 본딩 와이어」란
금·금합금 본딩 와이어는 반도체 칩과 전극을 고신뢰에 접속하는 도통재로 뛰어난 접합성 ·내부식성을 갖추고 있습니다. 당사 제품은 전세계의 반도체 메이커에 채용되는 월드 스탠다드로서 미세화나 고루프 제어 등 다양한 실장 요구에 대응하고 있습니다.
HAZ 길이와 파단 하중 [Au Wire dia. 25um]
![[HAZ 길이와 파단 하중 비교 그래프] 왼쪽에서 Y/C/FA/GSA/M3/GHA-2/LC/GSB/GFC/GLF/GMH/GFD/GPH/GPG-3/GPG/GPG-2/GMG/GMH-2](/jp/products/img/img_bonding_wires_au_02.jpg)
GSA / GSB– 안정된 2nd 접합이 가능한 Au 본딩 와이어
특징
- 안정된 스티치 접합성으로 인해 QFN, QFP, BGA 패키지에서도 국소적인 부착이 발생하기 어렵다.
- 스티치 풀 시험 후의 금 나머지가 많고, 스티치 접합부에서의 본드 리프트가 적다.
- 압착 직경의 편차가 적고, 진원성이 양호하고 FAB가 부드럽고 압착 볼이 변형되기 쉽다.
Stable Stitch Bond on QFN Packages (PPF, 175℃)
![[Frequency와 2nd Pull Strength 비교 그래프]Average-GSA:4.3gf/FA:4.1gf/GSB:4.2gf/GHM:4.0gf](/jp/products/img/img_bonding_wires_au_03.jpg)
After Stitch Pull Test
![[After Stitch Pull Test]GSA/FA/GSB/GMH](/jp/products/img/img_bonding_wires_au_04.jpg)
Squashed Ball Roundness
![[Squashed Ball Roundness 비교] GSA/GSB/FA/GMH](/jp/products/img/img_bonding_wires_au_05.jpg)
GFC/GFD- 미세 피치 장착 가능 Au 본딩 와이어
특징
- 본딩시 초음파에 의한 압착 볼의 변형이 적다.
- 필요한 충분한 초음파를인가 할 수 있기 때문에 양호한 접합 상태가 얻어진다.
- 다양한 패드 피치 본딩에 대응.
Ball Shape
![[Ball Shape 비교] GMH/GFC/GFD, FAB:38-61µm,SBD:45-75µm](/jp/products/img/img_bonding_wires_au_06.jpg)
Middle FAB : 51μm SBD : 60μm
Lower FAB : 62μm SBD : 75μm
35µm BPP 본딩
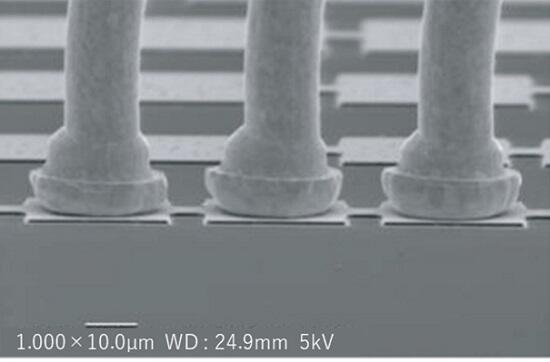
본더 : 시카와 UTC-3000
Pad Opening : 2µm
Scatter Diagram at 35µm BPP 본딩

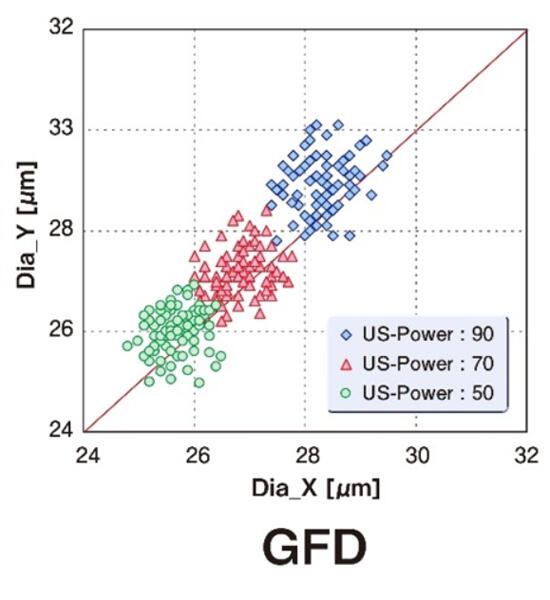

GPH- 고신뢰성 대응 Au 합금 본딩 와이어
특징
- 할로겐 프리 수지와의 조합으로 높은 신뢰성
![[Failure ratio와 Aging time의 비교 그래프] GPH/GPG series](/jp/products/img/img_bonding_wires_au_11.jpg)
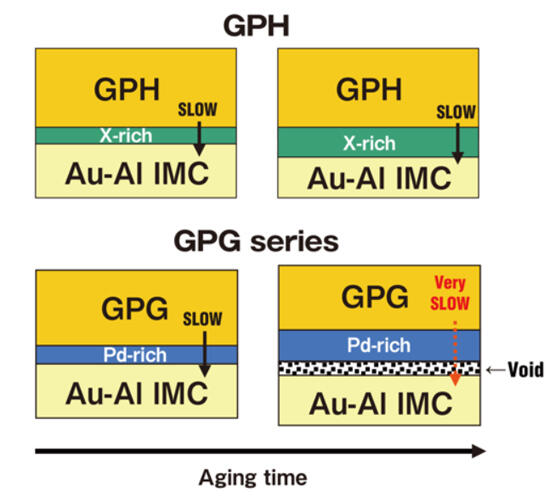
GLF- 초저 루프 대응 Au 본딩 와이어
특징
- 종래의 저루프 와이어보다 저루프 형성성이 우수하다.
- 뛰어난 목 데미지 억제성
- S자 구부림 억제성
- 기존의 저 루프 와이어보다 풀 강도가 높습니다.
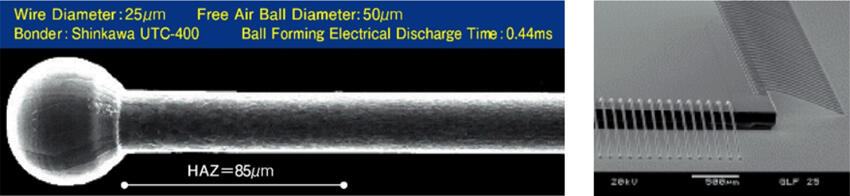
GMG– 고강도 Au 본딩 와이어
특징
- 고강도 타입은 세선화에 의한 코스트 다운이 가능
- BGA 등의 다양한 루프 형상에 대응.
- 스택 다이 패키지로 범프 형성이 우수하다.
Mechanical Properties
![[Breaking Load와 Wire Diameter의 비교 그래프] FA/GMH/GMH-2/M3/GMG](/jp/products/img/img_bonding_wires_au_14.jpg)
기술 데이터 다운로드
기술 데이터는 다음 배너에서 다운로드할 수 있습니다.
스크롤



