Gesinterte Gold(Au) Bonding-Technologie: AuRoFUSE™ Preforms

Was ist "AuRoFUSE™-Präform"?
Die AuRoFUSE™-Präform ist eine von TANAKA entwickelte Au-Sintertechnologie für hochdichte Aufbau- und Verbindungstechnik auf Basis der Niedertemperaturpaste AuRoFUSE™ für Gold-Gold-Bonding. Sie steigert die Prozesseffizienz und Zuverlässigkeit und bietet eine elektrische Resistivität von 4,5 µΩ·cm sowie eine Wärmeleitfähigkeit von 200 W/m·K.
AuRoFUSE™-Präform-Technik
Gesintertes Gold (Au) Verbindungstechnik für eine hohe Bestückungsdichte mittels AuRoFUSE™
Bei dieser Technik wird das Verbindungsmaterial zunächst getrocknet damit es seine Fließfähigkeit verliert. Hierdurch wird die Aufwicklung und horizontale Ausbreitung des Materials unterdrückt bzw. erschwert, wodurch Fine-Pitch-Bonding ermöglicht wird. Bislang konnten auf diese Weise 5 µm große Bumps (Kontaktierhügel) hergestellt werden. Ein Einsatz im Flip-Chip-Montage, bei dem eine hohe Bestückungsdichte erforderlich ist, wird erwartet.
Eigenschaften
- ①Kann Goldnoppen in verschiedenen Größen und Formen erzeugen
(Mindestgröße: 5 µm Größe, 5 µm Abstand) - ② Ausgezeichnete Verformbarkeit unter Druck dank der porösen Struktur des Verbindungsmaterials
- ③ Ermöglicht eine hohe Bestückungsdichte aufgrund seiner geringen horizontalen Verformung wenn es unter Druck gesetzt wird
- ④ Oxidation und Migration sind unwahrscheinlich, da der Hauptbestandteil Gold (Au) ist
- ⑤ Kann bei relativ niedrigen Temperaturen (ab 200℃) und unter atmosphärischen Bedingungen gebondet werden
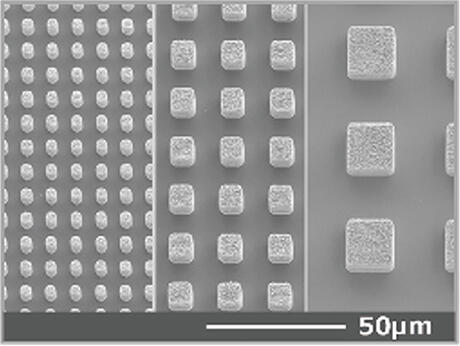
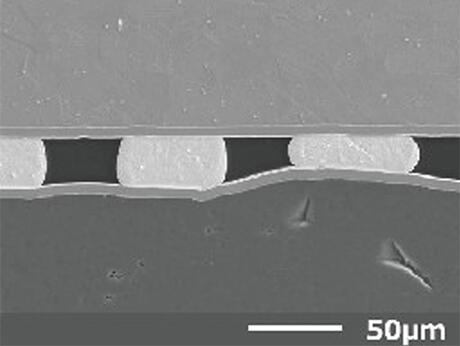

③ Formveränderungsrate bei erhöhtem Fügedruck
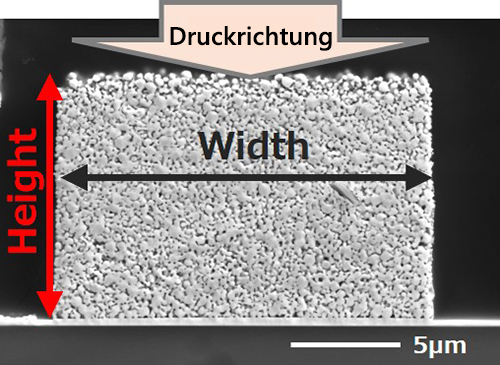

Verwendungsmöglichkeiten
Die-Bonding-Materialien für optische Halbleiter (LED und LD), Leistungshalbleiter und ICs
Herstellung von AuRoFUSE™ Präformen
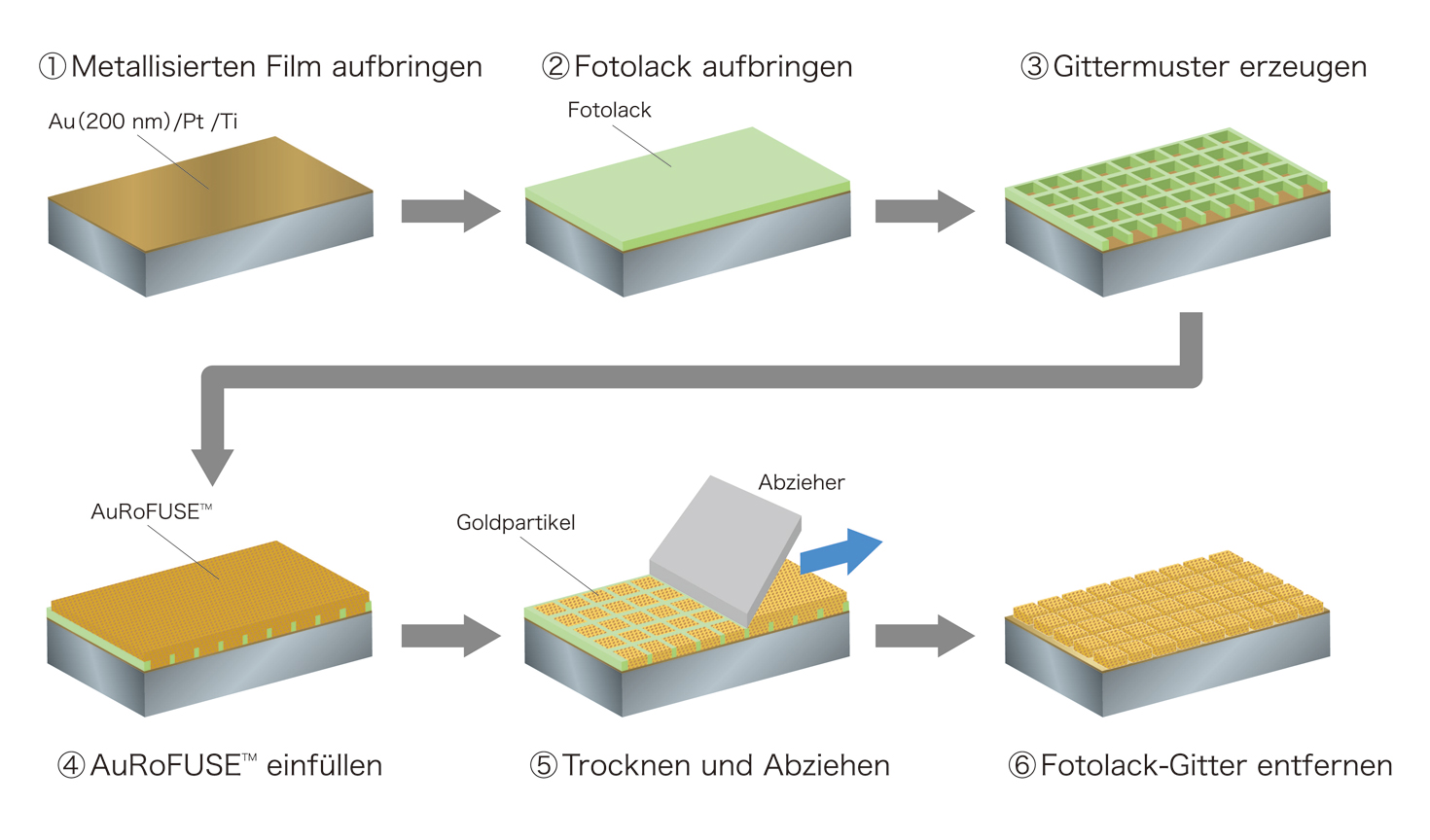
- ① Metallisierung mit Gold/Platin/Titan erzeugt die Basisschicht auf dem Trägermaterial
- ② Aufbringen eines lichtempfindlichen Fotolacks
- ③ Erzeugen des Präform-Musters durch Belichten und Entwickeln des Fotolacks
- ④ AuRoFUSE™ fließt in das Gitter
- ⑤ Trocknen im Vakuum bei Raumtemperatur, danach Abziehen von überschüssigem Gold
- ⑥ Sintern durch Aufheizen, danach Entfernen des Gitters aus Fotolack
Vergleich zwischen AuRoFUSE™-Präformen und anderen Materialien
(〇) AuRoFUSE™- Präform
- Dadurch, dass die Paste vor dem Bonding getrocknet wird, damit sie ihre Fließfähigkeit verliert, wird das seitliche Auslaufen der Paste verringert, was eine hohe Bestückungsdichte ermöglicht
- Aufgrund seiner porösen Struktur, kann die Paste leichter verformt werden, und Bonding ist selbst bei Höhenunterschieden zwischen den Elektroden, Verzug der Platine oder Unterschieden in der Platinendicke, möglich
(△) Lötmaterialien
- Je feiner der Bump-Pitch wird, desto mehr breitet sich das Lotmaterial beim Schmelzen seitlich aus, wodurch es zu Kurzschlüssen durch Kontakt zwischen den Elektroden kommt
(△) stromloses Abscheidung
- Ein enger Bump-Pitch ist realisierbar, jedoch ist beim Bonden ein relativ hoher Druck erforderlich, wodurch es zu Beschädigungen der Chips kommen kann

Bonding-Beispiel: Flip-Chip-Montage (Wende-Montage)
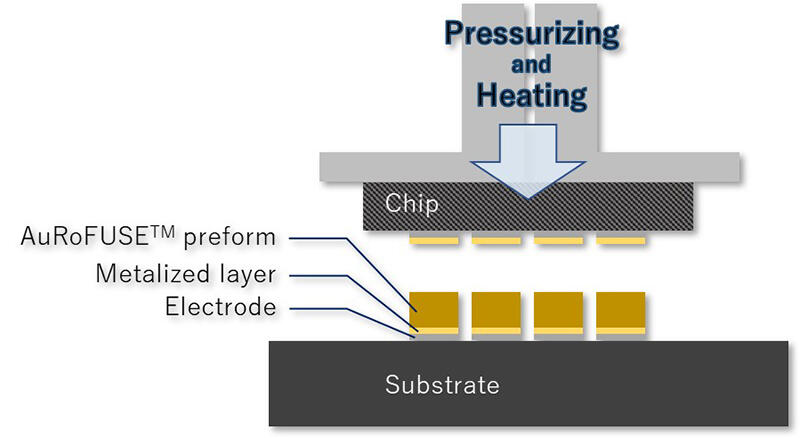
| Pretreatment: | UV ozonation, etc. |
| Thermo-Compression: | 200℃, 20MPa, 10 Sec. |
| Post-Bake: | 200℃, 60 min. |
Materialeigenschaftstabelle
| 200 °C, 20 MPa, 10 s | 200 °C, 100 MPa, 10 s | |
|---|---|---|
| Elektrischer Widerstand (µΩ·cm) | 3.0 | 2.6 |
| Wärmeleitfähigkeit (W/mK) | 250 | 280 |
| Elastizitätsmodul (GPa) | 57 | 70 |
| CTE: Linearer Ausdehnungskoeffizient (ppm/K) | 14 | 14 |
| Scherfestigkeit (MPa) | >30 | |
| Unter Barrieremetall | Au/Pt/Ti, Au/Pd/Ni | |
AuRoFUSE™ Preforms Transfer-Technologie
Diese Methode besteht darin, ein Substrat mit im Voraus gebildeten Erhebungen zu erstellen und dann die Erhebungen von diesem Substrat auf den Zielchip oder das Zielsubstrat zu übertragen.
Da die Erhebungen in den Öffnungen des Substrats gebildet und gehalten werden, besteht kein Risiko, dass die Erhebungen während des Transports abfallen.
Beim Transfer ziehen sich die Erhebungen aufgrund der Erwärmung zusammen, sodass sie durch Anwendung nur vertikaler Kraft leicht herausgezogen werden können.
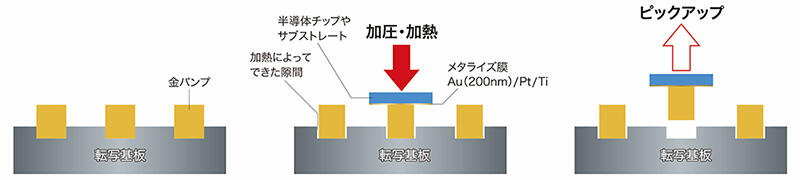
■ Merkmale
- ① Kann auf Halbleiterchips und Substrate angewendet werden, deren Formen mit herkömmlichen Methoden schwer zu handhaben sind, wie z. B. unebene Oberflächen und Durchgangsbohrungen.
- Kann für Halbleiterchips und Substrate verwendet werden, die aufgrund von Bedenken hinsichtlich Schäden durch Abbeizlösungen und andere Quellen nicht leicht photolithographisch bearbeitet werden können.
■【Herstellung von Transfersubstraten und Transfer- sowie Bindungsverfahren】
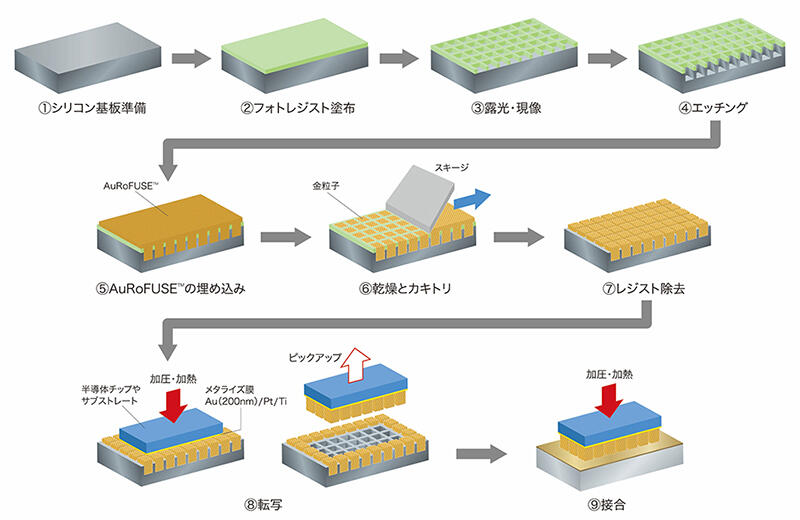
- ① Bereiten Sie ein Siliziumsubstrat als Transfersubstrat vor.
- ② Photoresist auf Siliziumsubstrat auftragen
- ③ Belichten und entwickeln, um das gewünschte Muster zu erhalten.
- ④ Löcher in das Siliziumsubstrat ätzen.
- ⑤ AuRoFUSE™ mit einem Schaber oder einem ähnlichen Werkzeug einbetten.
- ⑥ Trocknen Sie AuRoFUSE™ bei Raumtemperatur und unter Vakuum und schaben Sie überschüssige Goldpartikel vom Resist ab.
- ⑦ Das Entfernen des Widerstands erzeugt ein Übertragungssubstrat.
- ⑧ Das Objekt (Halbleiterchip oder Substrat), auf dem Goldbumps gebildet werden sollen, wird auf das Transfer-Substrat gelegt, und es erfolgt eine druckbeaufsichtigte Erwärmung bei 10 MPa, 150 °C und für 1 Minute. Danach wird das Substrat vertikal angehoben, und die Goldbumps werden übertragen.
- ⑨ Verbinden Sie das Substrat nach dem Transfer bei 20 MPa, 200 °C und 10 Sekunden druckbeaufsichtigtem Erhitzen.
Beispiel
Ergebnisse der Anwendung auf ein ultrakompaktes, doppelseitiges Kühlleistungsmodul (Professor Yoshikazu Takahashi, Universität Tohoku)>
Die Verwendung von AuRoFUSE™ Preforms zur Verbindung von Chip-Elektroden von Modulen, die mit Leistungshalbleitern für Wechselrichter und Substratschaltungen ausgestattet sind, hat sich als vorteilhaft für die Verbesserung des thermischen Widerstands im Vergleich zu herkömmlichem Lötzinn erwiesen. Darüber hinaus hat es den Power Cycle Test bestanden, der Teil der Bewertungsstandards für Automobil-Leistungsmodule in Europa (AQG324) ist.

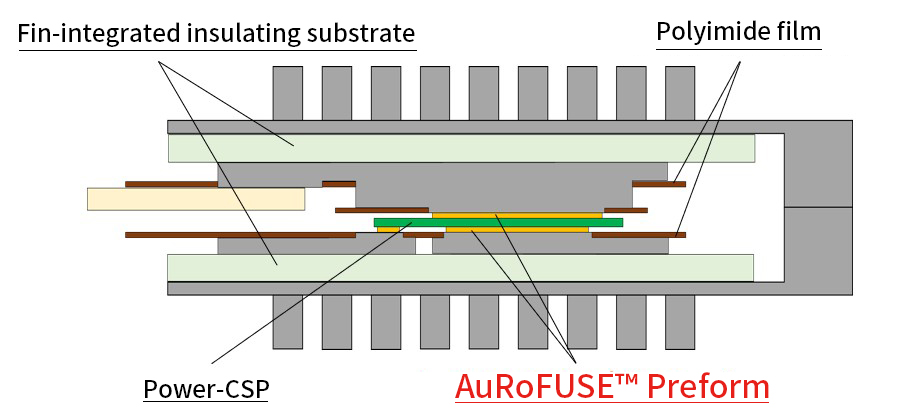
| Prüfen | Bedingungen | Gesinterte Gold(Au) Bonding-Technologie: AuRoFUSE™ Preforms | Lötmittel |
|---|---|---|---|
| Wärmeleitfähigkeit | Kühlwasser: 10 l/min | 0,98 für das gesamte System | 1,00 (Referenz) für das gesamte System |
| Stromzyklus | T jmax:175℃/T jmin:75℃ 2 Sek. EIN/18 Sek. AUS |
60.000 Zyklen V on bleibt unverändert. |
60.000 Zyklen V erhöhte sich um 3,2 % im Vergleich zur ursprünglichen Version. |
Diese Forschung wurde von der Tohoku-Universität mit Unterstützung des Ministeriums für Bildung, Kultur, Sport, Wissenschaft und Technologie im Rahmen des "Forschungs- und Entwicklungsprojekts zur Entwicklung innovativer Leistungselektronik" (Zuschussnummer: JPJ009777) durchgeführt, und TANAKA PRECIOUS METAL TECHNOLOGIES stellte AuRoFUSE™ Preforms zur Verfügung und war im Beratungsgremium tätig.
Verbundene Unternehmen
TANAKA PRECIOUS METAL TECHNOLOGIES und MEMS CORE nutzen ihre jeweiligen Stärken, um Materialien bereitzustellen und die Implementierung von Vorformen (Au-Bumps) in einer gegenseitig koordinierten Weise zu prototypisieren und zu evaluieren, um ein schnelles Entwicklungssystem zu etablieren.

MEMS CORE, INC. Webseite: https://www.mems-core.com/index.html
Weitere Informationen
Bitte Kontakt
Bitte zögern Sie nicht, uns bei jeglichem Kontakt bezüglich Produkten, Medien, Wettbewerbsförderung usw. zu kontaktieren.