Gold- und Goldlegierungs- bonddrahte

Über 50 Jahre Vertrauen und Zuverlässigkeit
Was sind "Gold- und Goldlegierungs-Bondingdrähte"?
Gold (Au) und Goldlegierungs-Bondingdrähte mit hoher Leistung unterstützen weiterhin die Halbleiterindustrie. Als leitfähige Verbindungsmaterialien zur zuverlässigen Verbindung von Halbleiterchips mit Elektroden bieten sie hervorragende Bondfähigkeit, chemische Stabilität und hohe elektrische Leitfähigkeit. Durch kontinuierliche Materialentwicklung können Funktionen wie feines Bonding und geringe Schlaufenbildung erreicht werden, während eine hohe Reinheit beibehalten wird, um den vielfältigen Anforderungen an die Halbleiterverpackung weltweit gerecht zu werden.
HAZ-Länge und Bruchlast [Au-Drahtdurchmesser 25 µm]
![[HAZ-Längen- und Bruchlastvergleichsgraph] Von links: Y/C/FA/GSA/M3/GHA-2/LC/GSB/GFC/GLF/GMH/GFD/GPH/GPG-3/GPG/GPG-2/GMG/GMH-2](/jp/products/img/img_bonding_wires_au_02.jpg)
GSA / GSB– Au-Bondingdrähte, die eine stabile zweite Bonding-Verbindung ermöglichen
Eigenschaften
- Die stabile Nahtbindung minimiert lokale Nicht-Haftung in QFN-, QFP- und BGA-Gehäusen.
- Nach den Stichziehversuchen bleibt eine große Menge Gold übrig, und die Ablösung der Verbindung an den Nahtstellen ist minimal.
- Hat eine geringe Variation im Crimpdurchmesser, eine gute Rundheit und ist weich, was es der gecrimpten Kugel erleichtert, sich zu verformen.
Stabile Stichverbindung auf QFN-Gehäusen (PPF, 175℃)
![[Grafik, die Frequenz und 2. Zugkraft vergleicht] Durchschnitt-GSA: 4,3gf / FA: 4,1gf / GSB: 4,2gf / GHM: 4,0gf](/jp/products/img/img_bonding_wires_au_03.jpg)
Nach dem Nahtzugtest
![[Nach dem Stitch Pull Test] GSA/FA/GSB/GMH](/jp/products/img/img_bonding_wires_au_04.jpg)
Die Rundheit eines zusammengedrückten Balls
![[Vergleich der Rundheit von zusammengedrückten Bällen] GSA/GSB/FA/GMH](/jp/products/img/img_bonding_wires_au_05.jpg)
GFC / GFD- Au-Bond-Draht für die Montage mit feinen Abständen
Eigenschaften
- Weniger Verformung der Bindekugeln durch Ultraschall während des Bindens.
- Gute Bindungsbedingungen können erreicht werden, da ausreichender und geeigneter Ultraschall angewendet werden kann.
- Unterstützt verschiedene Pad-Pitch-Bonding.
Ball
![[Vergleich der Kugelformen] GMH/GFC/GFD: 38-61µm, SBD: 45-75µm](/jp/products/img/img_bonding_wires_au_06.jpg)
Mitte FAB : 51µm SBD : 60µm
Unten FAB : 62µm SBD : 75µm
35µm BPP-Bonding
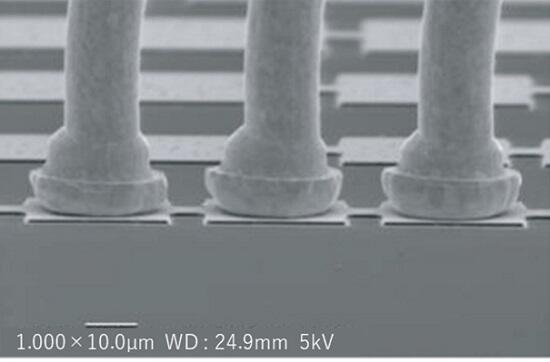
Bonder : Shikawa UTC-3000
Pad-Öffnung : 2µm
Streudiagramm bei 35µm BPP-Bonding

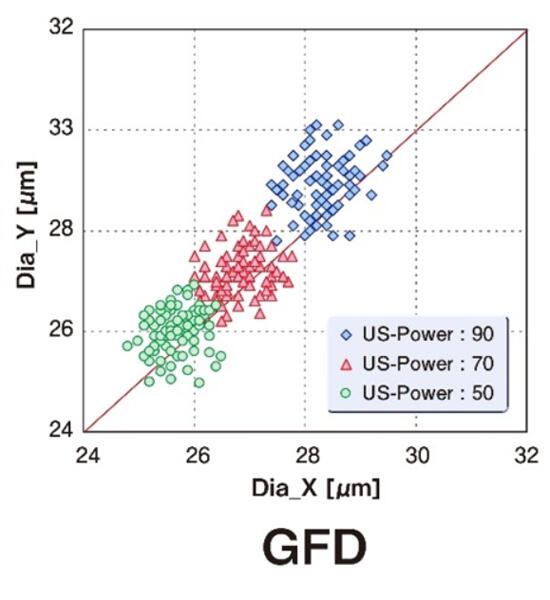

GPH- Hochzuverlässiger Bonding-Draht
Eigenschaften
- Hohe Zuverlässigkeit in Kombination mit halogenfreien Harzen.
![[Grafik, die das Ausfallverhältnis und die Alterungszeit vergleicht] GPH/GPG-Serie](/jp/products/img/img_bonding_wires_au_11.jpg)
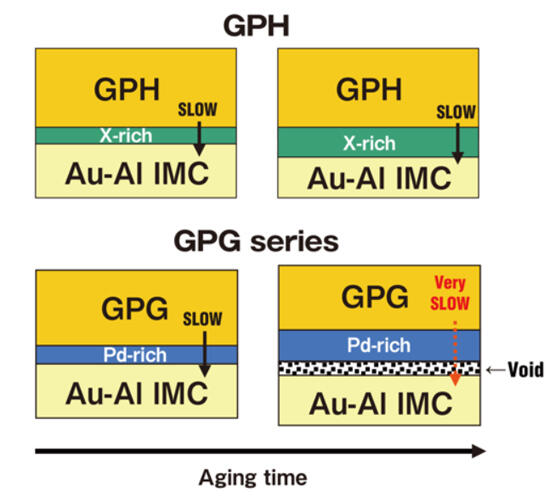
GLF- Au-Bondingdraht für ultra-niedrige Schleifen
Eigenschaften
- Hat eine bessere Schleifenformbarkeit als herkömmlicher Draht mit niedrigem Schlaufenanteil.
- Ausgezeichnete Widerstandsfähigkeit gegen Nackenschäden.
- Verhinderung von S-Biegungen
- Hat eine höhere Zugfestigkeit als herkömmlicher Draht mit niedrigem Schlaufen.
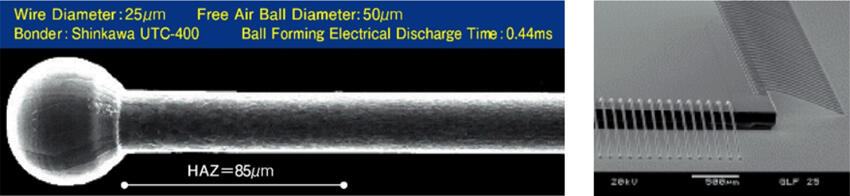
GMG– Hochstärke Au-Bindedraht
Eigenschaften
- Hochfestigkeitsarten können Kosten senken, indem sie in dünnere Drähte hergestellt werden.
- Unterstützt verschiedene Schleifenformen, einschließlich BGA.
- Ausgezeichnet für die Bildung von Erhebungen in gestapelten Gehäusepaketen.
Mechanische Eigenschaften
![[Diagramm, das die Bruchlast und den Drahtdurchmesser vergleicht] FA/GMH/GMH-2/M3/GMG](/jp/products/img/img_bonding_wires_au_14.jpg)
Technische Daten herunterladen
Technische Daten können über das Banner unten heruntergeladen werden.
Bitte Kontakt
Bitte zögern Sie nicht, uns bei jeglichem Kontakt bezüglich Produkten, Medien, Wettbewerbsförderung usw. zu kontaktieren.



