SHOW ROOM 01
TANAKA
DIGITAL SHOWROOM

SHOW ROOM 02
Tanaka Forum @ Plug and Play

SHOW ROOM 01

SHOW ROOM 02

Contents

High-purity aluminum (Al) bonding wires and ribbons with excellent surface properties.

TANAKA offers bonding thick wires (100 to 500µm) as metal bonding materials for power modules.

Sheet bonding component that enables bonding of large silicon(Si)chips

TANAKA provides composite materials of Cu and active brazing filler metals that are expected to be used for applications such as ceramic circuit boards, and heat dissipation parts such as heat sinks, for power devices.
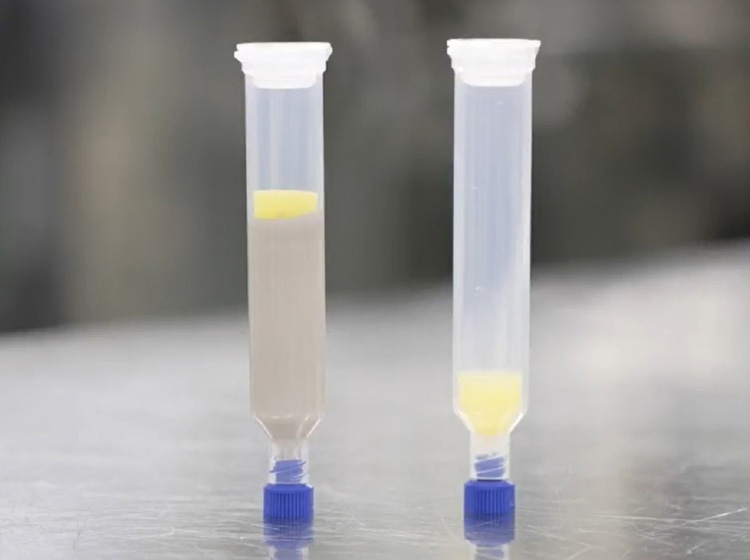
Conductive adhesives for die bonding are used with Si for power devices and SiC and GaN next-generation semiconductors. Our lineup includes hybrid types that allow a balance of high thermal conductivity and high reliability and sintering types with high thermal conductivity exceeding 200W/m・K.

High Thermal Conductivity and High Reliability Ag Adhesive Pastes for power devices and SiC and GaN next-generation semiconductors.
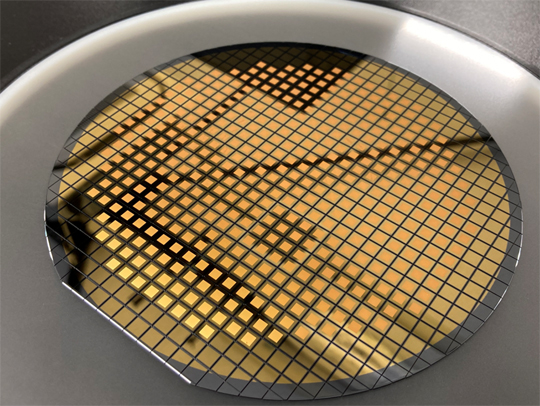
A gold particle bonding technology for high-density mounting of semiconductors using AuRoFUSE™ low-temperature fired paste for gold-to-gold bonding.

This paste is made solely from sub-micron sized gold particles with a solvent that has low electrical resistivity (5.4µΩ-cm) and provides high thermal conductivity (150W/mK) metal bonds.
Contents
TANAKA DIGITAL SHOWROOM

Details
[Al Bonding Wires for Power Modules]
TANAKA ELECTRONICS offers high-purity aluminum (Al) bonding wires and ribbons with excellent surface properties of automotive grade. As aluminum has excellent corrosion resistance , it is often used in power device applications that drive high currents under harsh environments. We also have wires for power devices that use copper, which has even better electrical conductivity.
[Characteristics]
●Excellent corrosion resistance.
●Excellent bondability.
●Wire diameter : Φ100 – 500μm
●Length : Max 800m (Φ300μm / No.88K)
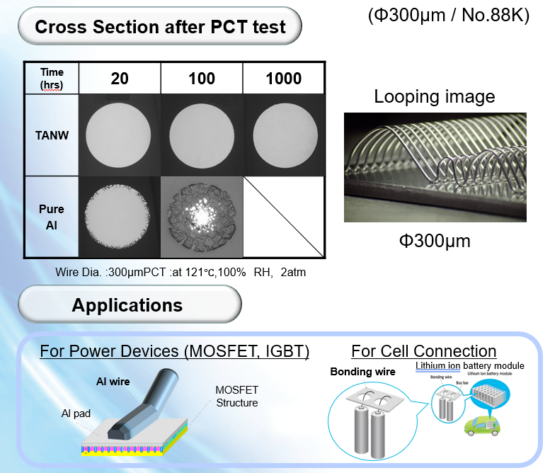
Details
Details
[AgSn TLP Sheet]
AgSn TLP: Transient Liquid Phase diffusion bonding
Sheet bonding component that enables bonding of large silicon(Si)chips
A large area that supports a chip size of 20 mm with highly reliable bonding
Helps meet the growing need for high-power semiconductors in EV, HV, industrial infrastructure, and other applications.
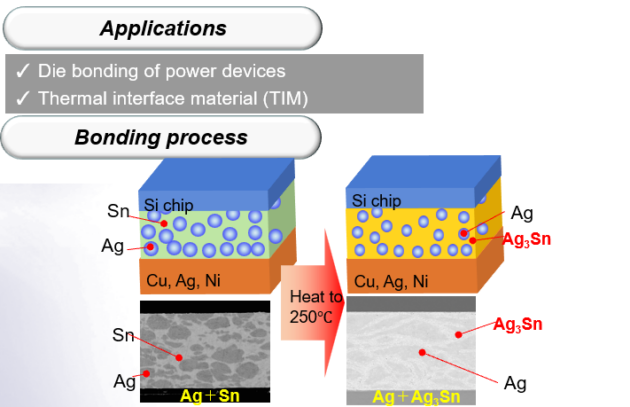
Details
Details
[Ag Paste for Pressure Sintering]
TANAKA’s lineups of Silver Adhesive Pastes for Die Bonding, Pressure Sintering and non-pressure Sintering is also available.
[Features]
●Both pressure and pressure-less available
●Excellent bonding to Cu
●Small to large area bonding
●RoHS Compliance & High performance
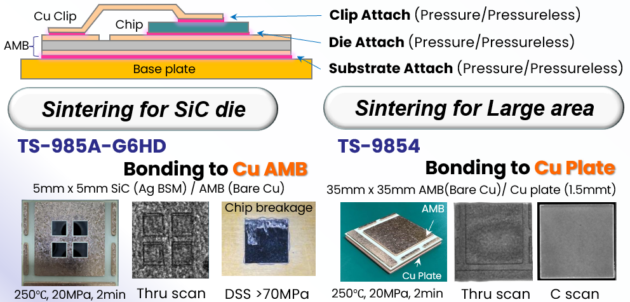
Details
A gold particle bonding technology for high-density mounting of semiconductors using AuRoFUSE™ low-temperature fired paste for gold-to-gold bonding

[Features]
・Can achieve fine pitch bonding (Minimum actual size: 10µm, 4µm gap)
・Bonding is possible at comparatively low temperatures and pressures in a short time (e.g. 200°C, 20MPa, 10 seconds)
・Minimal horizontal deformation in the horizontal direction during compression
・Has compression deformability
・Its main component is Au, so oxidation and migration are unlikely
Using this new technology, the paste is dried prior to bonding to eliminate fluidity, which minimizes spread and enables high-density mounting. The porous structure of the paste makes it easily formable as well, which enables bonding even when there is a difference in height between electrodes or differences in warpage or thickness of the substrate.
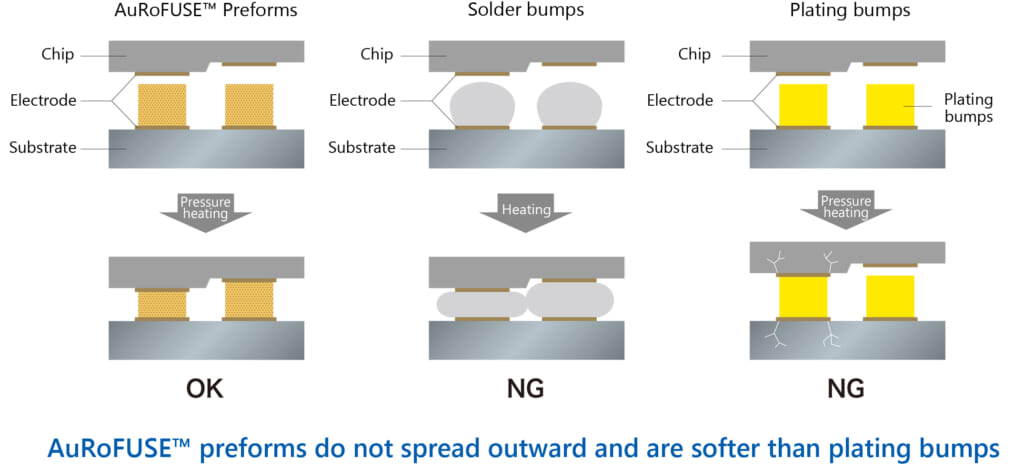
Details
Please input your customer information
TANAKA DIGITAL SHOWROOM
