편집장 픽업: 다나까귀금속, 소결 (Au) 접합 기술의 전사 기술을 확립

견적 소스: Semiconductor Digest
날짜: 2026년 2월 3일
문장 : Semiconductor Digest 공동 창립자 겸 편집장 피트 싱어 Pete Singer)씨
링크: TANAKA Establishes Transfer Technology for its Sintered Gold Bonding Technology - Semiconductor Digest
편집장 픽업: 다나까귀금속, 소결 (Au) 접합 기술의 전사 기술을 확립
다나까귀금속의 산업용 귀금속 사업을 전개하는 다나까귀금속공업 주식회사는, 소결 (Au) 접합 기술 「AuRoFUSE™(오로퓨즈) 프리폼」에 있어서, 금 범프의 전사 기술을 확립한 것을 발표했다. 본 기술에 의해, 복잡한 구조의 반도체 칩이나 서브스트레이트에 대해서도 AuRoFUSE™ Preforms (이하, 금 범프) 형성을 행할 수 있다.
금 범프를 전사할 수 있는 장점
본 기술은, 미리 금 범프가 형성된 기판 (이하, 전사 기판)을 제작하고, 그로부터 대상의 반도체 칩이나 서브스트레이트로 범프를 전사하는 방법이다. 전사 기판 으로서 사용되는 실리콘 기판에 개구부를 설치하고, 그 개구부에 금 범프를 형성한다. 금 범프를 개구부 전체에 충전하도록 형성함으로써, 기판에 유지되고, 핸들링 중에 금 범프가 탈락할 염려가 없다. 한편, 전사시에는 가열에 의해 금 범프가 수축하여 개구부와 금 범프 사이에 약간의 간극이 발생한다. 이 때문에, 수직 방향의 힘을 가함으로써, 용이하게 당기는 것이 가능해진다.
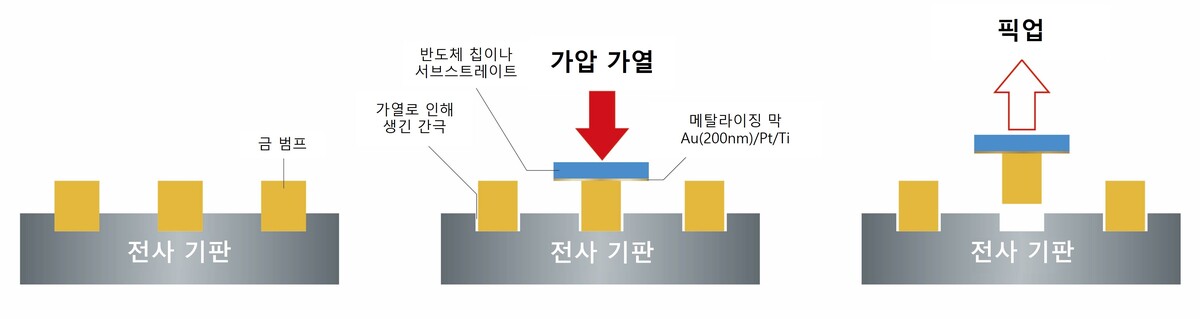
종래의 금 범프 형성 프로세스는, 대상의 반도체 칩이나 서브스트레이트에 직접 범프를 형성하는 방법이기 때문에, 요철이나 관통공 등 복잡한 형상을 갖는 대상물에는, 레지스트의 높이가 안정되지 않는 등의 과제가 있어, 대응이 곤란했다.
이번 전사 기술에서는, 금 범프를 별도로 제작하고, 목적의 장소에만 금 범프를 전사할 수 있기 때문에, 복잡한 형상에도 적용이 가능해진다. 또한, 박리액 등에 의한 데미지가 우려되어 포토리소그래피 공정에 통과하기 어려운 반도체 칩이나 서브 스트레이트에도 대응할 수 있게 된다.
본 기사는, Semiconductor Digest의 허가를 얻고, Semiconductor Digest의 2026년 3월 3일자의 기사를 다나까귀금속 번역·전재한 것입니다.
본 기사는 Semiconductor Digest에 게재된 것입니다. 자세한 내용은 여기를 참조하십시오.
더 보기 (Semiconductor Digest)
관련 정보


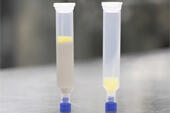

파워 반도체 패키지 패키징 기술의 최신 동향,
고방열성· 고내열성 실현하는 최첨단 소재
스마트폰이나 전자기기 등의 에너지 절약화, EV 등의 차세대 모빌리티, 기지국,
재에너지의 전력 제어 등 파워 반도체의 기술 개발은 점점 고출력화와 고효율화가 진행되고 있습니다.
고방열·고내열·접합 신뢰성의 공장·소형화 등의 과제에 대응하기 위한 최첨단 소재와,
패키징의 기술 동향을 소개합니다.
이 기사는 어땠어?
참고가 된 분은, 공유를 부탁합니다.




