【著眼於日益普及的光子學-電子學融合領域】面向下一代高密度封裝的新思路,開啟「黃金」封裝的可能性
電子學
半導體
接合與封裝
繼電器與電氣連接
目前,半導體後處理領域,尤其是封裝技術,正加速引入劃時代的新技術。同時,人們對能夠適應這些創新、基於全新理念的材料特性和性能的開發寄予厚望。田中貴金屬工業株式會社開發了一種名為「AuRoFUSE™ Preform」的新型封裝解決方案,該方案具有極高的可靠性,並可實現高密度封裝。
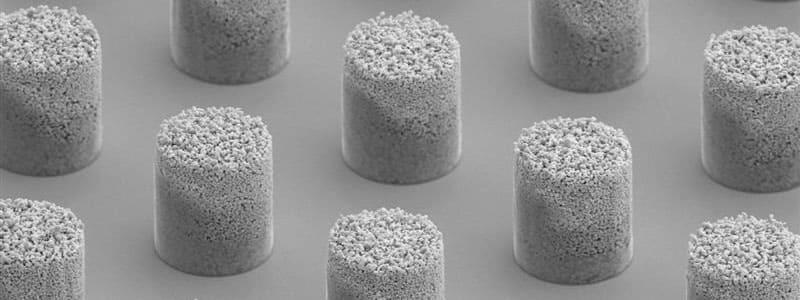
近年來,在半導體和電子設備領域中,需要通信速度的提高,節能和裝置的進一步小型化。作為滿足這些需求的技術而受到關註的是在高度方向上堆疊組件的三維安裝和在有限空間中包裝許多功能的高密度安裝。
支撐這些封裝技術的關鍵要素之一是倒裝晶片鍵合。此方法是將晶片倒置到基板上並直接鍵合,電極之間透過凸块連接。接合材料必須具備多種功能特性,例如鍵合溫度、導電性和導熱性,因此材料選擇至關重要。
凸块形成材料面臨的挑戰
目前,凸块電極的形成主要採用焊接和電鍍。
焊接雖然成本低、加工速度快,但人們擔心在小間距下有短路風險。電鍍雖然擅長處理細線,但其硬度較高,難以吸收高度變化或不均勻負載,這可能導致連接不良和殘餘應力等問題。
為了克服這些問題,現在正在大力開發新材料和優化連接工藝。倒裝晶片技術的進一步發展將是支持下一代半導體封裝的關鍵。
1 2
這是經日經BP許可在“Nikkei CrossTech” (2025年11月21日發佈) 上發表的廣告文章摘錄。
(禁止擅自轉載)
相關資訊
最新動力半導體封裝技術趨勢、高散熱與高耐熱性尖端材料
電力半導體技術的發展,如智慧型手機與電子裝置的節能、電動車等次世代移動技術、基站,以及再生能源的電力控制,將帶來更高的產能與效率。
我們將引入尖端材料與包裝技術趨勢,以應對高散熱性、高耐熱性、結合可靠性與微型化等問題。


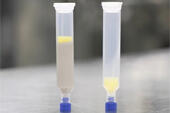

這篇報道怎麽樣?
請參考的人分享。
Scroll




