【著眼於日益普及的光子學-電子學融合領域】面向下一代高密度封裝的新思路,開啟「黃金」封裝的可能性
作為異質晶片和基板之間的中介
在半導體後處理技術應用發展趨勢的背景下,田中貴金屬工業工業株式會社開發了一種名為「AuRoFUSE Preform」的新型封裝解決方案,可實現高可靠性、高密度的倒裝晶片封裝,目前正準備進行量產和供應。此技術利用次微米大小金顆粒的低溫燒結特性,製造出各種尺寸和形狀的金凸块(圖1)。
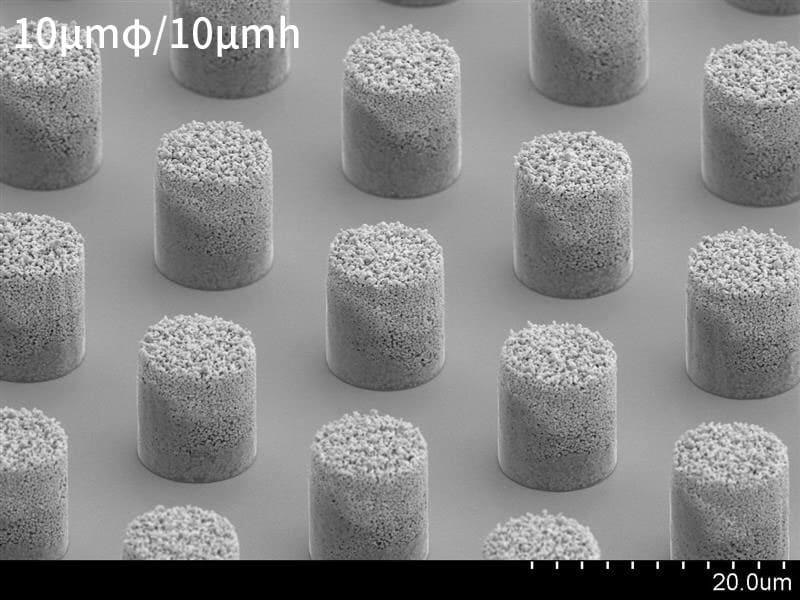
參與研發的牧田雄一表示:「用於將晶片連接到基板材料不僅需要有效地傳輸電訊號和熱量,還需要起到『調節器』的作用,以協調晶片和基板在狀態和物理特性上的差異。AuRoFUSE預成型件繼承了引線鍵合的功能,兼具這兩種新型特性,我們正在將其開發為時代需求的連接性。
採用 AuRoFUSE 預成型件形成的凸块可以在約 200°C 的相對較低的溫度下進行熱壓鍵結。雖然其連接密度略低於混合鍵合,但由於工藝更簡單,減輕了安裝過程的負擔,因此可以說它是一種極其有用的高密度連接技術。
形成的凸块具有由約0.4 μm金顆粒組成的多孔性結構,因此在連接過程中施加壓力時,它們不易改變寬度或形狀(圖2)。這降低了電極間發生短路的可能性,從而實現高密度、高可靠性的連接。同樣,即使待鍵合的基板尺寸較大且鍵合表面不平整,這些凸塊也能靈活地吸收翹曲、不平整和台階,從而實現高良品率貼裝。
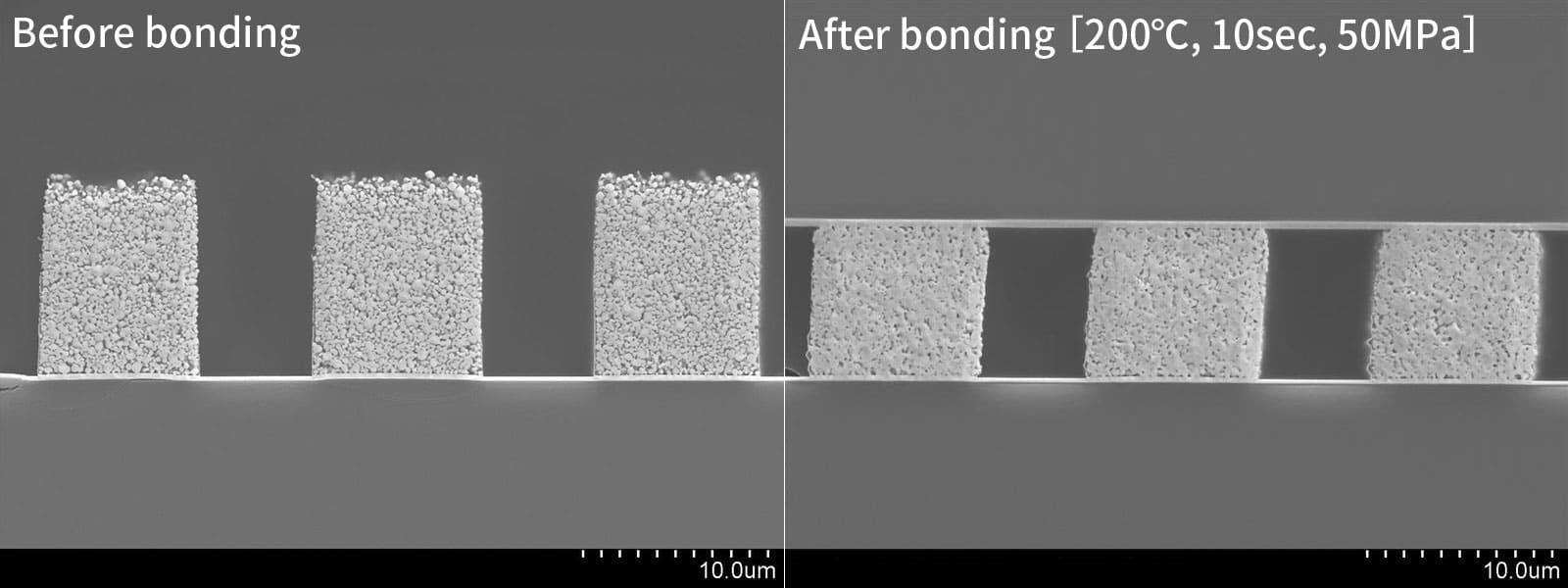
採用 AuRoFUSE 製程形成的凸块可以像海綿一樣,在高度方向上被壓縮,而寬度方向上的尺寸變化很小。這使得壓縮凸块之間出現短路等缺陷的可能性大大降低。
此外,由於主要成分是金,因此電阻低(4.5μΩ·cm,可通過加壓改善),熱傳導率極高,為200 W/mK。「它也非常適合安裝處理大電流和發熱量的設備,例如功率半導體。此外,由於金具有穩定的物理性質,不易發生氧化和遷移,因此可以實現長期可靠的連接。」Makita說。
提出發揮新材料力量的新工序
AuRoFUSE是一種由金顆粒和有機溶劑組成的膏材材料。通常,可以透過點膠機擠出形成凸块。然而,這種方法僅限於形成約600微米的凸块。
因此,該公司開發了一種利用AuRoFUSE技術優勢的新工藝,能夠形成最小尺寸為5 μm、間距為5 μm的微小高密度金凸块(圖3)。該公司開發的金凸块形成工藝結合了光刻工藝和膏材印刷工藝,並且與現有工藝高度相容。
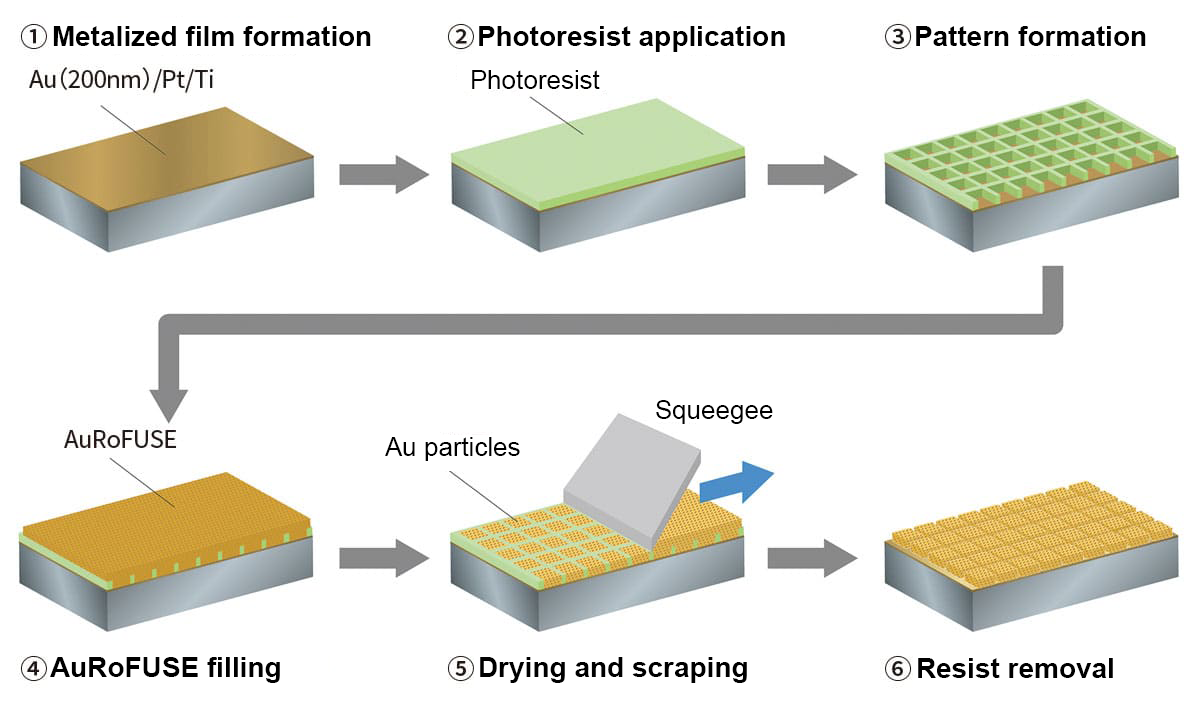
首先,在基板上沉積一層金屬薄膜 (Au/Pt/Ti),作為連接的基底,在其上塗上光阻,並透過曝光製程形成凸块圖案。接著,膏材以印刷方式嵌入,去除抗蝕層並將其烘乾,形成預成型。
除了提供原料外,該公司還在努力建立一套支援體系,幫助用戶企業將黃金凸块成型製程實現量產。由於該技術採用黃金這種功能卓越的貴金屬,該公司正在建立一套廢棄材料回收系統,從而實現可持續利用並降低用戶成本。
衹力於應用市場開發的渡邊尚登表示:「我們很自豪AuRoFUSE Preform是一項可以實現的技術,因為我們公司已經完善並積累了140年的貴金屬技術。目前,我們正在研究進一步提高性能和擴大應用範圍,特別是有望應用於熱控制重要的領域,例如微型LED和光電融合晶片的光源安裝。」。
利用AuRoFUSE預制件等新時代的實現解決方案,半導體晶片將進一步發展。

這是經日經BP許可在“Nikkei CrossTech” (2025年11月21日發佈) 上發表的廣告文章摘錄。
(禁止擅自轉載)
相關資訊
最新動力半導體封裝技術趨勢、高散熱與高耐熱性尖端材料
電力半導體技術的發展,如智慧型手機與電子裝置的節能、電動車等次世代移動技術、基站,以及再生能源的電力控制,將帶來更高的產能與效率。
我們將引入尖端材料與包裝技術趨勢,以應對高散熱性、高耐熱性、結合可靠性與微型化等問題。


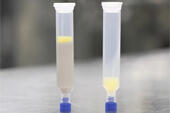

這篇報道怎麽樣?
請參考的人分享。




