編輯推薦:田中貴金屬建立了燒結(Au)鍵結轉移技術。

引用自: Semiconductor Digest
日期:2026年2月3日
撰文:Semiconductor Digest聯合創始人兼總編輯Pete Singer (Pete Singer) 先生
鏈接: TANAKA Establishes Transfer Technology for its Sintered Gold Bonding Technology - Semiconductor Digest
編輯推薦:田中貴金屬建立了燒結(Au)鍵結轉移技術。
經營田中貴金屬金屬工業業務的田中貴金屬工業株式會社宣布,其燒結(Au)鍵合技術「AuRoFUSE™預成型體」已開發出金凸块轉移技術。此技術即使在結構複雜的半導體晶片和基板上也能形成AuRoFUSE™ Preforms(以下簡稱金凸块)。
轉移黃金凸块的益處
此技術是預先形成金凸块,並將凸块轉移至目標半導體晶片或基板基板(以下簡稱轉移基板)的方法。 在用作轉印基板的矽基板開口,並在開口中形成金凸块。 透過形成金凸块填滿整個開口,金子被固定在基板中,無需擔心金凸块在搬運時會掉落。 另一方面,轉移過程中,加熱使金凸块收縮,造成開口與金凸块之間有輕微間隙。 這使得透過施加垂直力可以輕鬆拉出。
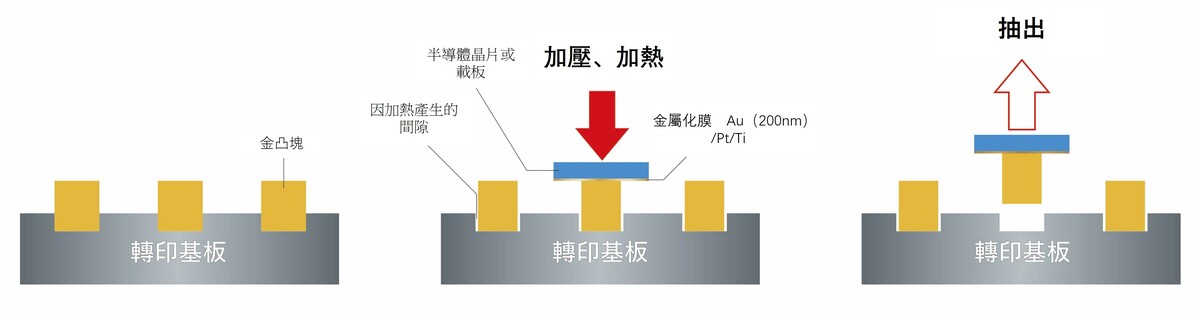
傳統的金凸块形成製程直接在目標半導體晶片或基板上形成凸块。然而,這種方法在處理形狀複雜的物體(例如表面不平整或有通孔的物體)時存在挑戰,例如電阻高度不一致等問題。
這種轉移技術可以分別製造金凸块,並將凸块轉移到所需位置,因此適用於複雜形狀的裝置。此外,由於擔心剝離液會造成損壞,一些半導體晶片和基板難以透過光刻技術進行加工,而這種技術也使得這些裝置的應用成為可能。
本文為田中貴金屬翻譯並轉載自 Semiconductor Digest 於 2026 年 3 月 3 日發表的文章,經 Semiconductor Digest 許可轉載。
本文發表於Semiconductor Digest。有關詳細信息,請單擊此處。
查看更多 (Semiconductor Digest)
相關資訊


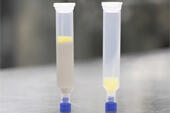

功率半導體封裝技術的最新趨勢
採用尖端材料,實現高散熱性和高耐熱性
智能手機和電子設備等的節能化、EV等的下一代移動性、基站、
再能源的電力控制等,功率半導體的技術開發將進一步向高輸出化和高效化發展。
為應對高放熱、高耐熱、接合可靠性的工廠、小型化等課題,介紹最先進的材料和
包裝的技術動向。
這篇報道怎麽樣?
請參考的人分享。




