【Mit Fokus auf das Potenzial für die photonische Fusion, das zunehmend Beachtung findet】„Gold“ eröffnet neue Perspektiven für die hochdichte Montage der nächsten Generation.
Aktuell beschleunigt sich in den Backend-Prozessen der Halbleiterindustrie die Einführung neuer, potenziell bahnbrechender Technologien, insbesondere im Bereich der Packaging-Technologien. Gleichzeitig steigen die Erwartungen an die Entwicklung von Materialien mit neuen Eigenschaften und Merkmalen, basierend auf innovativen Ideen. TANAKA PRECIOUS METAL TECHNOLOGIES hat mit „AuRoFUSE™ Preform“ eine neue Montagelösung entwickelt, die sich durch hohe Zuverlässigkeit und die Möglichkeit der Montage mit hoher Dichte auszeichnet.
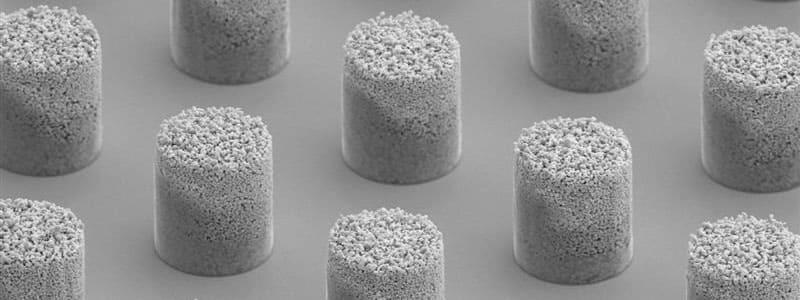
In den letzten Jahren haben die Halbleiter- und Elektronikgerätebranchen schnellere Kommunikationsgeschwindigkeiten, einen reduzierten Energieverbrauch und eine weitere Miniaturisierung der Geräte gefordert. Zu den Technologien, die als Antwort auf diese Bedürfnisse Aufmerksamkeit erregen, gehören die 3D-Montage, die Komponenten in der Höhenrichtung stapelt, und die hochdichte Montage, die mehrere Funktionen auf engem Raum integriert.
Eines der Schlüsselelemente, die diese aufkommenden Technologien unterstützen, ist das Flip-Chip-Bonding. Bei dieser Methode werden Chips umgedreht und direkt mit Substraten verbunden, wobei die Elektrodenteile durch Mikrobumps verbunden sind. Da die Bindematerialien verschiedene funktionale Eigenschaften erfordern, wie z.B. Bindetemperatur sowie elektrische und thermische Leitfähigkeit, ist die Materialauswahl von äußerster Wichtigkeit.
Herausforderungen bei Materialien zur Bildung von Erhebungen
Derzeit werden Bump-Elektroden hauptsächlich durch Löten oder Beschichten hergestellt.
Lötverbindungen haben den Vorteil von niedrigen Kosten und schneller Verarbeitung, aber es gibt Bedenken hinsichtlich des Risikos von Kurzschlüssen bei engen Abständen. Andererseits hat die Beschichtung eine ausgezeichnete Kompatibilität mit feinen Drähten, aber ihre Materialhärte kann nachteilig sein, was zu Problemen wie Höhenvariationen und ungleichmäßigen Lasten führen kann, die sie nicht absorbieren kann. Dies kann zu Problemen wie schlechten Verbindungen und Restspannungen führen.
Um diese Herausforderungen zu überwinden, werden derzeit aktiv die Entwicklung neuer Materialien und die Optimierung von Verbindungsprozessen verfolgt. Die weitere Entwicklung der Flip-Chip-Technologie wird als der Schlüssel zur Unterstützung der nächsten Generation von Halbleiterverpackungen angesehen.
NÄCHSTES ≫ Der "Vermittler" zwischen heterogenen Chips und Substraten
Dies ist ein Auszug aus einem Werbeartikel, der in "Nikkei Crosstech" (veröffentlicht am 21. November 2025) mit Genehmigung von Nikkei BP veröffentlicht wurde.
(Reproduktion ohne Erlaubnis verboten)
Weitere Informationen
Neueste Trends in der Technologie der Leistungshalbleiterverpackung und hochmoderne Materialien für hohe Wärmeableitung und hohe Wärmebeständigkeit
Da energiesparende Technologien für Smartphones und elektronische Geräte, die nächste Mobilität wie Elektrofahrzeuge, Basisstationen und die Leistungssteuerung für erneuerbare Energien weiterhin fortschreiten, wird sich die technologische Entwicklung von Leistungshalbleitern zunehmend auf höhere Leistung und Effizienz konzentrieren.
Wir werden hochmoderne Materialien vorstellen, um Herausforderungen wie hohe Wärmeableitung, hohe Wärmebeständigkeit, Verlässlichkeit der Verbindung und Miniaturisierung sowie Trends in der Verpackungstechnologie anzugehen.


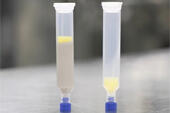

Wie war dieser Artikel?
Wenn Sie dies hilfreich fanden, teilen Sie es bitte.




