【Mit Fokus auf das Potenzial für die photonische Fusion, das zunehmend Beachtung findet】„Gold“ eröffnet neue Perspektiven für die hochdichte Montage der nächsten Generation.
„Einsteller“ zwischen verschiedenen Chips & Substraten
TANAKA PRECIOUS METAL TECHNOLOGIES entwickelt mit „AuRoFUSE Preform“ eine neue Montagelösung für die Flip-Chip-Montage. Diese ermöglicht eine hochzuverlässige und hochdichte Bestückung und eignet sich für die Anwendung der Technologie in Halbleiter-Backend-Prozessen. Die Lösung wird derzeit für die Massenproduktion und Vermarktung vorbereitet. Die Technologie nutzt die Niedertemperatur-Sintereigenschaften von Goldpartikeln im Submikrometerbereich zur Herstellung von Goldkontakten in verschiedenen Größen und Formen (Abbildung 1).
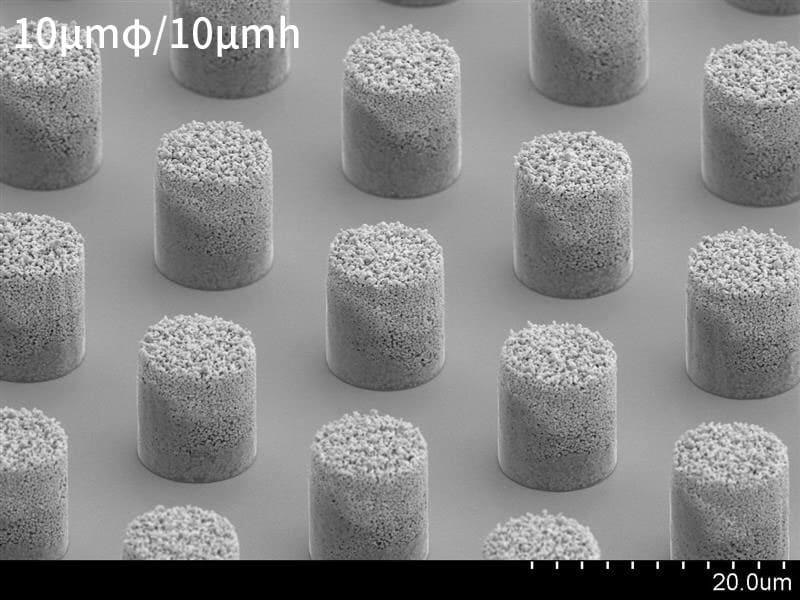
Yuichi Makita, der an der Entwicklung beteiligt war, sagte: „Das Material, das den Chip mit der Leiterplatte verbindet, muss nicht nur elektrische Signale und Wärme effektiv übertragen, sondern auch als ‚Ausgleichselement‘ fungieren, um die Unterschiede im Zustand und den physikalischen Eigenschaften von Chip und Leiterplatte auszugleichen. Die AuRoFUSE-Vorform übernimmt die Funktionen des Drahtbondens, das beide Eigenschaften aufweist, und wir entwickeln sie als neue Verbindungstechnologie, die den Anforderungen der Zeit gerecht wird.“
Die mit AuRoFUSE-Preformen gebildeten Erhebungen können bei etwa 200 °C thermokompressionsgebunden werden, was eine relativ niedrige Temperatur darstellt. Obwohl diese Methode eine etwas niedrigere Verbindungsdichte als das Hybridbonding aufweist, ist sie eine äußerst nützliche Hochdichtetechnologie, da der Prozess einfacher ist und die Belastung des Montageprozesses verringert werden kann.
Nach der Bildung hat der Buckel eine poröse Struktur, die aus Goldmikropartikeln von etwa 0,4 μm besteht, sodass es weniger wahrscheinlich ist, dass seine Größe und Form in der Breite aufgrund von Druck während der Verbindung verzerrt wird (Abbildung 2). Dies macht es unwahrscheinlich, dass Kurzschlüsse zwischen den Elektroden auftreten, was hochdichte und hochzuverlässige Verbindungen ermöglicht. Aus ähnlichen Gründen können selbst bei großen Substraten, die verbunden werden sollen, und unebenen Verbindungsflächen Verformungen, Unebenheiten und Höhenunterschiede flexibel ausgeglichen werden, was eine Montage mit hoher Ausbeute ermöglicht.
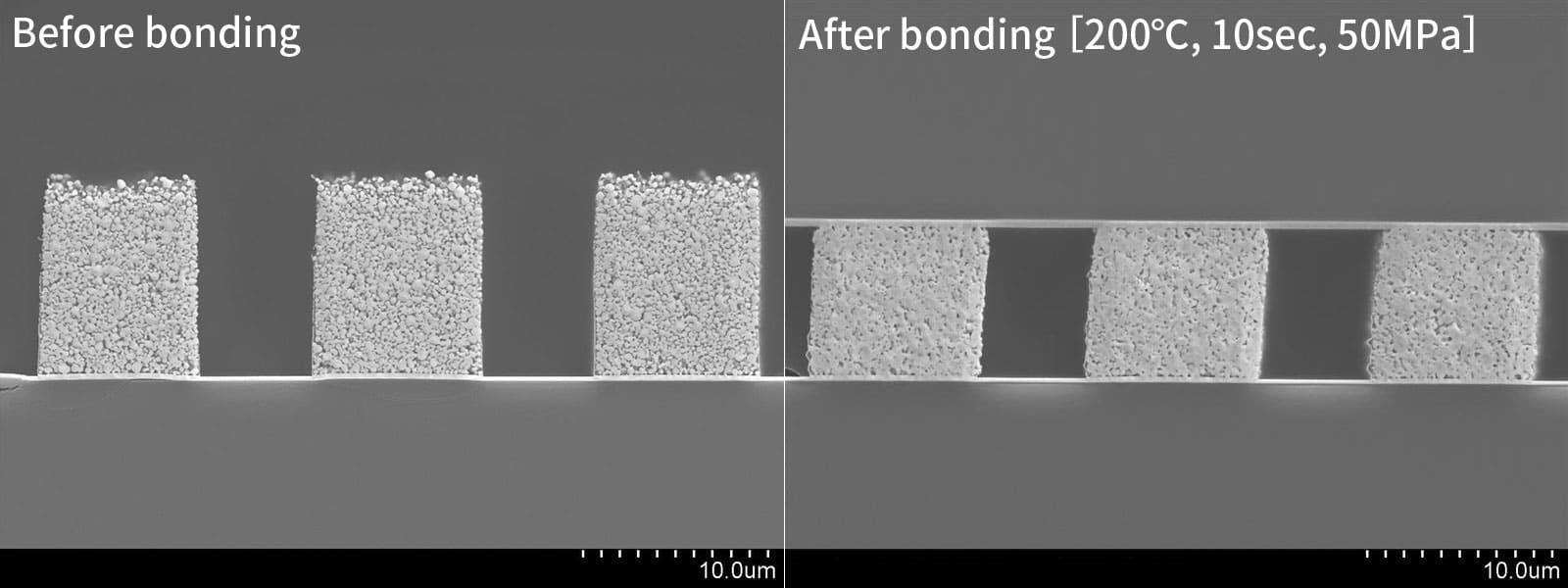
Die mit AuRoFUSE gebildeten Erhebungen weisen in der Breite minimale Größenänderungen auf, ähnlich wie ein Schwamm, und können in der Höhe komprimiert werden. Daher ist es unwahrscheinlich, dass nach der Kompression Defekte wie Kurzschlüsse zwischen den Erhebungen auftreten.
Zusätzlich hat Gold, da es der Hauptbestandteil ist, einen niedrigen elektrischen Widerstand (4,5 μΩ・cm, der durch Druck verbessert werden kann) und eine extrem hohe Wärmeleitfähigkeit von 200 W/mK. "Das macht es ideal für die Montage auf Geräten, die große elektrische Ströme verarbeiten, wie Leistungshalbleiter, die erhebliche Wärme erzeugen. Darüber hinaus ist aufgrund der stabilen physikalischen Eigenschaften von Gold Oxidation und Migration unwahrscheinlich, was eine hochzuverlässige Verbindung über lange Zeiträume gewährleistet", sagt Makita.
Vorschlag neuer Prozesse, die die Kraft neuer Materialien nutzen.
AuRoFUSE ist ein Pastenmaterial, das aus Goldmikropartikeln und organischen Lösungsmitteln besteht. Es kann im Allgemeinen verwendet werden, um Erhebungen zu bilden, indem es aus einem Spender extrudiert wird. Mit dieser Methode ist die Bildung von Erhebungen jedoch auf etwa 600 μm begrenzt.
Das Unternehmen hat daher einen neuen Prozess entwickelt, der die Vorteile von AuRoFUSE nutzt und die Bildung von miniaturisierten und hochdichten Goldbumps mit einer Mindestgröße von 5 μm und einem Abstand von 5 μm ermöglicht (Abbildung 3). Der entwickelte Prozess zur Bildung von Goldbumps wird durch die Kombination eines Pastendruckverfahrens mit dem Photolithografieprozess konstruiert und weist eine hohe Kompatibilität mit bestehenden Prozessen auf.
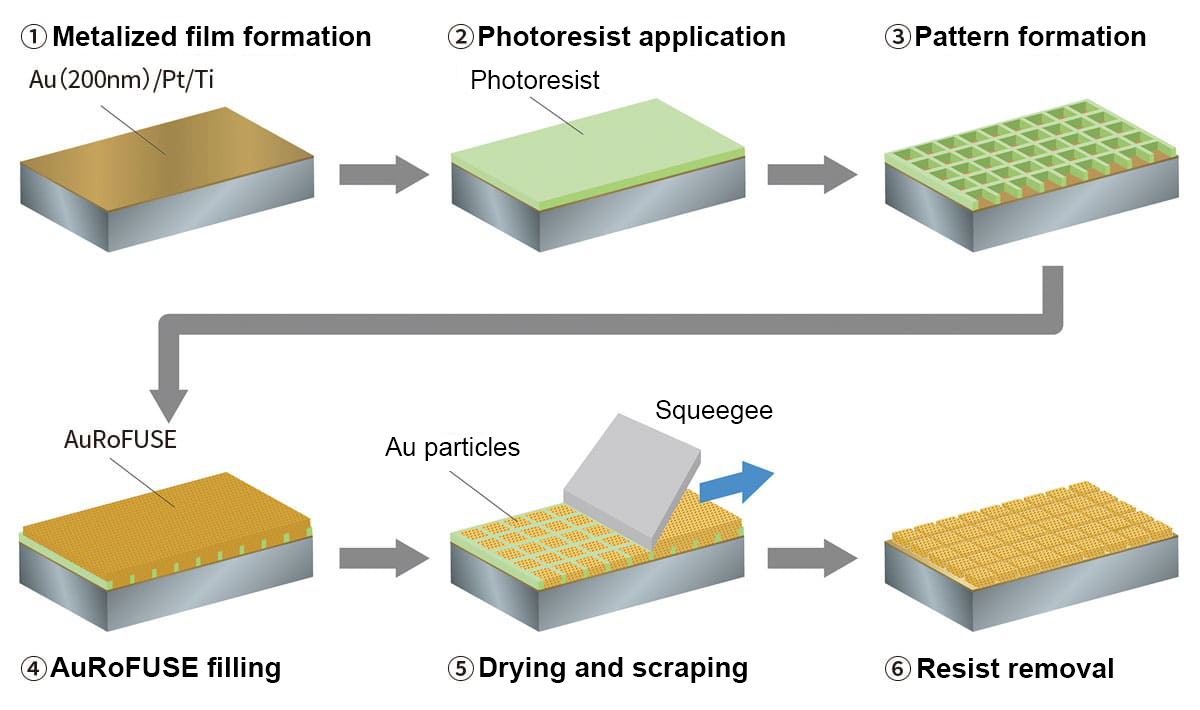
Zuerst wird eine metallische Dünnschicht (Au/Pt/Ti), die als Basis für Verbindungen dient, auf das Substrat aufgebracht, und dann wird Fotolack aufgetragen, um während des Belichtungsprozesses ein Erhebungsmuster zu bilden. Danach wird Paste durch Drucken eingebettet, der Lack wird entfernt und das Produkt wird getrocknet, um eine Vorform zu bilden.
Das Unternehmen arbeitet auch daran, ein Unterstützungssystem einzurichten, um Nutzerunternehmen bei der Einführung des Goldbump-Formationsprozesses als Massenproduktionsprozess zu unterstützen, zusätzlich zur Lieferung von Materialien. Da diese Technologie Gold verwendet, ein Edelmetall mit hervorragender Funktionalität, wird das Unternehmen ein System zur Wiederverwertung von gebrauchten Materialien einrichten, um deren nachhaltige Nutzung sicherzustellen und die Kosten für die Nutzer zu senken.
„Wir sind stolz auf die AuRoFUSE-Preforms, eine Technologie, die nur unser Unternehmen realisieren kann, das seit 140 Jahren Technologien im Bereich Edelmetalle verfeinert und weiterentwickelt. Wir arbeiten derzeit an weiteren Leistungsverbesserungen und der Erweiterung des Anwendungsspektrums und erwarten, dass diese Technologie in Bereichen eingesetzt wird, in denen die Wärmeregulierung entscheidend ist, insbesondere als Lichtquelle für Mikro-LEDs und optoelektronische Fusionschips“, sagt Naoto Watanabe, der an der Entwicklung neuer Anwendungen beteiligt ist.
Durch den Einsatz neuer Montagesysteme wie AuRoFUSE-Vorfälle wird erwartet, dass sich Halbleiterchips weiterentwickeln.

Dies ist ein Auszug aus einem Werbeartikel, der in "Nikkei Crosstech" (veröffentlicht am 21. November 2025) mit Genehmigung von Nikkei BP veröffentlicht wurde.
(Reproduktion ohne Erlaubnis verboten)
Weitere Informationen
Neueste Trends in der Technologie der Leistungshalbleiterverpackung und hochmoderne Materialien für hohe Wärmeableitung und hohe Wärmebeständigkeit
Da energiesparende Technologien für Smartphones und elektronische Geräte, die nächste Mobilität wie Elektrofahrzeuge, Basisstationen und die Leistungssteuerung für erneuerbare Energien weiterhin fortschreiten, wird sich die technologische Entwicklung von Leistungshalbleitern zunehmend auf höhere Leistung und Effizienz konzentrieren.
Wir werden hochmoderne Materialien vorstellen, um Herausforderungen wie hohe Wärmeableitung, hohe Wärmebeständigkeit, Verlässlichkeit der Verbindung und Miniaturisierung sowie Trends in der Verpackungstechnologie anzugehen.


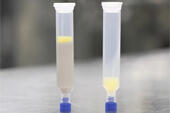

Wie war dieser Artikel?
Wenn Sie dies hilfreich fanden, teilen Sie es bitte.




