【注目集まる光電融合での活用も視野に】"金"の可能性が拓く次世代高密度実装の新発想
現在、半導体後工程では、パッケージング技術を中心としてエポックメイキングとなるような新技術の導入が加速している。同時に期待が高まっているのが、この革新に対応した、新たな発想に基づく特徴・特性を持つ材料の創出だ。田中貴金属工業は、信頼性が高く、高密度実装を可能とする新たな実装ソリューション「AuRoFUSE™ (オーロフューズ)プリフォーム」を開発した。
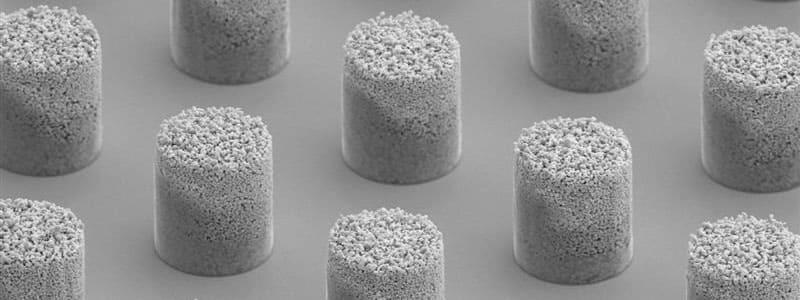
近年、半導体および電子機器分野では、通信速度の向上、省エネルギー化、そしてデバイスのさらなる小型化が求められている。こうしたニーズに応える技術として注目されているのが、コンポーネントを高さ方向に積層する3次元実装や、限られたスペースに多くの機能を詰め込む高密度実装である。
これらの実装技術を支える重要な要素の一つが、フリップチップ接合だ。チップを基板に裏返して直接接合するこの方式では、電極部分をマイクロバンプで接続する。接合材料には、接合温度や電気・熱伝導率など、さまざまな機能特性が求められるため、材料選定は極めて重要だ。
バンプ形成材料に立ちはだかる課題
現在、バンプ電極の形成には主にはんだやめっきが用いられている。
はんだは、低コストかつ迅速な処理が可能という利点があるが、狭ピッチでのショートのリスクが懸念される。一方、めっきは微細配線への対応力に優れるものの、材料の硬さが災いし、高さのばらつきや荷重の不均一を吸収できないという課題を抱えている。これにより、接続不良や残留ひずみの発生といった問題が生じる可能性がある。
こうした課題を克服すべく、現在では新規材料の開発や接合プロセスの最適化が精力的に進められている。フリップチップ技術のさらなる進化は、次世代の半導体実装を支える鍵となるだろう。
日経BPの許可により「日経クロステック」 (2025年11月21日掲載)に掲載された広告記事を抜粋したものです。
(禁無断転載)
関連情報
パワー半導体パッケージング技術の最新動向、高放熱性・高耐熱性を実現する最先端素材
スマートフォンや電子機器等の省エネ化、EV等の次世代モビリティ、基地局、再エネの電力制御など、パワー半導体の技術開発は、ますますの高出力化や高効率化が進みます。
高放熱・高耐熱・接合信頼性の工場・小型化などの課題に対応するための最先端素材と、パッケージングの技術動向をご紹介します。


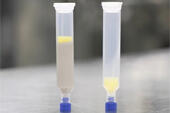

この記事はどうでしたか
参考になった方は、シェアをお願いします。




