編集長ピックアップ:田中貴金属、焼結金(Au)接合技術の転写技術を確立

引用元: Semiconductor Digest
日付: 2026年2月3日
文:Semiconductor Digest共同創立者兼編集長 ピート・シンガー(Pete Singer)氏
リンク: TANAKA Establishes Transfer Technology for its Sintered Gold Bonding Technology - Semiconductor Digest
編集長ピックアップ:田中貴金属、焼結金(Au)接合技術の転写技術を確立
田中貴金属の産業用貴金属事業を展開する田中貴金属工業株式会社は、焼結金(Au)接合技術「AuRoFUSE™(オーロフューズ)プリフォーム」において、金バンプの転写技術を確立したことを発表した。本技術により、複雑な構造の半導体チップやサブストレートに対してもAuRoFUSE™プリフォーム(以下、金バンプ)形成を行うことができる。
金バンプを転写できることによるメリット
本技術は、事前に金バンプが形成された基板(以下、転写基板)を作製し、そこから対象の半導体チップやサブストレートへバンプを転写する方法である。転写基板として用いるシリコン基板に開口を設け、その開口部に金バンプを形成する。金バンプを開口部全体に充填するように形成することで、基板に保持され、ハンドリング中に金バンプが脱落する心配がない。一方、転写時には加熱により金バンプが収縮し、開口部と金バンプの間にわずかな隙間が生じる。このため、垂直方向の力を与えることで、容易に引き抜くことが可能となる。
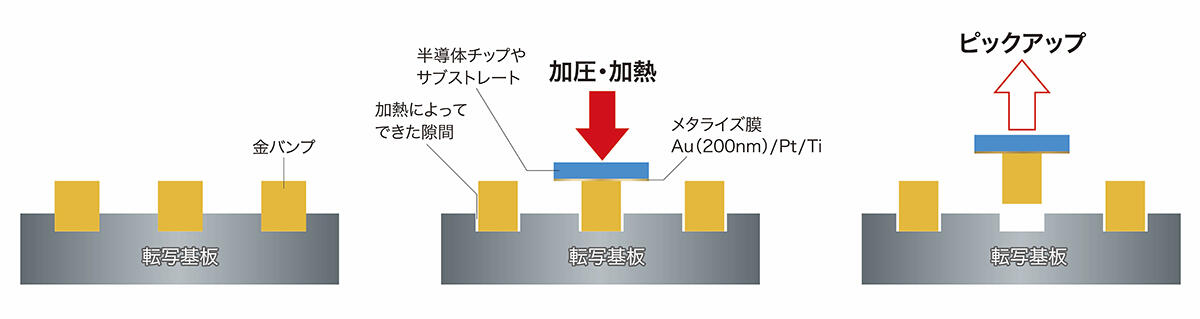
従来の金バンプ形成プロセスは、対象の半導体チップやサブストレートに直接バンプを形成する方法であるため、凹凸や貫通孔など複雑な形状を持つ対象物には、レジストの高さが安定しないなどの課題があり、対応が困難だった。
今回の転写技術では、金バンプを別で作製し、目的の箇所にのみ金バンプを転写することができるため、複雑な形状にも適用が可能となる。また、剥離液などによるダメージが懸念され、フォトリソグラフィ工程に通しづらい半導体チップやサブストレートにも対応できるようになる。
本記事は、Semiconductor Digestの許可を得て、Semiconductor Digestの2026年3月3日付の記事を田中貴金属が翻訳・転載したものです。
本記事はSemiconductor Digestに掲載されたものです。詳細はこちらをご覧ください。
続きを見る (Semiconductor Digest)
関連情報


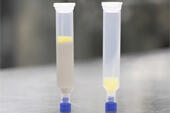

パワー半導体パッケージング技術の最新動向、
高放熱性・高耐熱性を実現する最先端素材
スマートフォンや電子機器等の省エネ化、EV等の次世代モビリティ、基地局、
再エネの電力制御など、パワー半導体の技術開発は、ますますの高出力化や高効率化が進みます。
高放熱・高耐熱・接合信頼性の工場・小型化などの課題に対応するための最先端素材と、
パッケージングの技術動向をご紹介します。
この記事はどうでしたか
参考になった方は、シェアをお願いします。




