AgSn TLPシート
エレクトロニクス
半導体
接合・封止
接合材
板・線・管材料

「TLPシート」とは
田中貴金属が開発したNi/Cuを主成分とする拡散接合による中間材料シートです。200℃で接合可能、高温工程後も安定し、接合層の薄さとボイド低減を実現。パワーデバイスや高熱負荷がかかるモジュール実装など、高信頼性と熱安定性が求められる分野に最適な次世代型接合材料です。
大型シリコン(Si)チップ接合を可能にするシート状接合部材
対応チップサイズ20mmの大面積で、高信頼な接合を可能。
EV、HV、産業インフラ等で高まる大電流対応のパワー半導体ニーズに貢献。
TLP接合(液相拡散接合(※1)):Transient Liquid Phase Diffusion Bonding
AgSn TLPシートの概要
特長
信頼性
- 接合後、AgとSnがAg3Snとなることで耐熱温度が480℃まで上がるため、既存材料よりも高い耐熱性を有します。
- 接合強度においては最大50MPaを維持し、300℃においても同等の接合強度を維持します。
- 3,000サイクルのヒートサイクル試験を通過した高接合信頼性も特長です。
コスト低減
- 数分にて接合ができるため、タクトタイムの低減によりプロセスコスト削減ができます。
環境負荷低減
- 溶剤を含まない材料である為、VOC(揮発性有機化合物)が発生しません。
- 鉛を含まないためRohs規制対象物質を含みません。
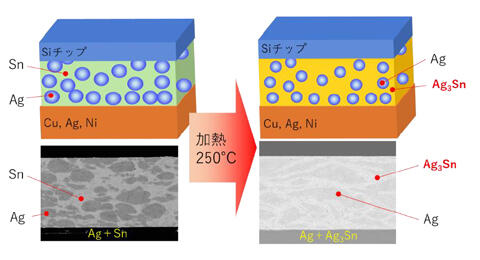
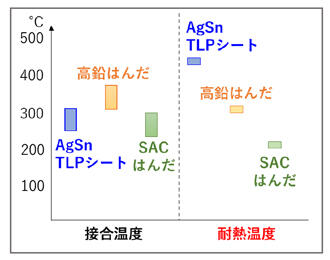
使用方法
接合条件
- 加熱温度250℃で液相拡散接合(※1)が可能です。
- 3.3MPaの低加圧で接合が可能です。
接合対象
- Cu,Ni,Agなどの様々な被接合材に対応が可能です。
スペック
| 要求性能項目 | 性能 |
|---|---|
| 対応チップサイズ | 最大20mm |
| シート厚さ | 0.03~0.2mm |
| 接合強度(シェア強度) | 25~50MPa |
| 耐熱性(高温シェア強度300℃) | 25~50MPa |
| 信頼性(H.C. -50℃⇔200℃) | 3,000cyc. |
| 被接合材 | Cu/Ni/Agに接合可能 |

(※1)液相拡散接合:拡散接合を行う際、接合界面に挿入される金属などを一時的に溶融、液化した後に、拡散を利用し等温凝固させて接合する接合方法。英語名称は Transient Liquid Phase Diffusion Bonding(TLP接合)
関連情報
Scroll


