田中貴金屬工業的混合燒結技術重新定義了SiC/GaN功率模組的可靠性
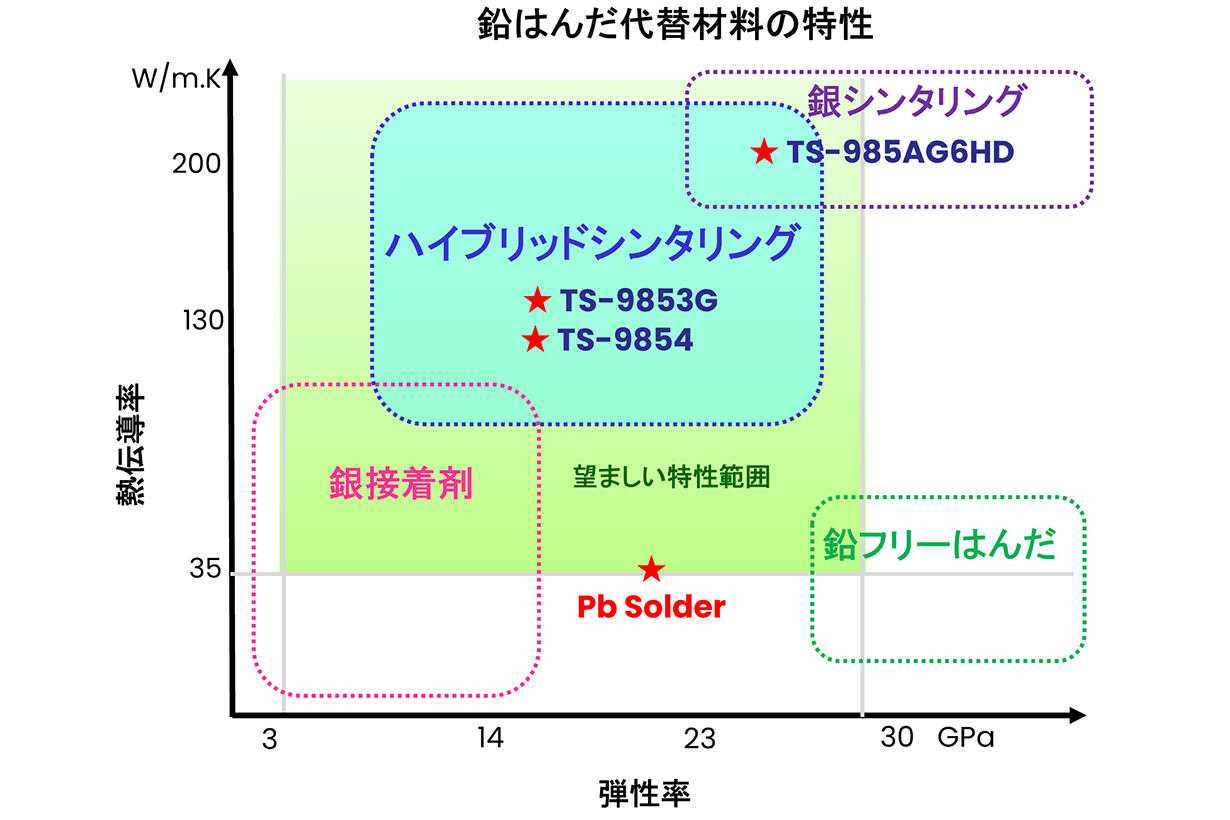
引用來源: Semiconductor Digest
日期:2025年12月12日
鏈接: https://www.semiconductor-digest.com/tanakas-hybrid-silver-adhesive-paste-redefines-reliability-for-sic-gan-power-modules/
田中貴金屬工業株式會社銀黏合劑全球研發高級經理阿部慎太郎解釋了材料方面的突破,正是這種突破使得高溫無壓晶片貼裝成為可能。
隨著寬禁帶(WBG)半導體在電力電子領域日益普及,封裝可靠性已成為一項重大挑戰。對於工作溫度超過200°C的SiC MOSFET和GaN HEMT而言,晶片貼裝層會承受極端的熱應力、機械應力和化學應力,這超出了焊料和環氧樹脂黏合劑等傳統材料的承受極限。
田中貴金屬工業株式會社開發了一種混合燒結技術,該技術實現了高導熱性、在200℃以上溫度下仍能保持牢固的結合、無需加壓加工以及優異的長期抗疲勞性能。根據田中貴金屬工業,該公司透過同時解決兩大難題——實現樹脂中銀的燒結以及控制燒結網絡內樹脂的分佈——開發出了這項創新的連接技術。

根據安倍的說法,第一個重大突破是能夠在含有樹脂的環境中燒結銀粒子。 這種情況下燒結通常會被抑制。 「樹脂中的銀燒結通常較為困難,因為樹脂會抑制燒結過程,而我們獨特的設計技術克服了這項挑戰,透過優化樹脂的介面互動,同時維持銀的燒結,」阿部說。
第二步則涉及工程與微觀結構。 「透過不均勻地將樹脂分布在銀燒結結構內,我們同時實現了熱導率與機械彈性。
田中貴金屬工業株式會社透過僅在必要部位塗覆樹脂,發展出一種複合材料體系,該體系在顯著降低彈性模量的同時,仍能保持高導熱性。 「這兩項創新在保持高導熱性的同時,增加了機械柔韌性,從而確保了長期可靠性。傳統的樹脂基黏合劑在溫度超過200°C時,接合強度會顯著下降,因此必須將黏合和燒結結合起來,」阿部解釋。
高溫下的可靠性是WBG功率模塊最重要的問題。基於傳統樹脂的銀粘合劑在高溫下變得不穩定。安倍先生解釋了這個問題的機制如下。「在超過200°C的高溫下,依賴氫鍵的粘合劑體係的性能降低,剪切強度顯著降低。」
為了解決這個問題,田中貴金屬工業工業株式會社將銀燒結技術與銀鍵結的化學特性結合。 “我們將燒結技術與鍵合技術相結合,即使在超過200°C的環境下也能保持較高的鍵合強度,並能有效分散溫度循環過程中接合材料線膨脹係數差異引起的應力。”
所得材料形成穩定的結構,可減輕熱機械疲勞,特別是在銅和陶瓷基電源基板中。
管理空隙
空腔降低了導電性和可靠性,尤其是在高功率模塊中。安倍先生解釋了公司的戰略如下。「首先,高密度地填充銀填料。通過組合不同尺寸和形狀的銀粒子,形成高密度的結構。熔化後,樹脂熔化以填充微小的空隙,從而實現更高密度和更穩定的結構」。從而有效地防止氧氣和濕氣的侵入。「最大限度地減少空隙,防止氧氣和濕氣進入,從而導衹長期老化」安倍先生說。
無壓力熔合
其主要優勢在於與現有晶片貼裝製程的高度相容性。 Abe 表示:“加壓燒結需要專用設備,但我們的混合燒結製程無需加壓,即可利用現有加熱系統(例如間歇式烘箱)進行加工。這使得客戶能夠輕鬆引入新材料,而無需對其生產線進行重大改造。”
對於尋求加壓下沉的客戶,可以在加壓係統中使用相同的粘合劑。
圖1展示了田中貴金屬工業的銀晶片貼裝產品線,其中中心部分為新型混合燒結製程。圖2則比較了此混合燒結製程與其他產品線。


基板相容性
裸銅是最難接合的材料之一,因為薄氧化膜的形成阻礙了金屬接合。安倍先生說:「最難接合的是裸銅,因此我們將重點放在這方面。本公司的工藝實現了與裸銅的高度兼容性。」。
圖3示出了針對裸銅優化的推薦固化輪廓。該配置文件也適用於銀和金。對於銀和金,即使在約200°C的低溫下也可以實現可靠的粘合。

幸運的是,田中貴金屬工業的工廠已經具備了必要的基礎設施:“我們的生產工廠在生產各種膏材材料方面擁有豐富的經驗。這使我們能夠順利地從原型製作過渡到批量生產,而無需進行大規模的資本投資。”
除了技術實力外,田中貴金屬工業工業株式會社還建立了循環供應鏈。公司專注於從工業廢料中回收和提煉貴金屬,並制定了一系列環保舉措,以減少對環境的影響,確保貴金屬的可持續高效利用。循環採購不僅具有環境效益,在保障貴金屬穩定供應方面也扮演重要的策略角色。尤其對於產量有限且採購能力強的原料而言,回收不僅能提高供應穩定性,還有助於減少二氧化碳排放,並建立更永續的生產系統。此模式的特色在於,產品採用從回收貴金屬中提煉原材料製成,並運用了田中貴金屬集團多年來積累的先進回收和貴金屬分析技術。此外,本公司還可根據客戶需求提供100%由回收貴金屬製成的產品和解決方案。 「循環經濟和永續的原料供應對我們的客戶至關重要。我們的回收系統和採購能力是我們的主要競爭優勢,」安倍表示。此外,此混合膏材完全不含鉛和PFAS。
此外,田中貴金屬工業株式會社提供貴金屬材料的“一站式服務”,從鑄錠採購到加工、製造、銷售和回收。
未來發展方向
隨著封裝技術朝向更薄的晶片和先進的多層結構發展,田中貴金屬工業工業株式會社正在開發新一代黏合劑。安倍先生解釋道:“一些客戶的目標是將芯片厚度控制在50微米以下。在粘合過程中,膏材材料容易向上滲到芯片表面,而且隨著芯片厚度的減小,這種現象會更加明顯。克服這一問題是下一代封裝技術的關鍵所在。”
降低材料和制造過程的成本也是一個主題。「新一代產品的需求非常復雜,因此您必須密切關註技術趨勢,以降低材料和工藝成本」
為了解決這些問題,田中貴金屬工業工業株式會社正在開發適用於薄晶片的鍵合技術。此外,該公司還在努力透過減少貴金屬用量來降低成本,同時保持晶片的熱性能和機械性能。 “我們正與客戶和歐洲研究機構合作,共同研發下一代封裝技術。”
田中貴金屬工業的混合燒結技術不僅僅是一種新型接合材料,它代表著業界在熱性能和機械耐久性之間長期權衡取捨方式上的一次變革。該材料透過在樹脂結構中實現燒結、優化顆粒堆積並支援無壓加工,直接滿足了SiC/GaN功率模組量產市場的需求。
「我們的混合熔合粘合劑充分滿足了對長期可靠性和熱效率至關重要的下一代電力電子的需求。本公司將運用數十年來積累的材料相關專業知識,繼續為半導體的創新做贡獻。」安倍先生總結道。
相關資訊


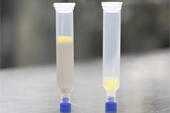

功率半導體封裝技術的最新趨勢
採用尖端材料,實現高散熱性和高耐熱性
智能手機和電子設備等的節能化、EV等的下一代移動性、基站、
再能源的電力控制等,功率半導體的技術開發將進一步向高輸出化和高效化發展。
為應對高放熱、高耐熱、接合可靠性的工廠、小型化等課題,介紹最先進的材料和
包裝的技術動向。
這篇報道怎麽樣?
請參考的人分享。
