NEWS/RELEASE
TANAKA PRECIOUS METAL TECHNOLOGIES 建立了燒結金(Au)接合技術「AuRoFUSE™ Preforms」的轉印技術
可應用於難以直接形成凸塊的複雜形狀基板
2026年3月3日
專注於產業用貴金屬展開業務的TANAKA PRECIOUS METAL TECHNOLOGIES Co., Ltd.發表在燒結金(Au)接合技術「AuRoFUSE™ Preforms」中,建立了金凸塊※1的轉印技術。透過本技術,即使是面對具有複雜結構的半導體晶片或載板※2,也能進行AuRoFUSE™ Preforms(以下稱金凸塊)的形成。
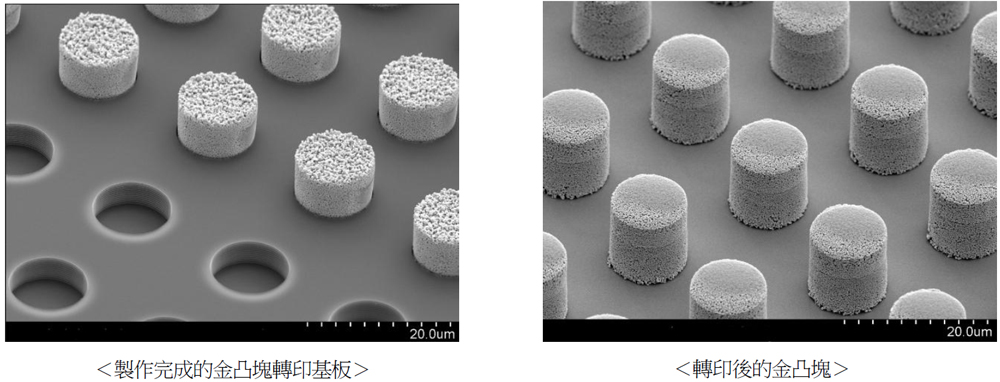
■因可轉印金凸塊而帶來的好處
本技術的方法是事先製作已形成金凸塊的基板(以下稱轉印基板),再從中將凸塊轉印到目標半導體晶片或載板。在作為轉印基板使用的矽基板上設開口,並於該開口部形成金凸塊。藉由形成金凸塊以填充整個開口部,使其被基板保持住,故在操作過程中不用擔心金凸塊會脫落。另一方面,轉印時因加熱而使金凸塊收縮,開口部與金凸塊之間就會產生微小的間隙。因此,只要施加垂直力,即可輕易將其抽出。
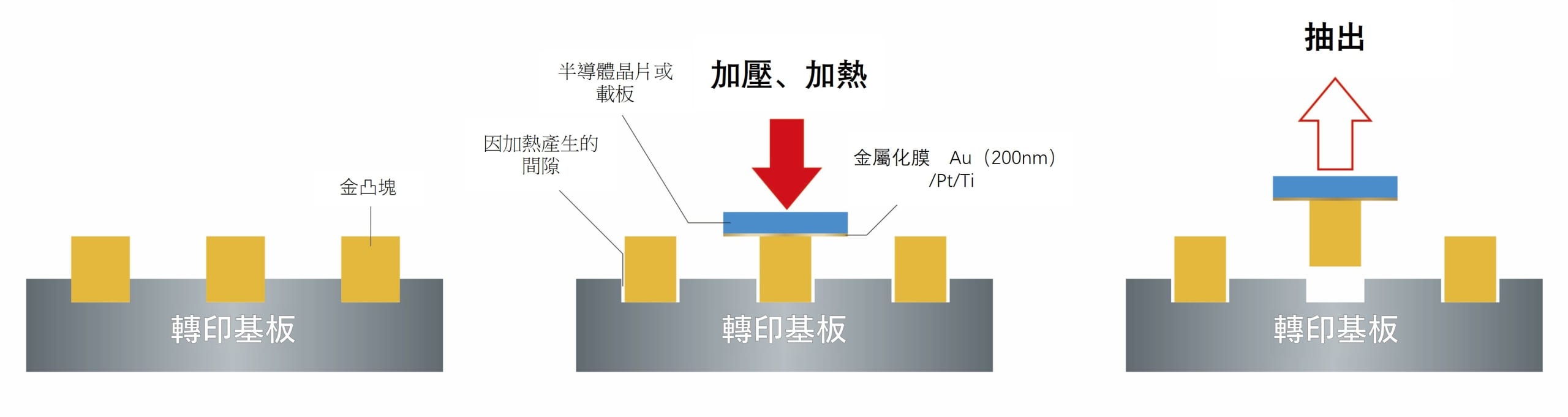
由於過去的金凸塊形成製程是採用在目標半導體晶片或載板上直接形成凸塊的方法,因此針對具有凹凸或貫穿孔等複雜形狀的目標物,存在光阻高度不一等課題,進而難以應對。
在這次的轉印技術中,由於可另外製作金凸塊,並將金凸塊轉印至目標位置,因此也能應用於複雜形狀。另外,對於憂心剝離液等造成損傷,而難以進入微影※3製程的半導體晶片或載板,也能加以應對。
【轉印基板的製作以及轉印、接合製程】
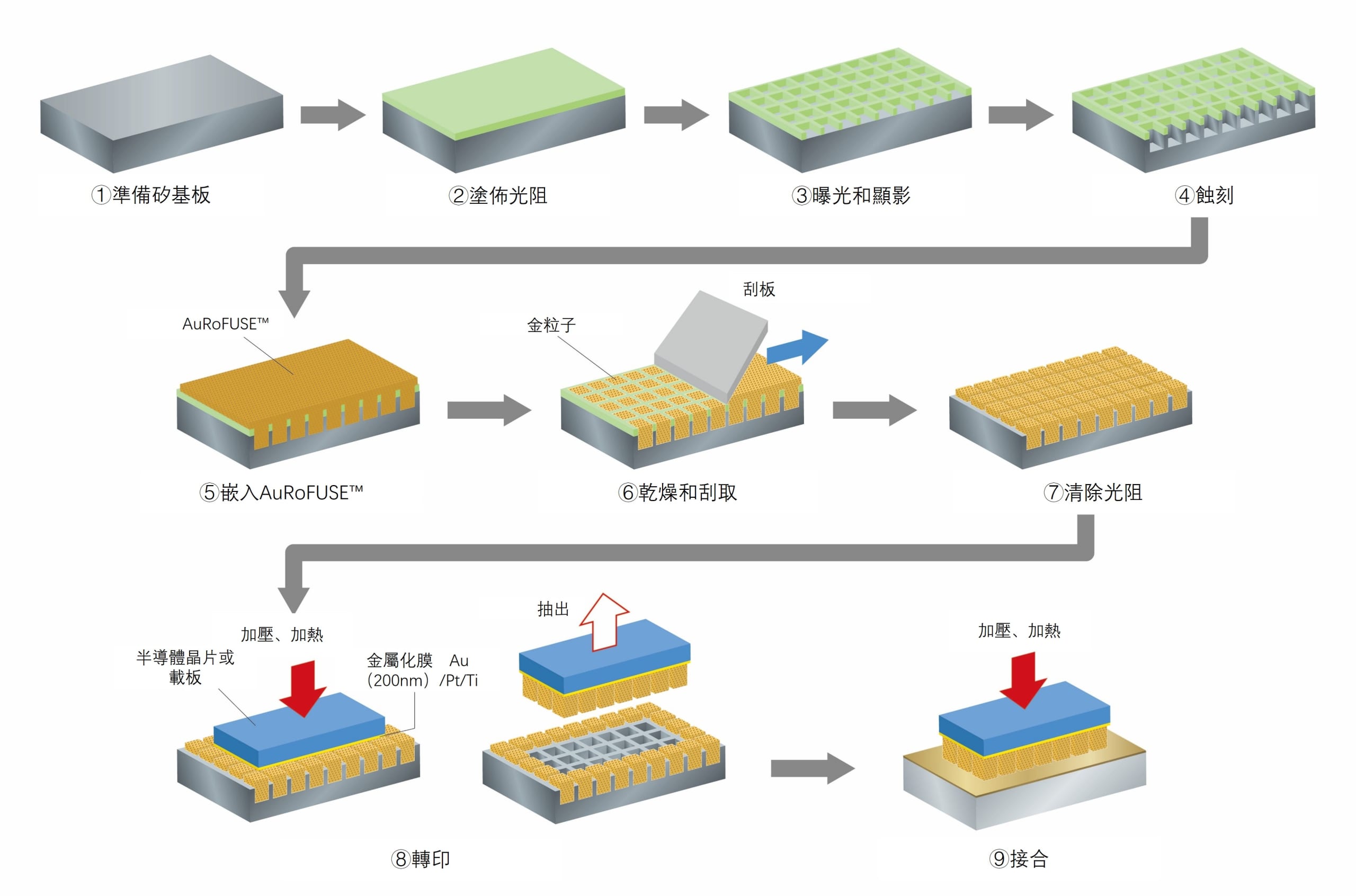
- 準備作為轉印基板的矽基板
- 在矽基板上塗佈光阻
- 曝光和顯影至目標圖案
- 在矽基板上以蝕刻鑽孔
- 使用刮板等工具嵌入AuRoFUSE™
- 在常溫及真空下乾燥AuRoFUSE™,並刮取光阻上多餘的金粒子
- 剝離光阻後,轉印基板即完成
- 將欲形成金凸塊的目標(半導體晶片或載板)對準轉印基板,進行10MPa、150℃、1分鐘的加壓加熱。隨後垂直提起基板,金凸塊即完成轉印
- 將轉印後的基板以20MPa、200℃、10秒的加壓加熱進行接合
【過去的金凸塊形成製程】
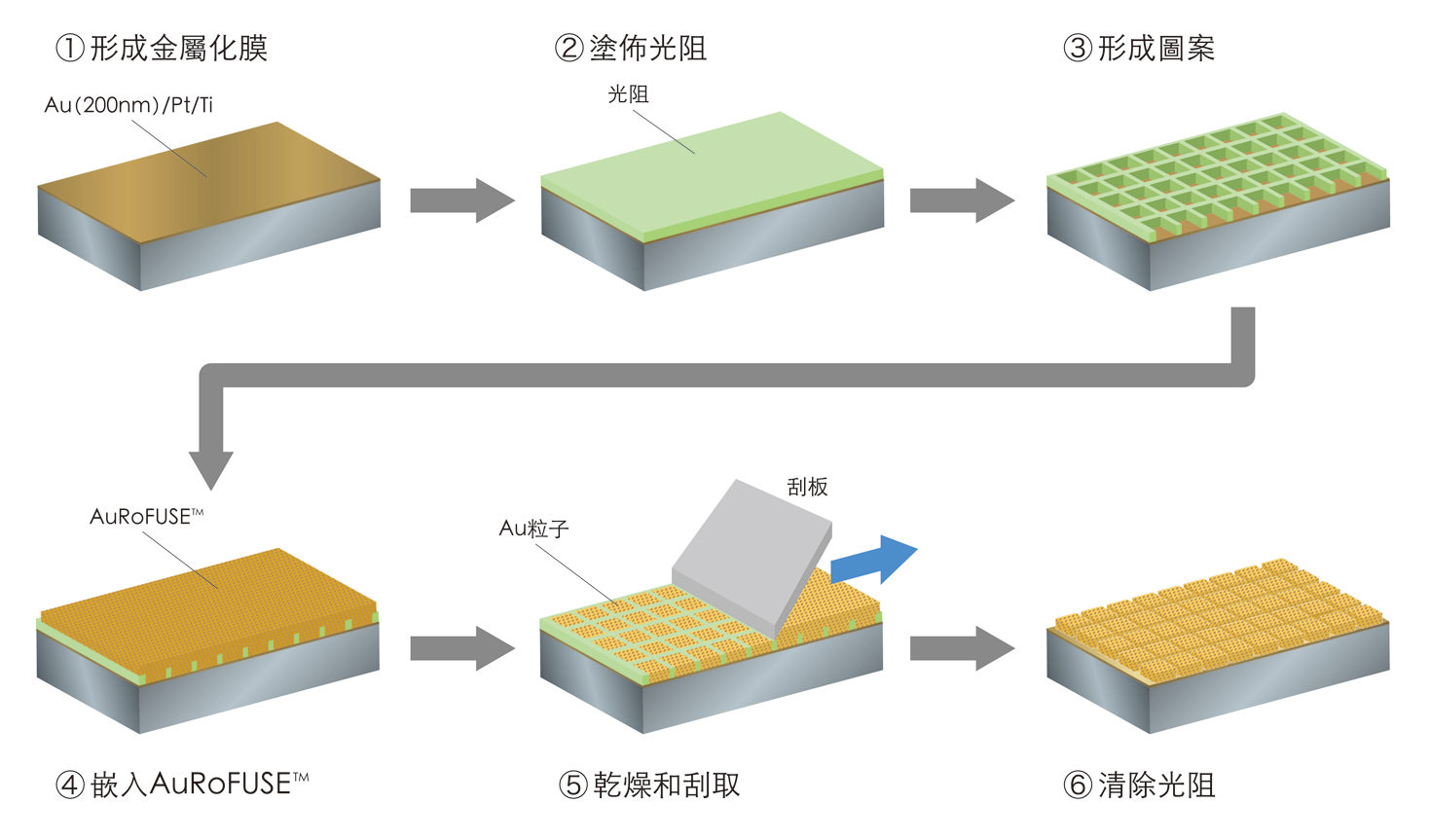
■關於燒結金接合技術「AuRoFUSE™ Preforms」
TANAKA所開發的「AuRoFUSE™ Preforms」是將由金微粒子與有機溶劑組成的膏材,預製形成凸塊形狀的接合技術。在200℃、20MPa、10秒的加壓加熱後,在壓縮方向顯示出約10%的收縮率,在水平方向上較少變形,具備足以承受實際應用的接合強度※4。再加上是以化學穩定性優異的金為主要成分,封裝後亦具高可靠性。
本技術是一種能夠實現半導體配線微細化和多種晶片集成(高密度化)的技術,期待將為LED(發光二極體)和LD(半導體雷射)等光學元件,電腦和智慧型手機等數位元件上的應用,以及為車載零部件和MEMS等,近年來日益高漲的半導體小型化和高性能化需求做出貢獻。
關於凸塊形成技術,過去是採用銲錫凸塊與電鍍凸塊為主要手法。不過,採用銲錫凸塊的話,由於隨著凸塊間距的微細化,銲錫材料在熔化時會往水平方向擴展,因此存在因電極間接觸而引起短路的風險。而電鍍凸塊雖然可做到窄間距化,但由於接合時需要相對較高的壓力,因此可能導致半導體晶片破損。本技術是為解決這些課題,並旨在應用於次世代高密度封裝及光電融合元件而進行開發。
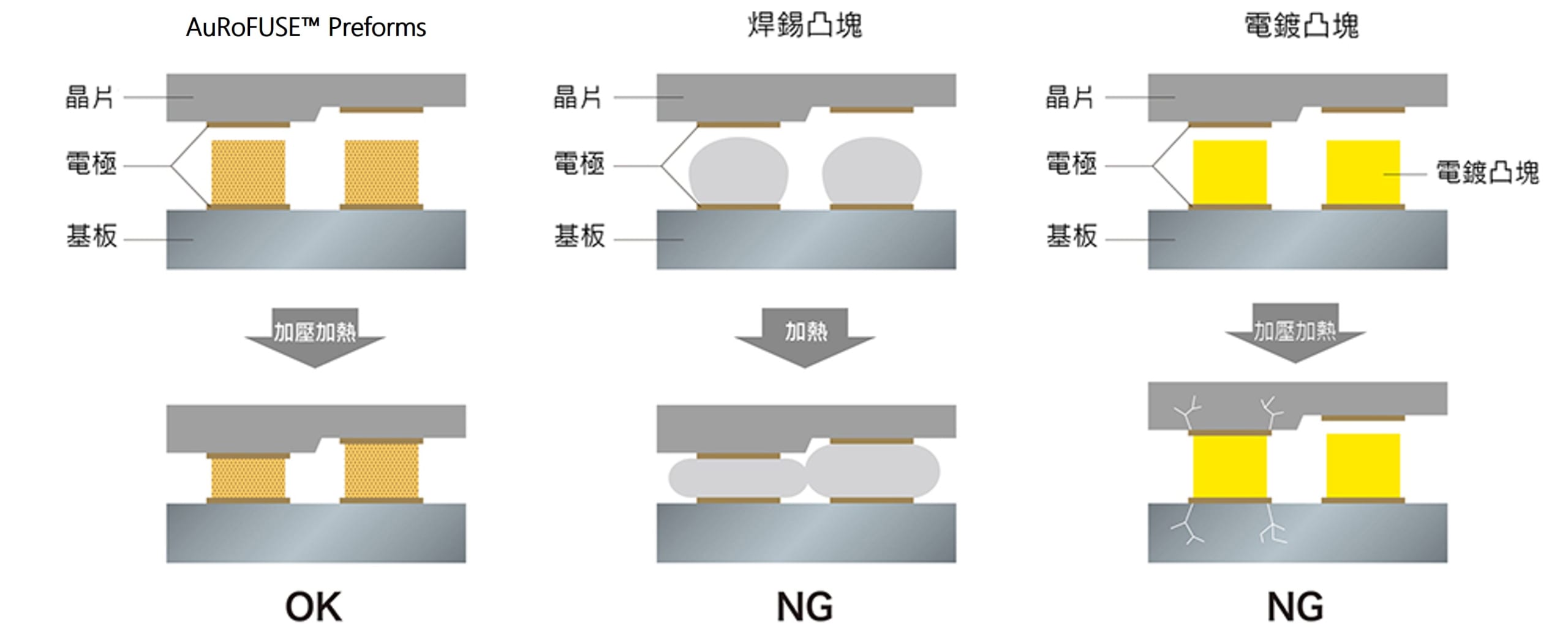
■關於「AuRoFUSE™」以及TANAKA親自開發的金材料
「AuRoFUSETM」是在粒徑控制至次微米大小的金粒子中混合了有機溶劑的膏狀接合材料。與金的熔點(約1064℃)相比,可於約200℃的低溫下進行接合為其特徵。
金是一種電阻低、熱傳導率非常高的材料。因此在處理大電流的功率半導體,以及發熱量大的高密度晶片中,能夠有效率地散熱並抑制能量損耗。另外,在貴金屬中也更是不易氧化,屬於穩定的物質,因此封裝後不易發生腐蝕或離子遷移(金屬移動而引起短路的現象),能長期維持高可靠性。
TANAKA自創業以來,憑藉積累的貴金屬材料開發技術優勢,持續致力於開發像是金這類在半導體領域中扮演重要角色的貴金屬材料。另外,還擁有從原料採購到材料開發、製造及回收的一貫執行體制,在有效利用有限貴金屬資源的同時,為半導體技術發展以及實現永續社會做出貢獻。
20260303_TANAKA PRECIOUS METAL TECHNOLOGIES 建立了燒結金(Au)接合技術「AuRoFUSE™ Preforms」的轉印技術.pdf
(※1)凸塊:突起的電極
(※2)載板:用於承載半導體晶片並提供電氣與機械支撐的基板
(※3)微影:在基板上形成微細電路圖案的技術
(※4)接合強度:指剪斷強度(橫向載荷測試中的強度)
