CLOSE
About Elements
私たち田中貴金属は、貴金属のリーディングカンパニー。
社会の発展を支える先端素材やソリューション、
それらが生まれた開発ストーリー、技術者たちの声、そして経営理念とビジョンーー
Elementsは、「貴金属を究める」をスローガンに、
より良い社会、豊かな地球の未来につながるインサイトを発信するWEBメディアです。

【注目集まる光電融合での活用も視野に】“金”の可能性が拓く次世代高密度実装の新発想
異質なチップ・基板間の“調整役”
田中貴金属工業は、こうした半導体後工程の技術活用状況を背景に、信頼性が高く、高密度のフリップチップ実装を実現できる新たな実装ソリューション「AuRoFUSEプリフォーム」を開発し、量産化・提供に向けた準備を進めている。サブミクロンサイズの金粒子が持つ低温焼結可能な特性を応用して、多様なサイズ・形状の金バンプを作製する技術である(図1)。
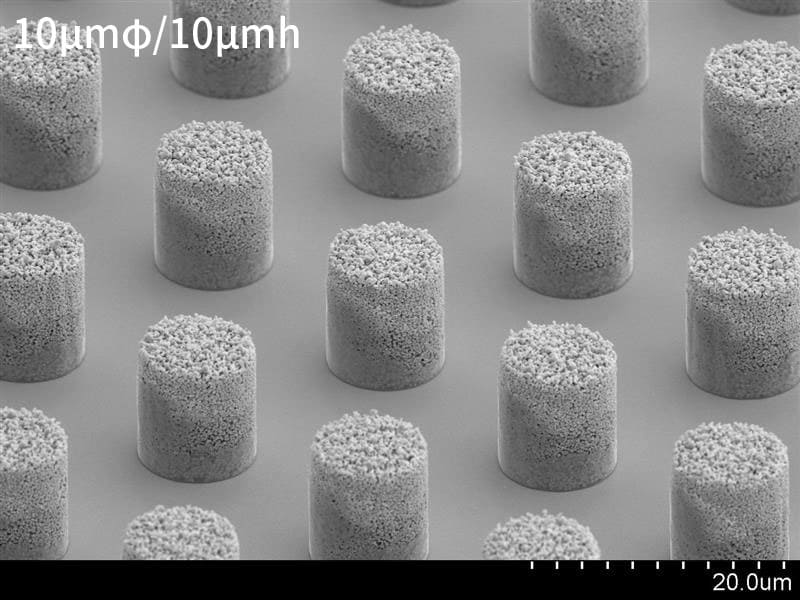
図1 AuRoFUSEプリフォームによって作製された金バンプ
開発に携わった牧田勇一氏は、「チップを基板に接続する際に用いる材料には、電気信号や熱を効果的に伝える機能だけでなく、チップや基板の状態、物性の違いを擦り合わせる“調整役”としての機能も求められます。AuRoFUSEプリフォームは、この両方の特徴を兼ね備えていたワイヤーボンディングの機能を継承しつつ、時代の要請に応える新たな接続技術として開発を進めています」と話す。
AuRoFUSEプリフォームで形成したバンプは、200℃程度の比較的低温で熱圧着接続が可能である。ハイブリッドボンディングと比べると接続密度ではやや劣るものの、工程がより簡便で実装プロセスの負荷を軽減できる点で、極めて有用な高密度接続技術であると言えるだろう。
形成後のバンプは約0.4μmの金の微粒子で構成された多孔質(ポーラス)構造のため、接続時の加圧によって幅方向のサイズや形状が崩れることが少ない(図2)。電極間の短絡が発生しにくく、高密度で信頼性の高い接続を実現できる。同様の理由で、接合対象となる基板が大きく、接合面が不均一であっても、反りや凹凸、段差を柔軟に吸収し、高い歩留まりでの実装が可能だ。
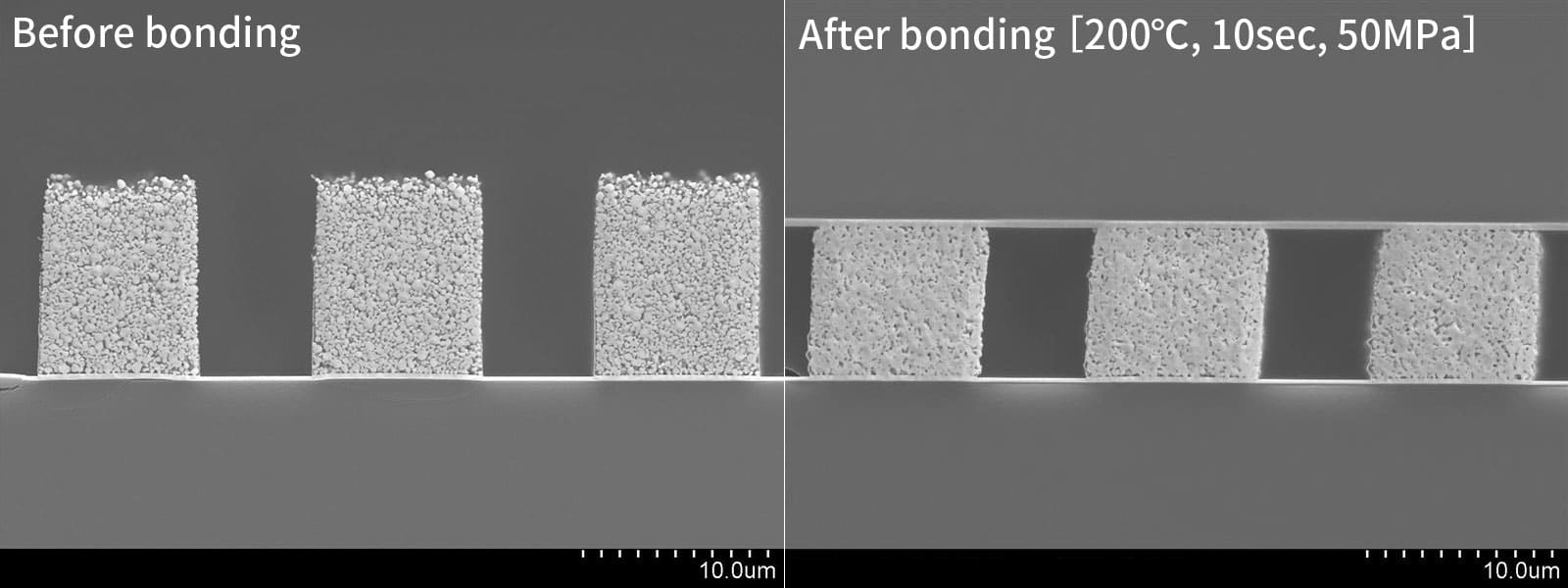
図2 圧縮による寸法変化
AuRoFUSEで形成したバンプは、スポンジのように幅方向のサイズ変化は少なく高さ方向を圧縮できる。このため、圧縮後にバンプ同士が短絡するような不良が発生しにくい。
加えて、主成分が金であるため、電気抵抗が低く(4.5μΩ・cm、加圧によって改善可能)、熱伝導率も200 W/mKと極めて高い。「パワー半導体のような大電流を扱い発熱量の大きなデバイスの実装にも最適です。さらに、金の安定した物性から、酸化やマイグレーションが発生しにくいため、長期的に信頼性の高い接合を実現できます」と牧田氏は話す。
新材料の力を引き出す新工程を提案
AuRoFUSEは、金の微粒子と有機溶剤で構成されたペースト材料である。一般にディスペンサーで押し出してバンプ形成することもできる。ただし、その方法では600μm程度のバンプ形成が限界だ。
そこで同社は、AuRoFUSEのメリットを引き出す新たなプロセスを開発し、実績最小5μmサイズ、5μm間隔の微小で高密度な金バンプの形成を可能にした(図3)。開発した金バンプ形成プロセスは、フォトリソグラフィ工程にペーストの印刷工程を組み合わせることで構築されており、既存プロセスとの高い親和性を持つ。
図3 金バンプの形成プロセス
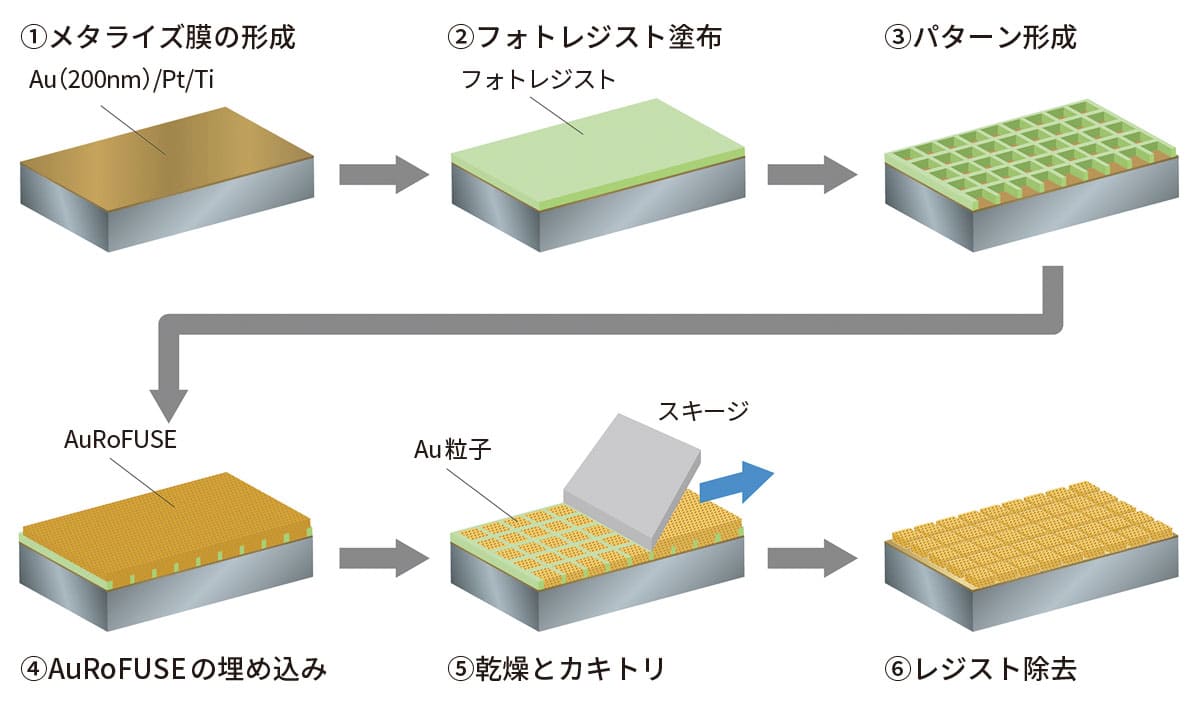
まず、基板上に接続の下地となる金属薄膜(Au/Pt/Ti)を成膜し、そこにフォトレジストを塗布して露光工程でバンプパターンを形成する。そして、印刷でペーストを埋め込んだ後、レジスト除去し、乾燥させてプリフォームを形成する。
また同社は、材料を供給するだけでなく、ユーザー企業が金バンプ形成プロセスを量産工程として立ち上げられるよう、支援体制の整備を進めている。機能性に優れた貴金属である金を活用する技術のため、使用済み材料をリサイクルする仕組みを整え、持続的な利用とユーザーのコスト軽減を両立していく。
「AuRoFUSEプリフォームは、140年にわたり貴金属の技術を磨き、蓄積してきた当社だからこそ実現できた技術だと自負しています。現在、さらなる性能向上と応用範囲の拡大に向けた検討を進めており、特にマイクロLEDや光電融合型チップの光源実装など、熱制御が重要な分野への適用が期待されます」と応用市場の開拓に取り組む渡辺尚登氏は述べる。
AuRoFUSEプリフォームのような新時代の実装ソリューションの活用で、半導体チップはさらなる進化を遂げることだろう。

日経BPの許可により「日経クロステック」 (2025年11月21日掲載)に掲載された広告記事を抜粋したものです。
(禁無断転載)
関連情報
パワー半導体パッケージング技術の最新動向、高放熱性・高耐熱性を実現する最先端素材
スマートフォンや電子機器等の省エネ化、EV等の次世代モビリティ、基地局、再エネの電力制御など、パワー半導体の技術開発は、ますますの高出力化や高効率化が進みます。
高放熱・高耐熱・接合信頼性の工場・小型化などの課題に対応するための最先端素材と、パッケージングの技術動向をご紹介します。











