CVD / ALD 용 귀금속 프리커서

차세대 반도체용 고순도 귀금속 프리커서 개발
한층 더 한 미세화 및 내구성 향상이 요구되는 반도체 산업에서 루테늄(Ru) 프리커서의 성막 속도 향상을 통해 비용 절감과 고품질화를 도모하며, 반도체가 개척하는 새로운 첨단기술 개발에 기여해 나갑니다.
CVD = Chemical Vapor Deposition (화학 기상 성장법)
ALD = Atomic Layer Deposition (원자층 퇴적법)
프리커서 개발・제공
당사에서는 Ru를 중심으로 다양한 CVD/ALD용 프리커서를 개발하고 있습니다.
또한, 반도체용의 박막을 제작하기 위한 CVD 장치, 박막을 평가하기 위한 각종 분석기기(FE-SEM, AFM, GD-MS 등)를 갖추어 목적에 맞는 프리커서를 제공합니다.
■프리커서 제품 예(Ru)
| Product Name | Appearance |
|---|---|
|
DCR Ru 성막용 고순도 프리커서 |

|
|
Rupta Ru 성막용 무산소 프리커서 |

|
|
TRuST Ru 성막용 고증기압 프리커서 |

|
반도체의 진화에 따라 반도체의 미세화를 위해 보다 낮은 저항으로 내구성이 높은 귀금속의 루테늄에 기대가 높아지고 있습니다. 또, 트랜지스터의 게이트용 전극이나 DRAM 의 커패시터용 전극 등에서도 우수한 특성을 가지는 루테늄이 검토되고 있습니다.
Ru 성막용 고증기압 프리커서: TRuST

액체 루테늄(Ru) 전구체로 세계 최고 수준의 증기압치를 실현
지금까지의 액체 루테늄(Ru) 전구체 에 비해 증기압을 약 100 배* 이상 까지 높인 CVD・ALD용 전구체.
본 기술에 의해 스마트폰 및 PC 용이나 향후 더욱 수요가 예상되는 데이터 센터에서 사용되는 반도체의 고성능화・전력 절약화에 공헌합니다.
*상온에서 당사 내 평가에 따른 실험값
■특징
- 실온 정도에서도 높은 증기압을 보입니다.
- 반응 가스(수소, 산소 등)로 쉽게 분해되어 저저항인 Ru막을 형성할 수 있습니다.
- 작은 분자이므로 기판 표면에 대한 흡착 효율이 우수하며, 높은 성막 속도를 얻을 수 있습니다.
- 단차 피복성이 우수하여 미세한 높은 아스펙트비 구조에도 심부까지 균일하게 성막할 수 있습니다.
-
프리커서 증기압 비교

-
TRuST를 이용한 ALD에 의한 Ru 박막

■TRuST를 이용한 2단계 ALD 공정
산소와 수소를 사용한 2단계 ALD 공정으로 기판의 산화 방지와 고품질 및 저저항 초박막 실현
TRuST를 이용한 2단계 성막 공정
-

1단계: H2를 사용한 Ru 성막
수소 성막으로 기판 표면의 산화 위험 저감 -

2단계: O2를 사용한 Ru 성막
산소 성막으로 Ru 순도를 거의 100%로 유지하는 고순도 성막 -

먼저 수소 성막으로 기판을 형성함으로써, 그 위의 산소 성막에 의한 Ru막도 평활하고 치밀해져 기존 이상의 낮은 저항값 실현
-
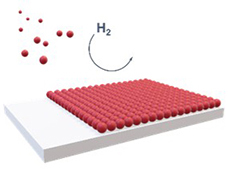
1단계: H2를 사용한 Ru 성막
수소 성막으로 기판 표면의 산화 위험 저감 -

-

2단계: O2를 사용한 Ru 성막
산소 성막으로 Ru 순도를 거의 100%로 유지하는 고순도 성막 -

-

먼저 수소 성막으로 기판을 형성함으로써, 그 위의 산소 성막에 의한 Ru막도 평활하고 치밀해져 기존 이상의 낮은 저항값 실현
- 2단계 성막 공정으로 극초박막 영역에서도 치밀하고 저저항인 Ru막을 형성할 수 있습니다.
- 각 공정은 동일한 원료와 성막 온도로 수행되므로 공정 비용이나 설비 투자 비용 절감에 기여합니다.
2 단계 성막의 단면 SEM 이미지

