CVD/ALD-Edelmetall-Präkursoren

Was sind "CVD/ALD-Edelmetall-Präkursoren"?
Dies sind filmformende Materialien, die in CVD (Chemical Vapor Deposition) und ALD (Atomic Layer Deposition) Prozessen verwendet werden, die entwickelt wurden, um die Miniaturisierung und hohe Leistung von Halbleitern zu ermöglichen. Wir entwickeln eine Vielzahl von CVD/ALD-Präkursoren, hauptsächlich Ruthenium (Ru).
Entwicklung hochreiner Edelmetall-Präkursoren für Halbleiter der nächsten Generation
In der Halbleiterindustrie, wo eine weitere Miniaturisierung und verbesserte Haltbarkeit erforderlich sind, streben wir an, die Kosten zu senken und eine höhere Qualität zu erreichen, indem wir die Geschwindigkeit der Filmabscheidung von Ruthenium (Ru)-Vorstufen verbessern, und wir werden zur Entwicklung neuer fortschrittlicher Technologien beitragen, die durch Halbleiter ermöglicht werden.
CVD = Chemical Vapor Deposition (Chemische Gasphasenabscheidung)
ALD = Atomic Layer Deposition (Atomlagenabscheidung)
Entwicklung und Angebot von Präkursoren
Unsere Firma hat verschiedene CVD/ALD-Präkursoren entwickelt, mit Schwerpunkt auf Ru. Weiterhin haben wir CVD-Vorrichtungen für die Anfertigung von Halbleiter-Dünnschichten, verschiedene Geräte zur Bewertung dieser Dünnschichten (FE-SEM, AFM, GD-MS etc.) im Angebot und bieten Präkursoren für verschiedene Verwendungszwecke an.
Beispiele für Vorprodukte (Ru)
| Produktname | Außenansicht |
|---|---|
| DCR Hochreiner Präkursor für die Ru-Filmabscheidung |

|
| Rupta Sauerstofffreier Präkursor für die Ru-Schichtabscheidung |

|
| TRuST Hochdampfdruck-Präkursor für die Ru-Schichtabscheidung |

|
Da Halbleiterbauelemente weiterhin in der Größe schrumpfen, wächst die Erwartung an Ruthenium (Ru), das einen geringeren Widerstand und eine höhere Haltbarkeit aufweist. Ru wird auch für den Einsatz in Transistor-Gate-Elektroden und DRAM-Kondensatorelektroden aufgrund seiner hervorragenden Eigenschaften in Betracht gezogen.
Hochdampfdruckpräkursor für die Bildung von Ru-Filmen: TRuST

Erreichen der weltweit höchsten Dampfdrücke durch Verwendung flüssiger Ru-Vorstufen
Dieser CVD/ALD-Präkursor hat einen mehr als 100-mal höheren Dampfdruck* als herkömmliche flüssige Ru-Präkursoren. Er wird zur Steigerung der Leistung und Energieeffizienz von Halbleitern in Smartphones und PCs beitragen, darüber hinaus von Halbleitern in Rechenzentren, wo die Nachfrage nach unseren Präkursoren in Zukunft weiter steigen dürfte.
*Experimentelle Werte basierend auf internen Bewertungen bei TEMPERATURE
Eigenschaften
- Hoher Dampfdruck selbst bei etwa Raumtemperatur.
- Ru-Filme mit niedrigem Widerstand können abgelagert werden, da sie sich leicht in Reaktionsgasen (Wasserstoff, Sauerstoff usw.) zersetzen.
- Hat aufgrund seiner kleinen Moleküle eine gute Adsorptionseffizienz auf Substratoberflächen, was hohe Abscheidungsgeschwindigkeiten von Filmen ermöglicht.
- Hat eine ausgezeichnete Schichtabdeckung und kann Filme gleichmäßig bis in ihre Tiefen bilden, selbst auf Miniaturstrukturen mit hohen Aspektverhältnissen.

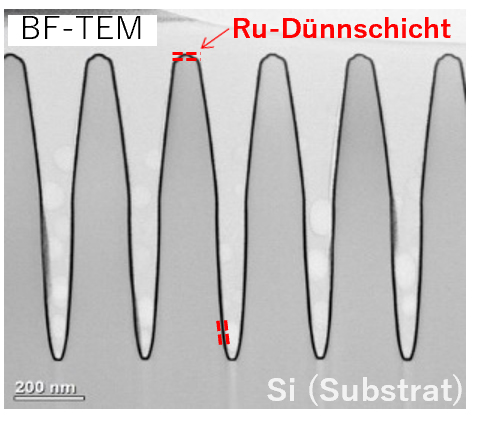
Zweistufiger ALD-Prozess unter Verwendung von TRuST.
Verhindert die Oxidation von Substraten und erzielt ultra-dünne Filme von hoher Qualität und niedrigem Widerstand durch einen zweistufigen ALD-Prozess unter Verwendung von Sauerstoff und Wasserstoff.
Zwei-Stufen-Filmformungsprozess durch TRuST
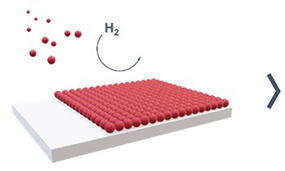

Schritt 1: Ru-Filmformation unter Verwendung von H2
Das Risiko der Oberflächenoxidation des Substrats wird durch die Bildung eines Wasserstofffilms verringert.
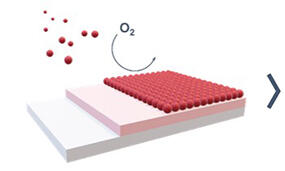

Schritt 2: Ru-Filmbeschichtung mit O2
Hochreine Filmbeschichtung mit einer Ru-Reinheit von fast 100% durch Sauerstofffilmbeschichtung

Durch die erstmalige Bildung einer Basis mittels Wasserstofffilm-Bildung ist der durch Sauerstofffilm-Bildung darauf entstandene Ru-Film ebenfalls glatt und dicht, wodurch niedrigere Widerstandswerte als je zuvor erreicht werden.
- Durch ein zweistufiges Verfahren zur Filmformation können dichte Ru-Filme mit niedrigem Widerstand selbst im Bereich der ultradünnen Filme abgeschieden werden.
- Da jeder Prozess mit denselben Rohmaterialien und Filmformungstemperaturen durchgeführt wird, trägt dies zur Senkung der Prozesskosten und der Investitionskosten für die Ausrüstung bei.

Weitere Informationen
Bitte Kontakt
Bitte zögern Sie nicht, uns bei jeglichem Kontakt bezüglich Produkten, Medien, Wettbewerbsförderung usw. zu kontaktieren.


