金・金合金ボンディングワイヤ

50年を超える信頼と実績
「金・金合金ボンディングワイヤ」とは
金・金合金ボンディングワイヤは、半導体チップと電極を高信頼に接続する導通材で、優れた接合性・耐腐食性を備えます。当社製品は世界中の半導体メーカーに採用されるワールドスタンダードとして、微細化や高ループ制御など多様な実装ニーズに対応しています。
HAZ長さと破断荷重 [Au Wire dia. 25um]
![[HAZ長さと破断荷重比較グラフ]左からY/C/FA/GSA/M3/GHA-2/LC/GSB/GFC/GLF/GMH/GFD/GPH/GPG-3/GPG/GPG-2/GMG/GMH-2](/jp/products/img/img_bonding_wires_au_02.jpg)
GSA / GSB – 安定した2nd接合が可能なAuボンディングワイヤ
特長
- 安定したステッチ接合性によりQFN, QFP, BGAパッケージでも局所的な不着が発生しにくい。
- ステッチプル試験後の金残りが多く、ステッチ接合部でのボンドリフトが少ない。
- 圧着径のばらつきが少なく、真円性が良好且つFABが軟らかく圧着ボールが変形しやすい。
Stable Stitch Bond on QFN Packages(PPF, 175℃)
![[Frequencyと2nd Pull Strength比較グラフ]Average-GSA:4.3gf/FA:4.1gf/GSB:4.2gf/GHM:4.0gf](/jp/products/img/img_bonding_wires_au_03.jpg)
After Stitch Pull Test
![[After Stitch Pull Test]GSA/FA/GSB/GMH](/jp/products/img/img_bonding_wires_au_04.jpg)
Squashed Ball Roundness
![[Squashed Ball Roundness比較] GSA/GSB/FA/GMH](/jp/products/img/img_bonding_wires_au_05.jpg)
GFC / GFD - ファインピッチ実装対応Auボンディングワイヤ
特長
- ボンディング時の超音波による圧着ボールの変形が少ない。
- 必要十分な超音波を印加できるため良好な接合状態が得られる。
- 様々なパッドピッチボンディングに対応。
Ball Shape
![[Ball Shape比較] GMH/GFC/GFD, FAB:38-61µm,SBD:45-75µm](/jp/products/img/img_bonding_wires_au_06.jpg)
Middle FAB : 51µm SBD : 60µm
Lower FAB : 62µm SBD : 75µm
35µm BPP Bonding
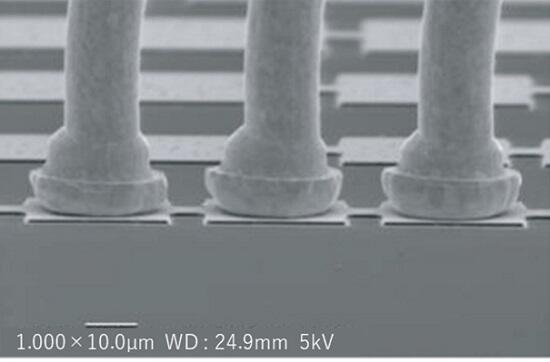
Bonder : Shikawa UTC-3000
Pad Opening : 2µm
Scatter Diagram at 35µm BPP Bonding

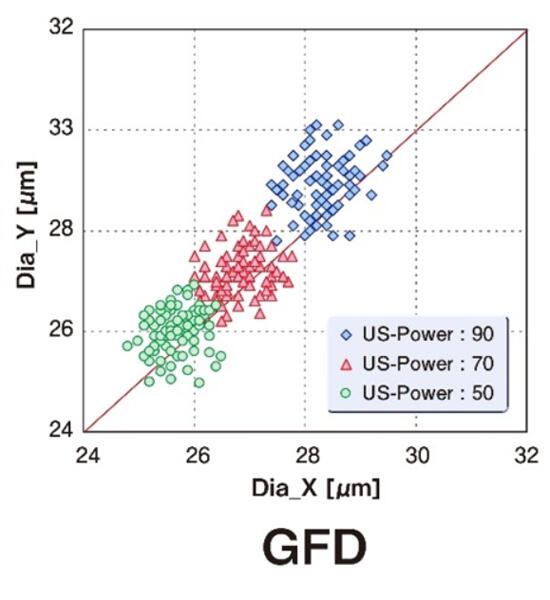

GPH - 高信頼性対応Au合金ボンディングワイヤ
特長
- ハロゲンフリー樹脂との組み合わせで高い高信頼性
![[Failure ratioとAging timeの比較グラフ] GPH/GPG series](/jp/products/img/img_bonding_wires_au_11.jpg)
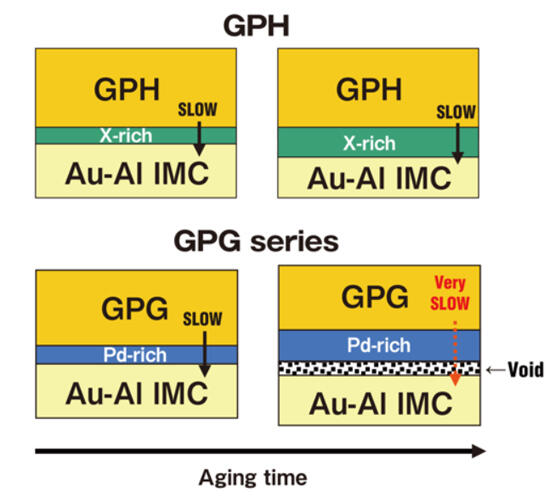
GLF - 超低ループ対応Auボンディングワイヤ
特長
- 従来の低ループワイヤよりも低ループ形成性に優れる。
- 優れたネックダメージ抑止性
- S字曲がり抑止性
- 従来の低ループワイヤよりプル強度が高い。
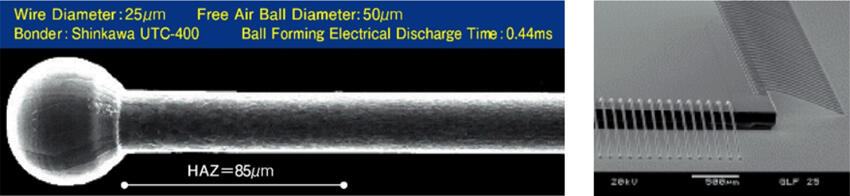
GMG – 高強度Auボンディングワイヤ
特長
- 高強度タイプは細線化によるコストダウンが可能
- BGAなどの多彩なループ形状に対応。
- スタックダイパッケージでのバンプ形成に優れる。
Mechanical Properties
![[Breaking LoadとWire Diameterの比較グラフ]FA/GMH/GMH-2/M3/GMG](/jp/products/img/img_bonding_wires_au_14.jpg)
テクニカルデータのダウンロード
テクニカルデータは以下のバナーよりダウンロードいただけます。
Scroll



