AuRoFUSE™ Preforms
電子
膏材
半導體
接合與封裝
接合材料

什麼是「AuRoFUSE™ Preforms」?
這是一種用於高密度安裝的金燒結結合技術,利用田中貴金屬開發的低溫燒製膏材AuRoFUSE™。 它提升了安裝過程的效率與高度的鍵結可靠性,並具備高效能特性,如電阻為4.5 μΩ·cm,熱導率達200 W/m·K。
AuRoFUSE™ Preforms技術簡介
採用 AuRoFUSE™ 的燒結金鍵結技術用於高密度封裝
這項技術透過預先乾燥鍵合材料來消除其流動性,從而防止材料蠕變,並使其難以水平擴散,實現小間距鍵合。目前,我們已成功形成尺寸為 5µm 的凸块,預計該技術將應用於需要高密度封裝的倒裝晶片鍵合領域。
特色
- ① 金凸块可以製成各種尺寸和形狀。
(最低性能要求:尺寸 5µm,間距 5µm) - ②由於黏結材料的多孔質結構具有優異的壓縮變形性能
- ③ 加壓時水平變形小,可實現高密度安裝
- ④ 由於主要成分是Au,因此很難發生氧化和遷移
- ⑤ 允許在相對較低溫度 (200°C至更低) 的大氣中焊接
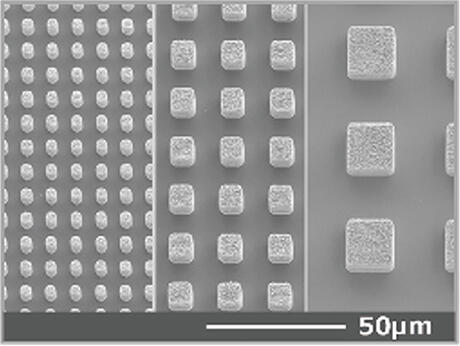
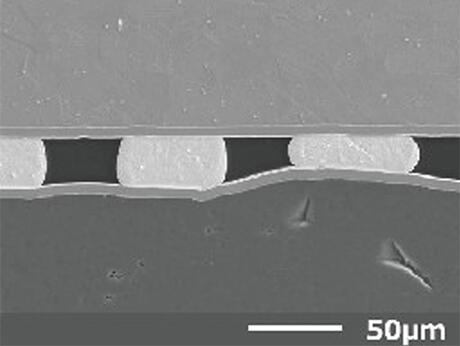

③ 提高接合壓力時的形狀變形率


預期用途
用於光電半導體(LED 和 LD)、功率半導體和積體電路的晶片晶片貼裝材料
AuRoFUSE™ Preforms體製造方法
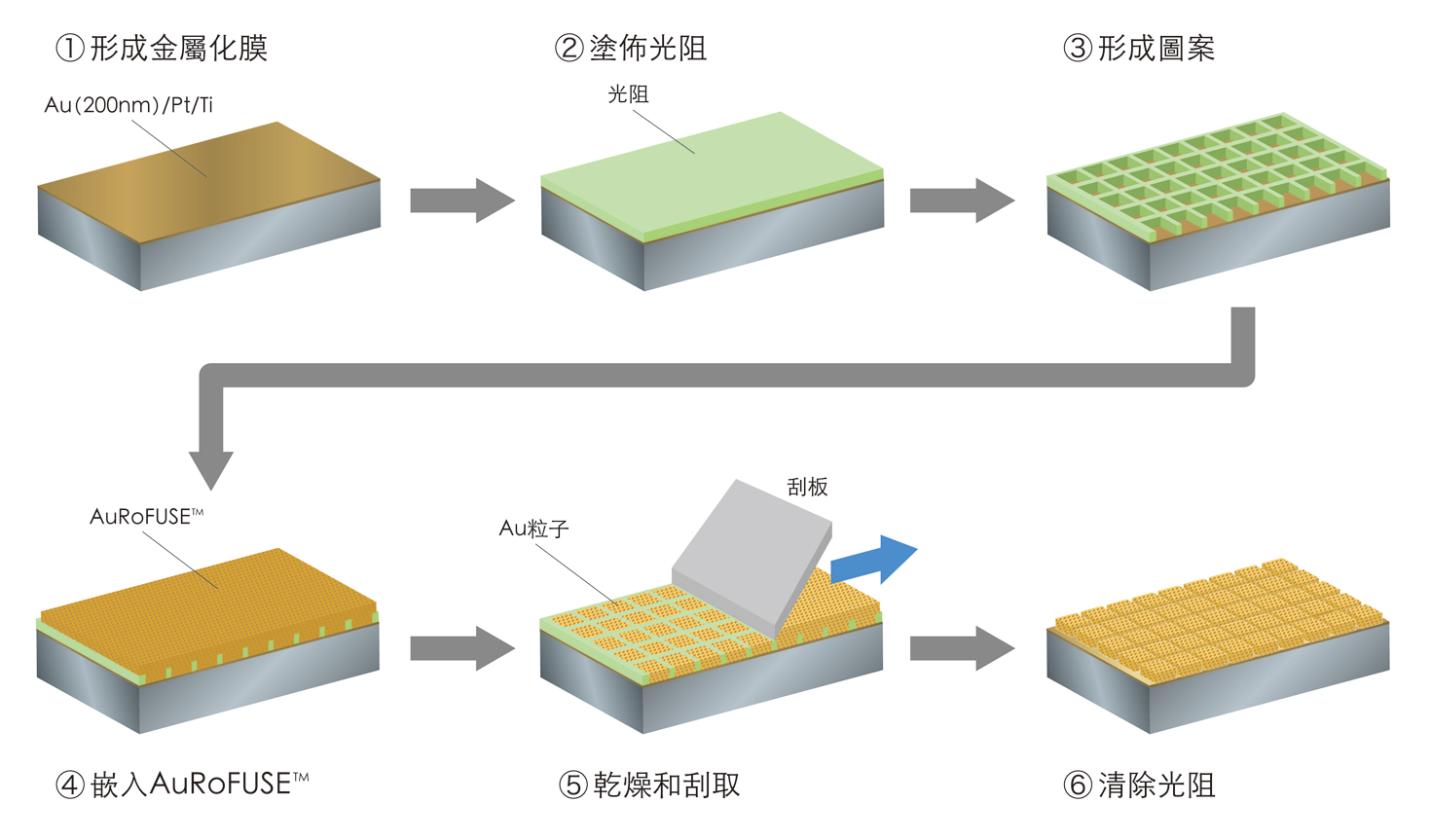
- ① 將要黏合的基板金屬化處理,以 Au/Pt/Ti 作為基底層。
- ②金屬化處理後,將光阻塗覆到要連接的基板。
- ③ 將與預製件形狀相符的光罩放在待黏合的基板上,透過曝光和顯影形成光阻框架。
- ④ 將AuRoFUSE ™ 倒入已創建的光刻框中
- ⑤ 在室溫下真空乾燥,乾燥後,用刮板刮去多餘的金顆粒。
- ⑥ 經過加熱預燒結後,將光阻框架剝離並移除。
AuRoFUSE™ Preforms與其他材質的比較
(〇)AuRoFUSE™ Preforms
- 透過在黏合前將膏材乾燥以消除流動性,可以抑制橫向擴散,從而實現高密度安裝。
- 多孔質結構使其易於變形,即使電極之間存在高度差,或基板翹曲或厚度不同,也能實現黏合。
(△) 焊料
- 隨著凸块間距變小,焊料熔化時會橫向擴散,導致電極之間接觸,造成短路。
(△)無電鍍(化學鍍/化鍍)
- 提供較窄的間距,但在連接時需要相對較高的壓力,從而導衹晶片損壞
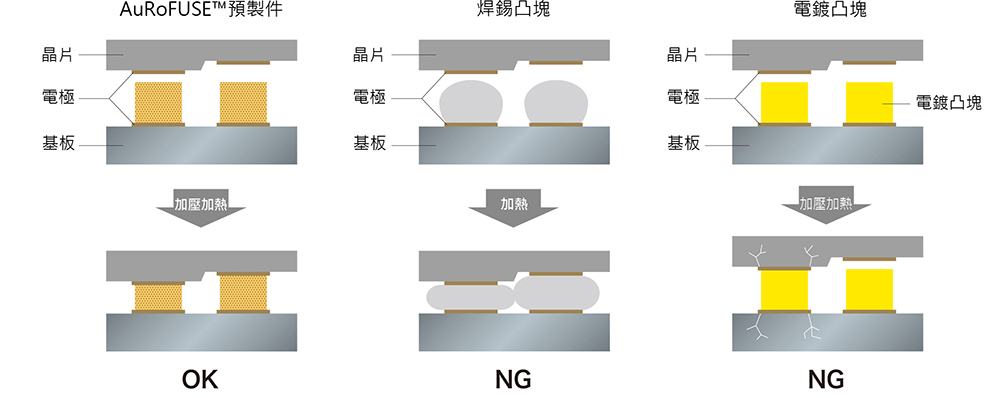
連接示例:倒裝接合
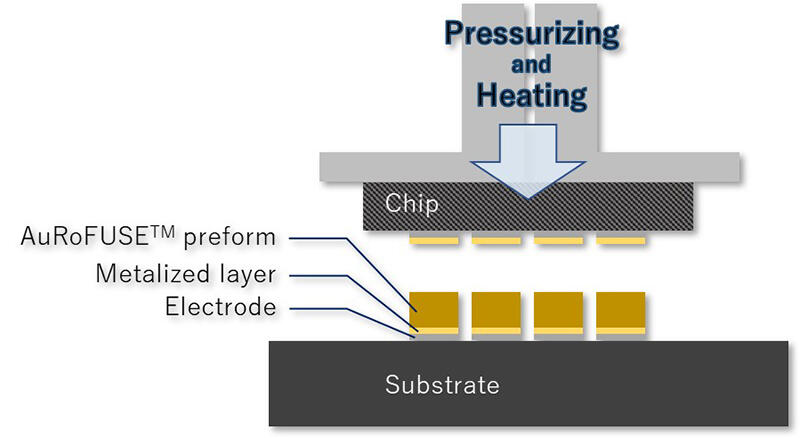
| Pretreatment: | UV ozonation, etc. |
| Thermo-Compression: | 200°C, 20MPa, 10sec. |
| Post-Bake: | 200°C, 60min. |
特性表
| 200°C, 20MPa, 10sec | 200°C, 100MPa, 10sec | |
|---|---|---|
| 電阻率 (μΩ·cm) | 3.0 | 2.6 |
| 熱導率 (W/mK) | 250 | 280 |
| 楊氏模量 (GPa) | 57 | 70 |
| CTE:線膨脹係數 (ppm/K) | 14 | 14 |
| 剪力强度(兆帕) | >30 | |
| 底膜 | Au/Pt/Ti, Au/Pd/Ni | |
AuRoFUSE™ Preforms轉移技術
這是一種預先產生凸块的基板,然後將凸块轉移到目標晶片或基板的方法。
該結構透過基板開口形成並固定凸块,因此運輸過程中無需擔心凸块脫落。
轉移過程中,凸块會因加熱而收縮,因此只需垂直拉力即可輕易拉出。
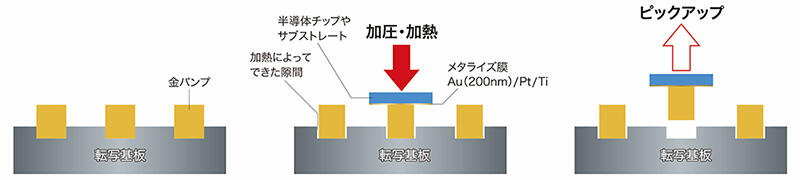
■特徵
- ① 它還可以應用於半導體晶片和襯底,其形狀難以通過傳統方法處理,例如凹凸和通孔
- ② 它還可以應用於半導體晶片和基板,這些晶片和基板擔心剝離液等的損壞並且難以通過光刻工藝
■【轉移基板的製備及轉移/鍵結過程】
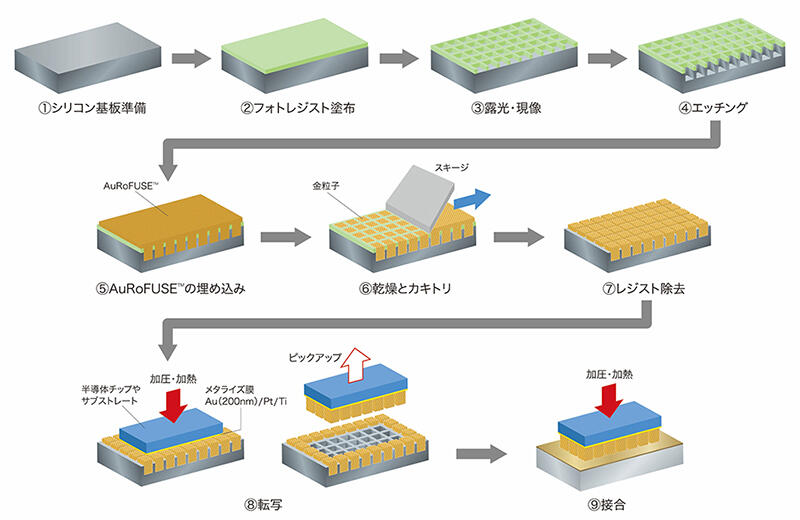
- ① 製備矽基板作為轉移基板。
- ② 在矽基基板塗覆光阻。
- ③ 對所需圖案進行曝光顯影
- ④ 在矽基基板蝕刻孔。
- ⑤ 使用刮板或類似工具將 AuRoFUSE™ 嵌入。
- ⑥ 在常溫/真空下幹燥AuRoFUSE ™ ,刮去光刻膠上多余的金顆粒
- ⑦ 當光阻剝離後,便形成轉移基板。
- (8) 將要用金凸块形成的目標(半導體晶片或基板)施加於轉移基板,並以10 MPa、150 °C加壓加熱1分鐘。 之後,垂直抬起基板就能將黃金轉移凸块
- ⑨ 將轉移的基板在 20 MPa、200°C 和 10 秒的條件下加壓和加熱進行黏合。
實施例
<超小型雙面冷卻功率模塊的應用成果 (東北大學高橋良和教授) >
我們發現,將我們的AuRoFUSE™ Preforms應用於逆變器功率元件模組的晶片電極與基板迴路之間的黏合,與傳統焊料相比,有助於提高熱阻。此外,它還通過了歐洲汽車功率模組評估標準 (AQG324) 中規定的功率循環測試。

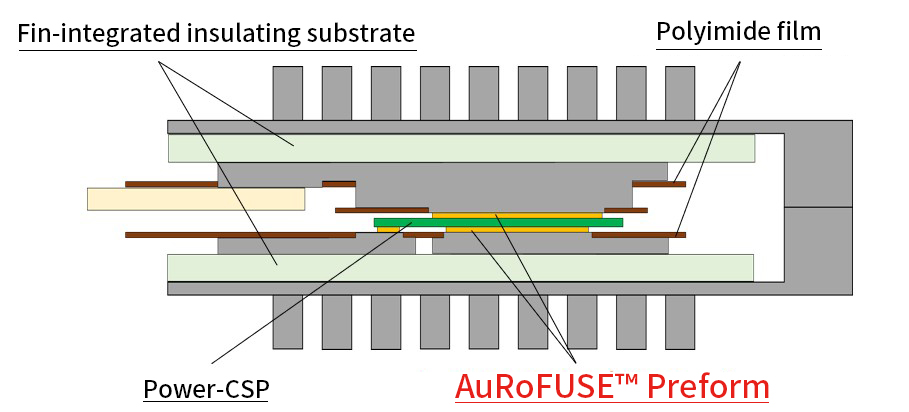
| 試驗 | 條件 | AuRoFUSE™ Preforms | 焊料 |
|---|---|---|---|
| 熱阻 | 冷卻水:10L/min | 整個係統0.98 | 整個係統1.00 (基數) |
| 動力迴圈 | T jmax:175°C/T jmin:75°C 2sec ON/18sec OFF |
6萬次迴圈 V on無變動 |
6萬次迴圈 V on比初期增加3.2% |
本研究由東北大學開展,並獲得了日本文部科學省「創新電力電子創造基礎技術研發計畫」(資助號:JPJ009777)的支持,田中貴金屬工業株式會社擔任顧問委員會成員,並提供了AuRoFUSE™ Preforms。
關聯公司
田中貴金屬工業株式會社和Mems Core公司透過發揮各自的優勢,以雙向合作的方式提供材料、原型製作和預成型件(金凸块)評估,從而實現快速開發系統。

株式會社Mems Core網站鏈接: https://www.mems-core.com/index.html
相關資訊
Scroll