CVD/ALD用貴金屬前驅物
感測器材料
能源與氫能社會
電子感測器的材料
化合物與奈米粒子
半導體
粉末、化合物、奈米粒子與顆粒
、沉積、濺鍍、
貴金屬薄膜與沉積技術

什麼是"CVD/ALD用貴金屬前驅物"?
這些是用於化學氣相沉積 (CVD) 和原子層沉積 (ALD) 製程的成膜材料,這些製程的開發是為了滿足半導體小型化和高性能的需求。我們開發了多種用於 CVD/ALD 的前驅物,重點是釕 (Ru)。
面向下一代半導體的高純度貴金屬前驅物的開發
在要求進一步微細化和提高耐久性的半導體產業中,我們將通過提高釕 (Ru) 前驅物的成膜速度來降低成本和提高質量,為半導體開創的新先進技術的開發做出贡獻。
CVD=Chemical Vapor Deposition (化學氣相沉積法)
ALD=Atomic Layer Deposition (原子層沉積法)
開發、提供前驅物
本公司以Ru為中心,正在開發各種CVD/ALD用前置器。此外,還備有用於制作半導體薄膜的CVD裝置、用於薄膜評估的各種分析儀器(FE-SEM、AFM、XRF等),可根據目的提供預測器。
前驅物產品範例 (Ru)
| Product Name | Appearance |
|---|---|
| DCR Ru成膜用高純度前驅物 |

|
| Rupta Ru成膜用無氧前驅物 |

|
| TRuST Ru成膜用高蒸氣壓前驅物 |

|
面向半導體的進一步微細化,對電阻更低、耐久性更高的Ru的期待越來越高。此外,正在研究具有優異特性的Ru,用於晶體管柵極電極和DRAM電容器電極。
Ru成膜用高蒸氣壓前驅物:TRuST

液體Ru前驅物實現世界最高水平的蒸汽壓值
與以往的液體Ru前驅物相比,蒸汽壓力提高到*100倍以上的CVD/ALD用前驅物。我們將為智能手機和PC以及未來數據中心使用的半導體的高性能和節能做出贡獻。
*常溫下本公司內部評價的實驗值
特色
- 即使在室溫左右也顯示出高蒸氣壓。
- 用反應氣體(氫氣、氧氣等)容易分解,形成低阻力的Ru膜。
- 由於它是一種小分子,因此能有效地吸附在基板表面,從而實現較高的薄膜沉積速度。
- 階差覆蓋性優異,即使在細微的高長寬比結構中也能均勻地成膜至深處。

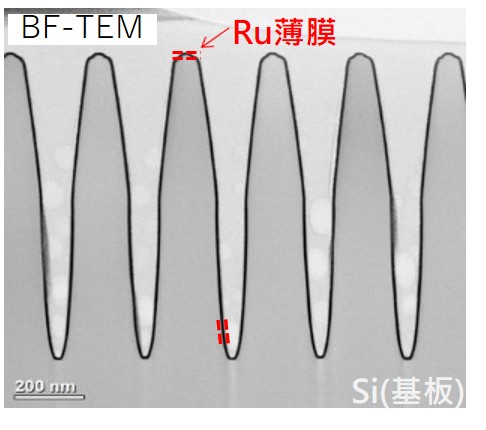
使用TRuST的兩步ALD過程
採用氧氣和氫氣的兩步驟 ALD 製程可防止基板氧化,並產生高品質、低電阻的超薄膜。
基於TRuST的兩階段成膜工藝
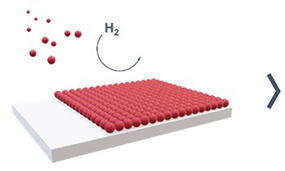

第1階段:利用H2進行Ru成膜
利用氫成膜降低基礎表面氧化的風險
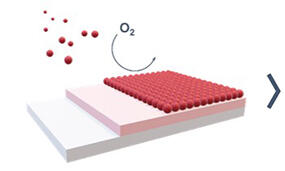

第2階段:利用O2的Ru成膜
利用氧氣成膜使Ru的純度幾乎保持在100%的高純度成膜

通過首先在氫成膜上形成基底,由氧成膜形成的Ru膜也變得平滑和衹密,實現了比以前更低的電阻值
- 兩步成膜工藝可在超薄膜區域形成衹密、低電阻的Ru膜。
- 由於每個過程都在相同的原料和成膜溫度下進行,因此有助於降低工藝成本和資本投資成本。

相關資訊
Scroll




